具有p-GaN岛状埋层耐压结构的横向AlGaN/GaN高电子迁移率晶体管∗
2018-01-18张力林志宇罗俊王树龙张进成郝跃戴扬陈大正郭立新
张力 林志宇 罗俊 王树龙 张进成 郝跃戴扬 陈大正 郭立新
1)(西安电子科技大学微电子学院,宽禁带半导体国家重点实验室,西安 710000)2)(西安电子科技大学物理与光电工程学院,西安 710000)
(2017年6月1日收到;2017年8月16日收到修改稿)
1 引 言
近年来,AlGaN/GaN高电子迁移率晶体管(HEMT)由于高二维电子气(2DEG)浓度、高电子饱和速度及高击穿电场等优越特性在学术界和工业界受到广泛关注,被认为是电力电子领域的理想应用器件[1−8].有大量报道称在提高Al-GaN/GaN HEMT击穿电压方面取得了优越的成果,Zhang等[9]报道了采用重叠栅结构,实现栅漏间距为13µm的AlGaN/GaN HEMT击穿电压为570 V;Kim等[10]报道了栅漏间距为10µm的常规结构AlGaN/GaNHEMT击穿电压为495 V,而采用氟等离子体处理之后实现击穿电压520 V;Deguchi等[11]报道了采用缓变栅场板结构,实现栅漏间距为10µm的AlGaN/GaN HEMT击穿电压为830 V.但上述器件能达到的最大栅漏间平均击穿电场仅为0.83 MV/cm,始终与GaN材料的理论击穿电场强度(3.3 MV/cm)相去甚远[12−15].
本文基于横向HEMT结构,提出了一种新型的工艺易实现的高击穿电压AlGaN/GaN HEMT.该器件采用岛状p-GaN掩埋缓冲层(PIBL),通过体电场调制效应使电场的分布更加均匀从而达到提高器件击穿电压的目的,其工作原理类似于硅功率器件中的减小体场效应[16,17].其中非故意掺杂n型GaN缓冲层与p-GaN岛掩埋层形成的反向偏置p-GaN/n-GaN结对器件表面和体电场分布均匀性有明显的优化,同时使器件的缓冲层泄漏电流得到抑制,实现了器件击穿电压超过1700 V.文中使用Sentaurus TCAD仿真软件对PIBL AlGaN/GaN HEMT的关态I-V特性、电场分布等器件电学特性进行仿真并对器件参数进行优化设计.仿真结果表明,与常规的AlGaN/GaN HEMT器件相比,实验设计的PIBL AlGaN/GaN HEMT在击穿电压等方面表现出明显的优越性.
2 器件仿真
PIBL AlGaN/GaN HEMT结构的截面图如图1所示,与常规HEMT结构的不同点在于此结构在2DEG通道下方的GaN缓冲层中埋设了6个等间隔的p-GaN岛.
图2给出了PIBL HEMT器件结构提高击穿电压的工作原理.对于常规GaN基HEMT而言,因为在栅极边缘处耗尽区边界发生弯曲,曲率很大,使得电场线向栅极边缘集中,因此在同样的偏压下,栅极边缘耗尽区电场远大于栅下方耗尽区电场[18,19].而对于PIBL HEMT结构,当截止状态下向漏极施加较高的正向电压(Vds)时,在p-GaN岛靠近漏端的区域与缓冲层之间形成反偏的p-n结,进而形成空间电荷区.p-GaN边缘产生负的空间电荷,而缓冲层产生正的空间电荷,正的空间电荷会吸引电场,在p-GaN岛靠近漏端一侧形成新的电场峰,这样能够使表面电场分布更加均匀,提高器件的耐压.同时p-GaN埋层也能与缓冲层形成横向p-n结,承担一部分缓冲层耐压,防止缓冲层横向穿通.
本文仿真过程中所用到的器件相关参数如表1所列,为了突出PIBL结构的优越特性,本文对具有表1所示相同特性参数的常规AlGaN/GaN HEMT也进行了仿真.
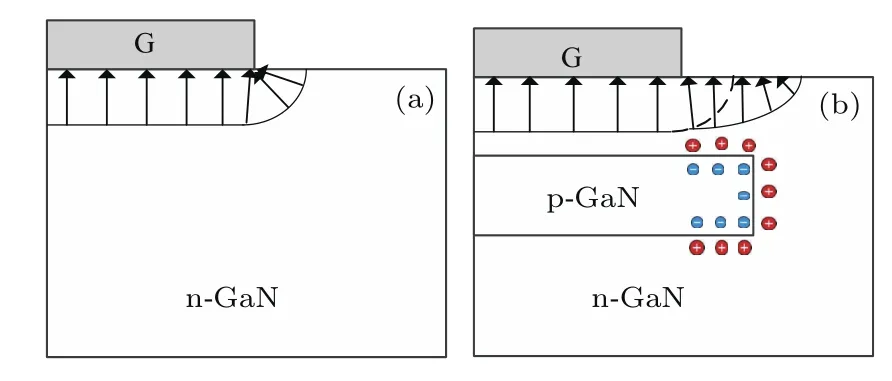
图2 (网刊彩色)(a)常规AlGaN/GaN HEMT和(b)PIBL AlGaN/GaN HEMT电力线分布Fig.2.(color online)Electric line distributions of the(a)AlGaN/GaN HEMT and(b)PIBL AlGaN/GaN HEMT.

表1 仿真中涉及的相关器件参数Table 1.Device parameters used in simulation.
除了表1中用到的器件仿真参数外,在模型参数中,设定p-GaN岛状埋层空穴迁移率为15 cm2/(V·s),2DEG迁移率为1500 cm2/(V·s),GaN亲和势为3.8,AlGaN亲和势为3.52.采用固定的正电荷来模拟异质结界面处的正极化电荷,面密度为1×1013cm−2,文中的仿真不考虑表面态和栅隧穿模型,器件击穿是由碰撞电离引起的,碰撞电离率为α0exp(−Ec/E),其中α0为碰撞电离系数,设为2.9×108/cm;Ec为临界击穿电场强度,设为3.4×107V/cm[20].
3 结果与讨论
PIBL AlGaN/GaN HEMT和常规AlGaN/GaN HEMT的关态I-V特性如图3所示,其中PIBL HEMT的tp=0.2µm,t=0.2µm,NPI=1.34×1017cm−3,两个器件的栅漏间距(Lgd)均为10µm,器件的击穿电压定义为栅压(Vgs)为−6 V下当漏极电流达到1 mA/mm时的漏极电压.由图3可以明显看出PIBL结构HEMT的击穿电压达到了1700 V,而常规结构HEMT的击穿电压仅有580 V.这表明本文提出的PIBL结构的平均击穿电场高达1.7 MV/cm,而常规AlGaN/GaN HEMT的平均击穿电场只有0.58 MV/cm,仅为PIBL结构的1/3.
图4给出了PIBL AlGaN/GaN HEMT和常规AlGaN/GaN HEMT在击穿点处的体等电位分布.可以看出,由于埋层p-GaN岛的调制效应,PIBL结构的等电位轮廓分布比常规结构的等电位轮廓分布更加均匀,特别是在掩埋p型岛的边缘处电场的分布均匀性对比最为明显.PIBL结构中六个等距离的p-GaN岛掩埋缓冲层起着与场限制环或场板相似的作用[21],使器件的电压分布在更大的范围上,因此PIBL结构具有更高的击穿电压.
图5显示了PIBL AlGaN/GaN HEMT和常规AlGaN/GaN HEMT在击穿电压下的界面电场(y=0.229µm)和表面电场(y=0.001µm)分布.埋层p-GaN岛引入的多个反向p-n结在界面位置处形成了新的电场峰,有效地调制了器件的体电场分布,同时PIBL结构的表面也产生了五个新的表面电场峰,这表明器件的横向电场被有效优化,有助于获得更高的击穿电压.

图3 (网刊彩色)PIBL AlGaN/GaN HEMT和AlGaN/GaN HEMT的关态I-V特性Fig.3.(color online)Off-state I-V characteristics of the PIBL AlGaN/GaN HEMT and the AlGaN/GaN HEMT.

图4 (网刊彩色)击穿点处(a)PIBL AlGaN/GaN HEMT和(b)AlGaN/GaN HEMT的等电位分布Fig.4.(color online)Equipotential contour distributions at breakdown point for(a)the PIBL AlGaN/GaN HEMT and(b)AlGaN/GaN HEMT.
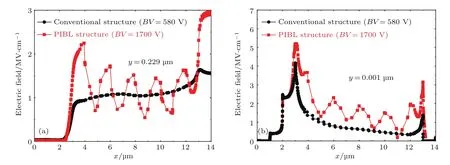
图5 (网刊彩色)击穿电压下PIBL AlGaN/GaN HEMT和AlGaN/GaN HEMT 的(a)界面电场(y=0.229µm)和(b)表面电场(y=0.001µm)分布Fig.5.(color online)Distributions of(a)interface electric fi elds(y=0.229µm)and(b)surface electric fi elds(y=0.001µm)at breakdown point for PIBL and AlGaN/GaN HEMT.
由于缓冲层中存在的泄漏电流是引起HEMT击穿的重要原因之一,图6展示了Vgs=−6 V,Vds=400 V时两种AlGaN/GaN HEMT结构的电子浓度分布.显然,在相同电压偏置下,PIBL HEMT缓冲层中的电子已经完全耗尽,缓冲层泄漏电流得到抑制,而常规HEMT缓冲层中仍然存在大量的电子.这是因为在PIBL结构中,p-GaN岛通过与缓冲层形成p-n结把漏端的高电压分散到缓冲层,使得源漏下方的体电场更高,等势线分布更加密集(如图4),更好地耗尽缓冲层电子.因此,与常规结构相比,PIBL结构通过减小缓冲层泄漏电流,降低了由泄漏电流引起的碰撞电离的概率,进而抑制了雪崩击穿的发生[22,23].
对于GaN基电力电子器件而言,单独提高器件的击穿电压是无意义的,通常要确保器件在获得高击穿电压的同时具有较低的导通电阻.因此,本文还研究了PIBL HEMT和常规AlGaN/GaN HEMT的输出特性和转移特性,如图7所示.输出特性的仿真范围为Vgs由−4 V变化至2 V,步长为2 V,转移特性在Vds为15 V下进行仿真.从图7可以观察到PIBL HEMT与常规HEMT相比具有较小的输出电流,表明PIBL HEMT的导通电阻略大于常规器件的导通电阻,这可能是因为引入的p-GaN埋层部分耗尽了2DEG沟道中的电子浓度导致的.但是从上述分析可以看出,PIBL HEMT的击穿电压显著提高到1700 V,特征导通电阻(Ron,sp)仅为1.47 mΩ·cm2,品质因数(FOM=BV2/Ron,sp)达到1966 MW·cm−2.
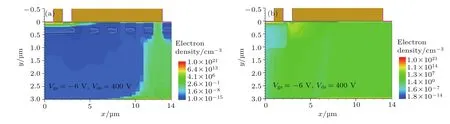
图6 (网刊彩色)(a)PIBL AlGaN/GaN HEMT和(b)AlGaN/GaN HEMT的关态电子浓度分布Fig.6.(color online)Off-state electron concentration distributions for(a)PIBL AlGaN/GaN HEMT and(b)Al-GaN/GaN HEMT.
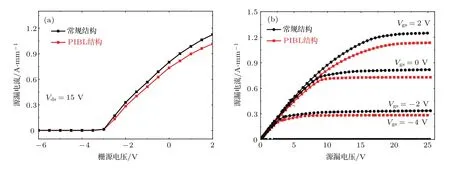
图7 (网刊彩色)PIBL AlGaN/GaN HEMT和AlGaN/GaN HEMT的(a)转移特性和(b)输出特性Fig.7.(color online)(a)output characteristics and(b)transfer characteristics of PIBL AlGaN/GaN HEMT and AlGaN/GaN HEMT.
为优化器件结构,图8展示了不同器件参数对PIBL AlGaN/GaN HEMT击穿特性的影响.图8(a)显示了t对击穿电压的影响,其中tp=0.2µm.由图8(a)可以看出,t=0.15,0.2,0.25µm时,对应每条曲线都有一个最优化的NPI,并且最优化的NPI随着t的增大而增加.这是因为t越大,p-GaN岛距离AlGaN势垒就越远,这种情况下需要更大的最优化NPI才能使p-GaN岛与缓冲层形成更大的掺杂浓度差,从而形成更大的空间电荷区,以便对器件表面的电场有更强的调制作用.当t=0.2µm,NPI=1.34×1017cm−3时,器件获得最大击穿电压为1700 V.图8(b)显示了tp对击穿电压的影响,可以看出器件的击穿电压随着tp的减少而增强.因为仿真模型中背景掺杂浓度是固定的,根据电荷平衡原理,当p-GaN埋层越薄时,其最优化掺杂浓度也越高,此时p-n结的p型区域和n型区域之间的掺杂浓度差越大(n型区域的空间电荷区更大),对电场的调制作用越强.当tp=0.1µm时,PIBL AlGaN/GaN HEMT的击穿电压可以达到1789 V.由此可以看出,较薄的埋层p-GaN岛应该有助于实现更显著的电场调制并使器件获得更高的击穿电压.
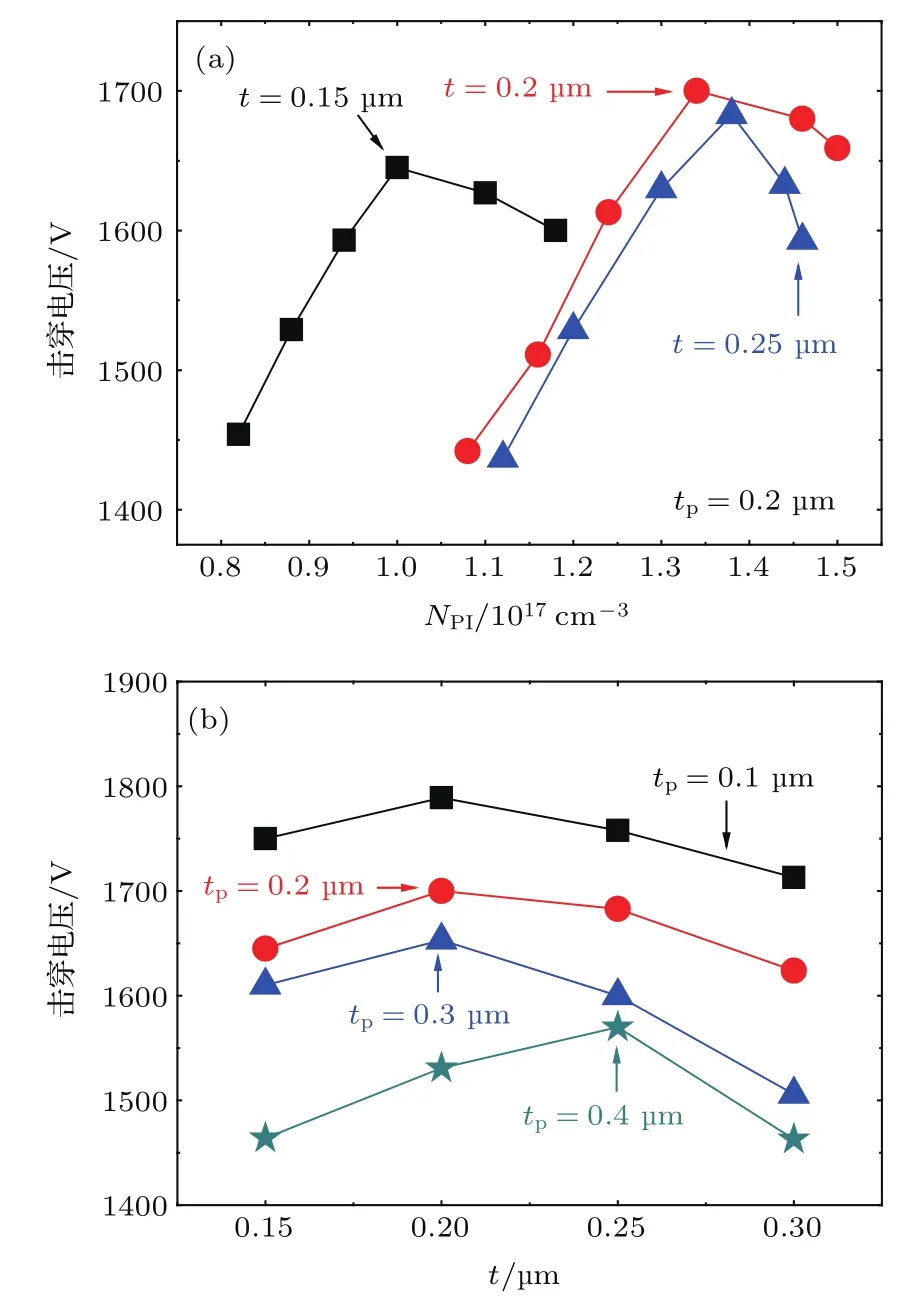
图8 (网刊彩色)不同器件参数(a)t和(b)tp对PIBL Al-GaN/GaN HEMT击穿特性的影响Fig.8.(color online)In fl uences of device parameters on breakdown characteristics for PIBL AlGaN/GaN HEMT:(a)t on the BV(tp=0.2µm),and(b)tpon the BV.
4 结 论
提出了一种新型PIBL AlGaN/GaN HEMT耐压结构,并使用Sentaurus TCAD仿真软件,从关态I-V特性、电场分布和关态载流子分布等方面对器件特性进行了详细的仿真分析,结果显示引入的p-GaN埋层在较高漏极电压下能形成反向偏置的p-GaN/n-GaN结,有效地调节器件的电场分布,同时能有效耗尽缓冲层中的载流子,减小缓冲层漏电,使PIBL AlGaN/GaN HEMT的击穿电压显著提高.对器件的结构优化显示,当t=0.2µm,tp=0.1µm时,Lgd=10µm的PIBL HEMT器件能实现高达1789 V的击穿电压,同时PIBL AlGaN/GaN HEMT的特征导通电阻仅为1.47 mΩ·cm2,品质因数(FOM=BV2/Ron,sp)高达1966 MW·cm−2.
[1]Zhang W,Li X,Zhang J,Jiang H,Xu X,Guo Z,He Y,Hao Y 2016Phys.Status Solidi213 2203
[2]Yu X X,Ni J Y,Li Z H,Kong C,Zhou J J,Dong X,Pan L,Kong Y C,Chen T S 2014Chin.Phys.Lett.31 037201
[3]Xie G,Edward X,Hashemi N,Zhang B,Fred Y F,Wai T N 2012Chin.Phys.B21 086105
[4]Mao W,Yang C,Hao Y,Zhang J C,Liu H X,Bi Z W,Xu S R,Xue J S,Ma X H,Wang C,Yang L A,Zhang J F,Kuang X W 2011Chin.Phys.B20 017203
[5]Luo J,Zhao S H,Mi M H,Chen W W,Hou B,Zhang J C,Ma X H,Hao Y 2016Chin.Phys.B25 027303
[6]Li X,Hove M V,Zhao M,Geens K,Lempinen V P,Sormunen J 2017IEEE Electron.Dev.Lett.38 99
[7]Mi M H,Zhang K,Chen X,Zhao S L,Wang C,Zhang J C,Ma X H,Hao Y 2014Chin.Phys.B23 077304
[8]Xie G,Edward X,Lee J,Hashemi N,Zhang B,Fu F Y 2012IEEE Electron.Dev.Lett.33 670
[9]Zhang N Q,Keller S,Parish G,Heikman S,DenBaars S P,Mishra U K 2000IEEE Electron.Dev.Lett.21 421
[10]Kim Y,Lim J,Kim M,Han M 2015Phys.Status Solidi C8 453
[11]Deguchi T,Kamada A,Yamashita M,Tomita H,Arai M,Yamasaki K,Egawa T 2012Electron.Lett.48 109
[12]Nanjo T,Kurahashi K,Imai A,Suzuki Y,Nakmura M,Suita M,Yagyu E 2014Electron.Lett.50 1577
[13]Wang M,Chen K J 2010IEEE Trans.Electron Dev.Lett.57 1492
[14]Boles T,Varmazis C,Carlson D,Palacios T,Turner G W,Molnar R J 2013Phys.Status Solidi10 844
[15]Ha W J,Chhajed S,Oh S J,Hwang S Y,Kim J K,Lee J H,Kim K S 2012Appl.Phys.Lett.100 132104
[16]Cheng J B,Zhang B,Sun W F,Shi L X,Li Z J 2014Superlattice Microst.76 288
[17]Cheng J B,Zhang B,Li Z J 2008Electron.Lett.44 933
[18]Wu Y F,Saxler A,Moore M,Smith R P,Sheppard S,Chavarkar P M,Wisleder T,Parikh P 2004IEEE Electron Dev.Lett.25 117
[19]Ando Y,Okamoto Y,Miyamoto H,Nakayama T,Inoue T,Kuzuhara M 2003IEEE Electron.Dev.Lett.24 289
[20]Mao W,Fan J S,Du M,Zhang J F,Zheng X F,Wang C,Ma X H,Zhang J C,Hao Y 2016Chin.Phys.B25 127305
[21]Cheng X,Sin J K O,Shen J,Huai Y J,Li R Z,Wu Y,Kang B W 2003IEEE Trans.Electron.Dev.50 2273
[22]Dora Y,Chakraborty A,Heikman S,Mccarthy L,Keller S,Denbaars P 2006IEEE Electron Dev.Lett.27 529
[23]Verzellesi G,Morassi L,Meneghesso G,Meneghini M,Zanoni E,Pozzovivo G 2014IEEE Electron Dev.Lett.35 443
