聚焦离子束(FIB)直写技术研究
2017-11-21
东南大学机械工程学院,江苏南京 211189
一、引言
现代半导体制造业迅速发展,对产品的质量要求越来越高,对相关的微分析技术的要求也越来越高。除了IC制造以外,纳米结构在新元件上应用越来越多,特别是纳米光子和纳米光学。
聚焦离子束( Focused Ion Beam,FIB) 系统是在常规离子束和聚焦电子束系统研究的基础上发展起来的,除具有扫描电子显微镜具有的成像功能外,由于离子质量较大, 经加速聚焦后还可对材料和器件进行刻蚀、沉积、离子注入等微纳加工[1],因而在纳米科技领域起到越来越重要的作用。
FIB的加工是通过离子束轰击样品表面来实现的。在FIB加工系统中,来自液态金属离子源的离子束经过加速、质量分析、整形等处理后, 聚焦在样品表面。离子束斑直径目前已可达到几个纳米[2],其加工方式为将高能离子束聚焦在样品表面逐点轰击,可通过计算机控制束扫描器和消隐组件来加工特定的图案。
本文以实验为基础,从具体的实验结果分析各加工参数对刻蚀结果的影响,主要讨论微纳图形加工过程中,FIB系统工作参数对刻蚀结构的影响。FIB刻蚀过程中,离子束强度对于束斑的聚集性有所影响;改变离子束的入射电流直接改变了离子束刻蚀速率;随着离子束驻留时间的增加,再沉积效应的影响越来越明显。在实际刻蚀应用中,熟练掌握各参数对溅射刻蚀的影响,可以大大提高加工效率,同时也能减小因加工参数选择不当造成加工错误的可能性。
二、离子束强度的影响
离子源聚焦到样品表面时,其能量呈高斯分布[3],设计简单实验初探能量对结构的影响对下一步实验具有指导意义。
实验方法:本文研究的各微纳图形均在Si(100)晶片上进行,预先将其切割为需求大小(5mm*10mm)。每次实验前会通过光学显微镜在晶片上查找一块干净区域,并在此区域周边滴上银胶标记,既能方便定位查看结果,又能利用银胶边缘结构快速聚焦。在刻蚀中,纳米图形结构轮廓、形貌特征与不同的工艺参数密切相关。
实验内容:在其他参数一致的情况下,改变离子束强度,研究离子束强度的高斯分布对实验结果的影响。设定结构尺寸为2μm*2μm,驻留时间为50μs,深度设置为100nm,离子束能量取5keV、30keV,研究离子束能量的改变对刻蚀结构的影响。
图1为两种能量下刻蚀方形结构的52°倾斜视图。根据标尺测量知,5keV时矩形宽度为3068nm,30keV时矩形结构宽度为2269nm,刻蚀宽度分别比设定的参数大53.4%和13.45%,由于入射离子剂量相同,实验结果表明,刻蚀中5keV时束斑更宽,而入射离子速度变慢,刻蚀能力变低,聚焦性更差。因此在实际应用中,根据需求选择不同的能量可以达到不同的效果,如透射电子显微镜(TEM)制备过程中,粗切时就需要选用30keV进行材料去除,而在减薄过程中则可以选择入射速度较小的离子轰击,慢慢减薄。
另外,从图1(b)中可以观察到,设计的方形结构轮廓,结构的边缘并非垂直侧壁。这是由于入射的束流轮廓呈高斯分布的原因,去除材料主要由能量在半高宽以上的离子分布决定,而半高宽以下分布的离子(beam tail)导致刻蚀出的侧壁非垂直形貌。
三、离子束电流的影响
离子束电流的增加导致入射离子剂量随着增加,不同电流扫描同样的结构时,电流越大结构轮廓尺寸也会越大[4]。设定三组线结构实验,相同参数包括:不同电流下刻蚀的线轮廓长度均为10μs,驻留时间是50μs,扫描总时间为20s;三组实验中电流变化依次为1.5pA、9.7pA和48pA。图2中结果为线结构俯视图,由于线结构轮廓尺寸较小,很难观察到,因此采用原子力显微镜(AFM)对尺寸进行测量,主要对比结构的宽度和深度变化情况。
图3分别为入射电流1.5pA、9.7pA和48pA线结构的原子力显微镜(AFM)轮廓结果,根据AFM测量结果量取三种电流下线结构深度和宽度,如图4所示。

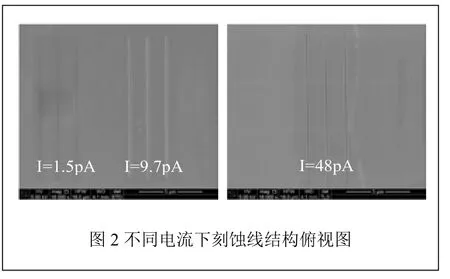
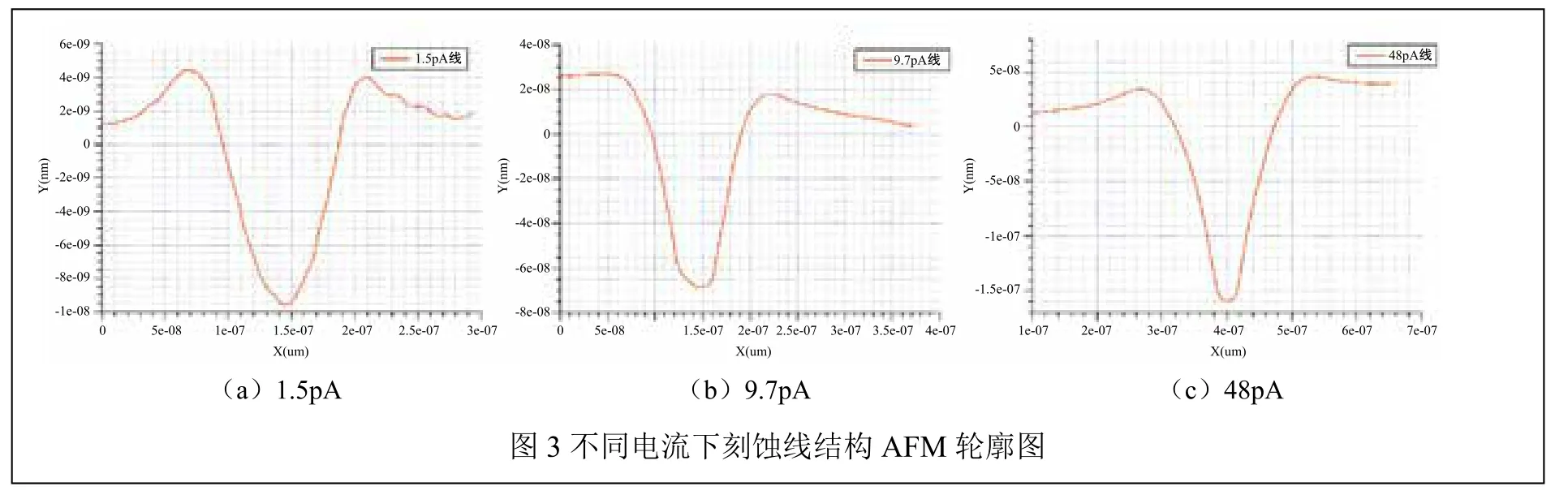

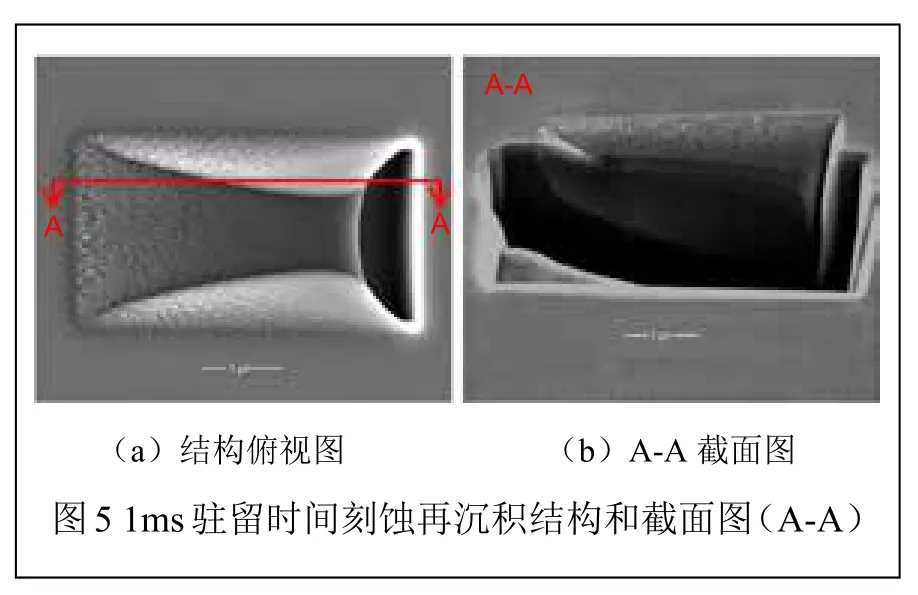
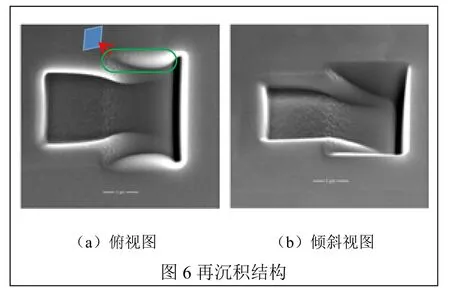
线结构的AFM测量结果表明,随着电流的增加,入射的离子数增加,相同的时间内,电流越大刻蚀的线轮廓越深,宽度变化比较缓慢。小电流可用来刻蚀纳米级尺寸,大电流材料去除能力较强[5],实际应用中应当根据不同的需求选用不同的电流进行加工。
四、离子束驻留时间对结构形貌的影响
FIB加工过程中,在单点停留时间称为驻留时间[6]。在蚀刻过程中,当入射离子驻留时间增加时,再沉积效应随之产生,此时刻蚀的形貌结构由于再沉积影响发生变化,因此在测量溅射产额时,研究驻留时间变化对结构的影响是有必要的。
如图5刻蚀矩形2μm*4μm结构,驻留时间选择1ms,刻蚀1次,扫描方向为从左到右。从截面结果可以看到,整个扫描过程中,一次刻蚀深度曲线式加深,并从开始边界到结束始终有再沉积存在,并在两侧壁形成再沉积非晶层。
五、再沉积对结构形貌的影响
驻留时间较大时,会存在再沉积效应,利用再沉积可以刻蚀出一些奇特的形貌轮廓[7]。如图6所示,预先用小驻留时间(50μs)刻蚀方形结构,扫描次数为20次;再将驻留时间增加至1000μs后加工矩形结构,扫描次数为1次,要求此矩形结构交于方形结构的边缘。
根据之前实验可知,第二次刻蚀矩形结构一定存在再沉积效应,当遇到有一定深度的结构时,由于边界侧壁非垂直结构,当扫描矩形结构刻到倾斜边界上时,去除材料的能力增加,刻蚀速度增大。两侧类似肋板的结构,是由于再沉积堆积存在方向性。第二次结构初始扫描时,与方形重叠作用产生一方形轮廓,后续再沉积时就会沿着这一方形轮廓继续堆积,所以最后堆积出一类似肋板的结构。
六、结论
FIB的微纳图形制备过程中,不同的加工工艺对结构形貌产生一定的影响。材料去除时离子束能量采用30keV时,结构形貌和预设的基本一致,小能量加工离子束的聚焦性分散,目前在TEM制备中有所应用;相同能量下,不同的入射电流直接改变入射剂量,小电流可用来刻蚀纳米级结构;当增加驻留时间时,再沉积效应影响更明显,再沉积堆积过程中有一定的方向性,可利用其堆积原理制备奇异的再沉积结构。因此在实际应用中,应当根据实际制备需求采用不同的加工工艺加工,才能最终刻蚀出理想的形貌。
