化学机械平坦化材料对蓝宝石抛光速率与粗糙度的影响*
2016-05-17贾少华刘玉岭王辰伟闫辰奇
贾少华,刘玉岭,王辰伟,闫辰奇
(河北工业大学 微电子技术与材料研究所,天津 300130)
化学机械平坦化材料对蓝宝石抛光速率与粗糙度的影响*
贾少华,刘玉岭,王辰伟,闫辰奇
(河北工业大学 微电子技术与材料研究所,天津 300130)
摘要:采用自主研制的新型碱性蓝宝石抛光液,在蓝宝石化学机械平坦化过程中加入FA/O型非离子表面活性剂,该活性剂能够减小蓝宝石表面粗糙度,同时,在蓝宝石抛光速率下降不明显的情况下实现较高的凹凸去除速率差,有利于实现蓝宝石的全局平坦化。通过实验得到了碱性条件下抛光速率较高、粗糙度较小的最佳pH值。研究了等质量分数等粒径条件下磨料分散度以及抛光温度对抛光速率和蓝宝石表面粗糙度的影响。
关键词:蓝宝石;CMP;活性剂;分散度;温度
0引言
蓝宝石具有很多为人熟知的特性,例如硬度高、耐磨损、耐高温、抗腐蚀、良好的电气规范和光传输特性。因为蓝宝石具有与Ⅲ族氮化物相同的六方密堆积结构且晶向生长技术优良[1],所以,蓝宝石主要用作第三代半导体材料GaN的衬底,在微电子工业以及光电技术领域也有广泛的应用[2]。在光电子领域,随着蓝宝石光电技术的快速发展,蓝宝石已经成为一种极为重要的光电材料,例如,蓝宝石晶体是制造GaN发光二极管(LED)、光学窗口、激光器以及反射器的首选衬底材料[3-6]。
由于蓝宝石导热系数较低,出于对制作薄膜发光二极管以及表面质量温度传感的严格要求[7],在抛光过程中蓝宝石衬底必须被去除。同时,由于蓝宝石表面缺陷对器件性能影响很大,目前要求蓝宝石表面超光滑、无缺陷,且表面粗糙度<0.2 nm,因此,如何找到一种能够高速有效去除蓝宝石并获得良好蓝宝石表面质量的方法至关重要。
陶瓷器件的性能和质量很大程度上依赖于衬底的表面精密加工,传统的纯机械抛光是用抛光粉不断地研磨被抛光材料的表面,通过不断减小磨料颗粒的大小来减小划伤,这种方法从根本上解决不了容易产生较深划伤的问题[8]。结合化学与机械作用,成本较低的CMP是目前可以实现全局平坦化最有效的蓝宝石抛光方法,也是迄今为止在蓝宝石大规模生产中普遍应用的抛光方法。但是由于蓝宝石抛光液成分以及抛光工艺的不同,在蓝宝石的CMP过程中存在两个主要问题:(1) 蓝宝石的抛光速率低,生产效率无法满足工业要求;(2) 蓝宝石表面质量差,存在划痕、凹坑等缺陷,降低了成品率[9-10]。
本文使用了自主研发的蓝宝石抛光液,选择分散度较低的SiO2作为磨料粒子,大大增加了蓝宝石抛光速率。同时,加入非离子表面活性剂,降低了蓝宝石表面张力,有利于SiO2磨料粒子的分散,不易凝胶,从而提高了抛光过程的一致性,降低了蓝宝石表面粗糙度,利于实现全局平坦化。同时,通过精确的抛光过程,实现表面平滑无划伤的蓝宝石晶元。
1实验
1.1实验设备与材料
1.1.1实验材料
河北工业大学微电子技术与材料研究所研制的新型蓝宝石碱性抛光液(SiO2作为磨料粒子);自主研发的FA/O Ⅰ型非离子表面活性剂;pH值调节剂(助剂);使用前与DIW按5∶3比例稀释;用于研究抛光速率及表面粗糙度的直径50.8 mm蓝宝石晶元。
1.1.2实验设备
法国Alpsitec公司生产的E460E型抛光机; X IC1000 (TM) A2 PAD DH2 24.7”ACAO*G01型抛光垫;原子力显微镜,AFM 5600LS,Agilent,美国;XP-300表面分析器分析天平,精确度为0.1 mg,Mettle Toledo AB204-N;PHB-4型手提式 pH 计,上海INESA科学仪器公司;厚度测试仪,结合测量膜厚与称重两种方法计算抛光去除速率以减小误差;NICOMP 380ZLS激光粒度仪。
1.2实验方法与分析测试
1.2.1实验方法
蓝宝石抛光液配制:磨料硅溶胶(SiO2质量分数40%),加入不同浓度FA/O型非离子表面活性剂和pH值调节剂调节抛光液,使用前按5∶3比例稀释(pH值=9.6,10.0,10.4,10.8,11.2,11.6和12.0),配成不同蓝宝石抛光液。抛光过程中抛光工艺如表1所示。

表1 蓝宝石CMP抛光工艺
注:Slurry flow rate 100%=300 mL/min。
1.2.2分析测试
每次使用前对抛光垫进行1 min的修正,根据5∶3的稀释比例将原液直接稀释成蓝宝石抛光液,对50.8 mm蓝宝石片进行为时3 600 s的抛光,通过称重和测量膜厚的方法计算蓝宝石抛光速率。其中测量膜厚时在蓝宝石片上均匀选取5个点,取点方式如图1所示,使用测膜厚仪测量抛光前后5个点处的膜厚, 5个点速率的平均值即为蓝宝石的抛光速率。而称重方法则按照下式计算
其中,Δm为时间t内去除蓝宝石质量,ρ为蓝宝石密度(4.0 g/cm3),r为蓝宝石晶元半径,t为抛光时间。使用TEM测量磨料粒径及其分散度。比较抛光液pH值、等质量分数等粒径条件下分散度、表面活性剂浓度以及温度对抛光速率和蓝宝石表面粗糙度的影响。

图1 蓝宝石测量点的选取
2结果与讨论
2.1pH值对蓝宝石去除速率和表面粗糙度的影响
实验采用自主研制的碱性蓝宝石抛光液,其中包含pH值较高且含有多个螯合环的FA/O型螯合剂,它能够迅速与氧化铝反应产生稳定产物,结合CMP过程中的机械作用,使得产物被迅速带离蓝宝石表面,实现蓝宝石表面的平坦化,提高蓝宝石去除速率。同时加入助剂调节抛光液pH值,不同pH值(9.6,10.0,10.4,10.8,11.2,11.6和12.0)对蓝宝石去除速率的影响如图2所示。
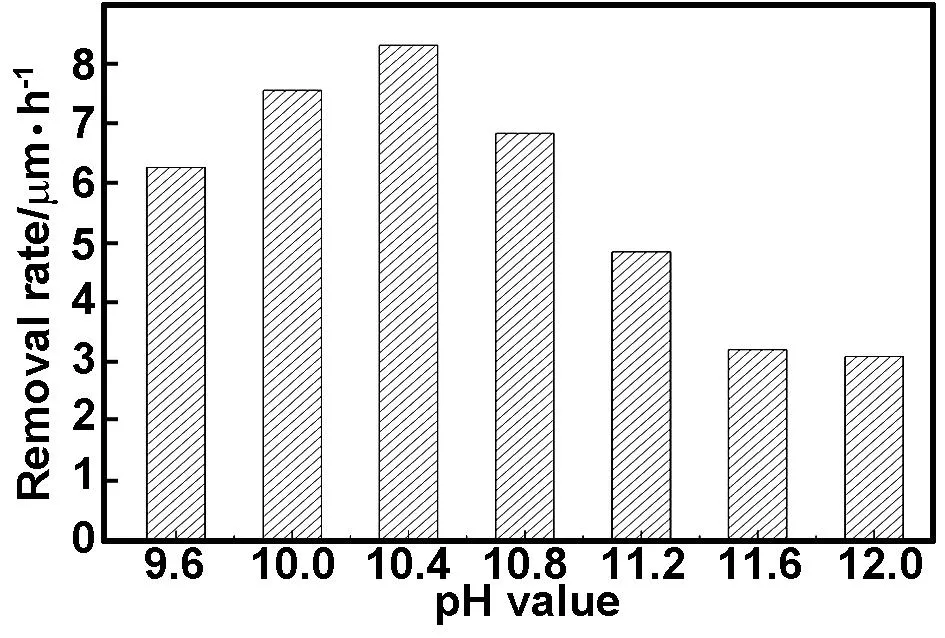
图2 不同pH值对蓝宝石去除速率的影响
Fig 2 Effect of different pH value on removal rate of sapphire
从图2可以看出, pH值从9.6变化到10.4的过程中,抛光速率持续上升,当pH值=10.4时,抛光速率达到最大值,为8.32 μm/h。继续添加pH值调节剂,pH值增大,抛光速率逐渐下降,当pH值到达11.6甚至更大时,抛光速率较低在3 μm/h左右,且变化缓慢。经分析可得:在碱性条件下,蓝宝石表面发生了反应式(1)、(2)
(1)
(2)
当pH值较低,即OH-含量较低时,发生反应式(1),此时,随着pH值的升高,氧化铝被去除速率加快,即蓝宝石去除速率增大。然而,当pH值较高时,反应式(2)伴随发生,从化学平衡角度来说,阻挡反应式(1)进行,因此反应速率有所下降。
不同pH值(9.6,10.4,11.2和12.0)对蓝宝石表面粗糙度的影响如图3所示。从图3可以看出,蓝宝石表面粗糙度在pH值为10.4时最小,为0.182nm,随着pH值的增大粗糙度有所增大。经分析得自主研制的螯合剂羟基含量多,能够降低抛光液表面张力,增大抛光液与反应界面间的接触角,在增加去除速率的同时,降低了蓝宝石表面粗糙度。
2.2同质量分数等粒径条件磨料分散度对蓝宝石去除速率和表面粗糙度的影响
2.2.1磨料分散度对蓝宝石去除速率的影响
CMP过程中的磨料粒子具有机械研磨和质量传递的作用,磨料粒子通过抛光垫使反应物迅速到达反应表面,生成物被快速带离反应表面,提供新的反应表面使反应继续进行,加快蓝宝石的去除速率[11-12]。如图4所示,图4(a)-(d)分别为4种同质量分数相同粒径不同分散度的蓝宝石抛光液,四者横坐标集中度逐渐升高,表明磨料粒子分散度依次降低。如图5所示,图5(a)-(d)为4种不同磨料分散度抛光液对蓝宝石的抛光速率。
从图5可以看到,抛光速率随磨料分散度的减小而增大。在抛光过程中,参与反应的粒子称为有效粒子[12],磨料分散度影响最大的就是有效粒子数,在反应过程中,粒径较大的磨料粒子参与反应,而粒径较小的不参与反应。同质量分数同粒径的情况下,磨料分散度越低,粒径差别越小,参与反应的有效粒子数越多,与蓝宝石表面所谓接触面积越大,同时质量传递作用也因有效粒子数的增多而增强,从而提高了蓝宝石的去除速率。
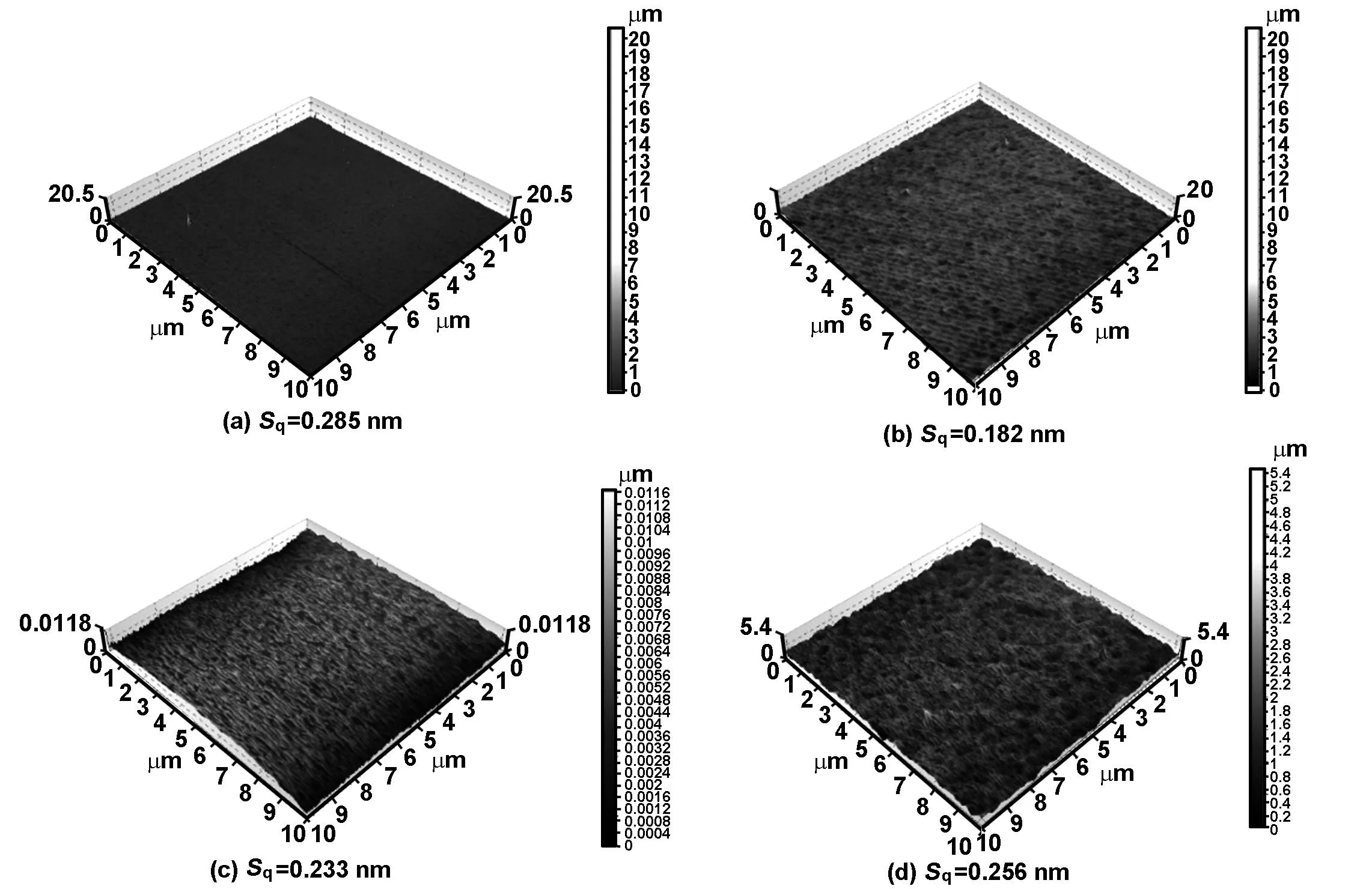
图3 不同pH值对蓝宝石表面粗糙度的影响

图4 同质量分数相同粒径不同磨料分散度蓝宝石抛光液
2.2.2磨料分散度对蓝宝石表面粗糙度的影响
如图6所示,为同质量分数相同粒径不同分散度抛光液对蓝宝石表面状态的影响,图6(a)-(d)蓝宝石表面粗糙度依次减小。
从图6可以看出,磨料分散度越低,蓝宝石表面粗糙度越低,即表面质量越好。质量传递过程对CMP后蓝宝石表面状态影响很大,化学反应的均匀性与质量传递息息相关,这在很大程度上影响了蓝宝石表面凹凸速率的选择性,进而影响全局平坦化的实现。较低磨料分散度伴随着更多有效粒子,有利于质量传递,因此低分散度能得到更好的蓝宝石表面状态,即表面粗糙度随分散度的降低而减小。

图5不同磨料分散度对蓝宝石抛光速率的影响
Fig 5 Effect of different abrasive dispersion on sapphire removal rate
2.3表面活性剂对表面粗糙度以及抛光速率的影响
如图7(a)、(b)分别为不加活性剂和添加一定量活性剂的抛光液对蓝宝石粗糙度的影响,从图7可以看出,添加一定量的活性剂,蓝宝石表面粗糙度明显下降。自主研制的FA/O型非离子表面活性剂能够有效降低表面张力,由于活性剂中极性键的键合作用,活性剂与蓝宝石抛光表面接触角增大,从而增加了凹凸速率选择比,减小了表面粗糙度。同时,表面活性剂的加入有利于加强质量传递过程以及抛光过程去除速率一致性,实现较低表面粗糙度[12]。因此,表面活性剂的加入使得表面粗糙度有所下降。
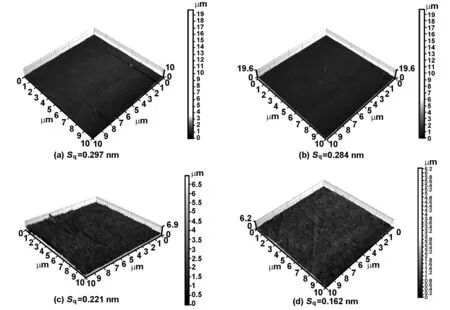
图6 不同磨料分散度对蓝宝石表面粗糙度的影响
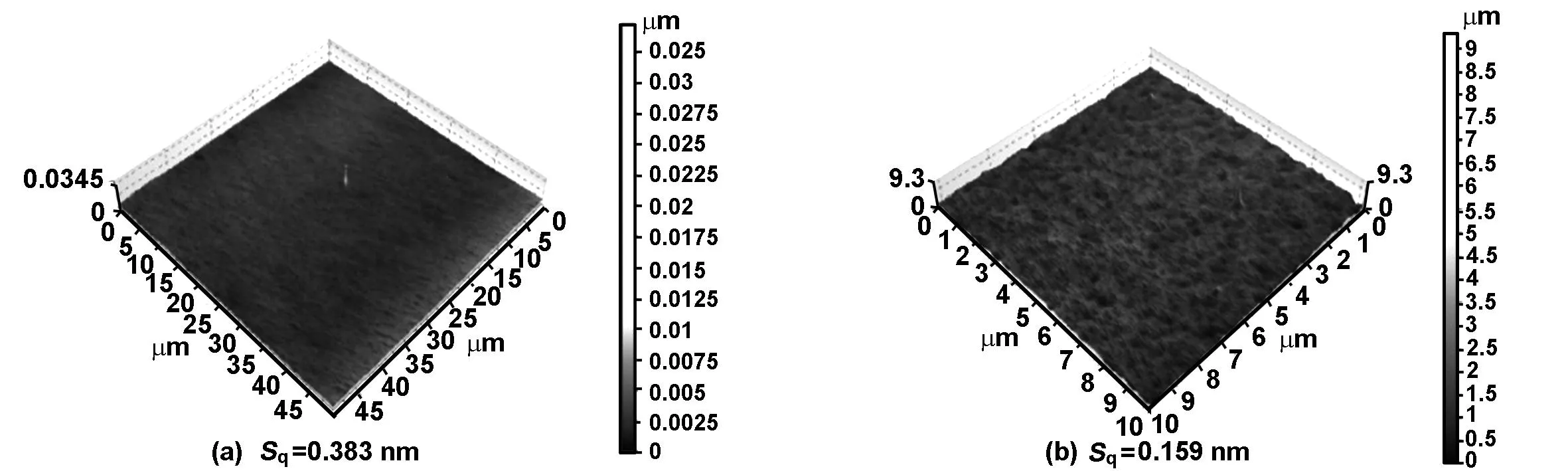
图7 不同活性剂浓度抛光液对蓝宝石表面粗糙度的影响
活性剂不仅仅具有前面所说的正作用,由于极性键的存在,活性剂的使用增加了蓝宝石抛光液的吸附作用,占用了反应表面反应面积,减小了有效反应面积,影响反应的质量传递过程,导致去除速率有所下降,但是影响不大,下降趋势比较缓慢。表2为不加活性剂和添加活性剂两种情况下蓝宝石的抛光速率。
同时,活性剂在蓝宝石表面凹处具有一定的钝化作用,能够保护凹处的蓝宝石不被去除,阻止其进一步反应。凸处蓝宝石由于CMP过程较大的动能被快速去除,实现了较高的凹凸速率差,因此表面活性剂的加入使得全局平坦化效果增强。
2.4温度对蓝宝石去除速率和表面粗糙度的影响
如图8所示为抛光温度对抛光速率的影响,可以看出,随着抛光温度的升高,蓝宝石去除速率不断增加,且抛光温度对去除速率的影响越来越明显。温度主要影响抛光过程中的质量传递以及温度传递过程,抛光温度越高,质量传递越迅速,反应产物能够迅速被带离,提供新的反应表面供给反应进行,因此蓝宝石抛光速率增加。同时,由于质量传递的增强,温度的升高也使得表面粗糙度有所下降。表3为抛光温度对表面粗糙度的影响。
表2不同活性剂浓度抛光液对蓝宝石抛光速率的影响
Table 2 Effect of polishing slurry with different surfactant concentration on sapphire removal rate

SurfactantconcentrationRemovalrateofsapphire/μm·h-106.58certaincontent6.22

图8 抛光温度对蓝宝石去除速率的影响
Fig 8 Effect of polishing temperature on sapphire removal rate
表3抛光温度对蓝宝石表面粗糙度的影响
Table 3 Effect of polishing temperature on sapphire surface roughness

Polishingtemperature/℃Roughness/nm20.3~22.70.36225.1~27.80.35640.3~42.30.095
3结论
在蓝宝石CMP过程中,由于FA/O型非表面离子活性剂的加入,降低了抛光液表面张力,减小了蓝宝石表面粗糙度,同时由于活性剂本身的吸附性和钝化性,在蓝宝石去除速率减小不明显的情况下实现了较高的高低去除速率差,利于实现蓝宝石全局平坦化。当pH值=10.4时, 蓝宝石去除速率最大,表面粗糙度达到最佳值0.182 nm。等质量分数等粒径情况下,随着磨料分散度的降低,质量传递过程增强,蓝宝石去除速率提高,同时表面粗糙度减小。另外,温度对质量传递与过程影响较大,升高温度能够在很大程度上加快质量传递过程使得抛光速率迅速增加。
参考文献:
[1]Zhu Zhen. Preparation and characteristics of epitaxial tin oxide films on SiC and sapphire substrates[D].Ji’nan: Shandong University,2012.
朱振. 碳化硅和蓝宝石衬底二氧化锡外延薄膜的制备及特性研究[D]. 济南:山东大学, 2012.
[2]Aida H, Doi T, Takeda H, et al. Ultraprecision CMP for sapphire, GaN, and SiC for advanced optoelectronics materials[J]. Current Applied Physics, 2012, 12: S41-S46.
[3]Zhou Shengjun, Liu Sheng. Study on sapphire removal for thin-film LEDs fabrication using CMP and dry etching[J]. Applied Surface Science, 2009, 255(23): 9469-9473.
[4]Aida H, Takeda H, Aota N, et al. Surface treatment for GaN substrate comparison of chemical mechanical polishing and inductively coupled plasma dry etching[J]. Sensors and Materials, 2013, 25(3): 189-204.
[5]Hsieh C Y, Lin B W, Cheng W H, et al. Semipolar GaN films on prism stripe patterned a-plane sapphire substrates[J]. ECS Journal of Solid State Science and Technology, 2012, 1(1): R54-R56.
[6]Leung K K, Fong W K, Chan P K L, et al. Physical mechanisms for hot-electron degradation in GaN light-emitting diodes[J]. Journal of Applied Physics, 2010, 107(7): 073103.
[7]Wang Haibo, Yu Qincong, Liu Weili, et al. The influence of process conditions on the sapphire chemical mechanical polishing[J]. Journal of Functional Materials and Devices, 2010, 16(3): 206-210.
汪海波, 俞沁聪, 刘卫丽, 等. 工艺条件对蓝宝石化学机械抛光的影响[J]. 功能材料与器件学报, 2010, 16(3): 206-210.
[8]Zhang Zefang, Hou Lei, Yan Weixia, et al. The preparation of nano SiO2polishing liquid and application in sapphire polishing[J]. Lubrication Engineering, 2013, 38(7): 88-91.
张泽芳, 侯蕾, 闫未霞, 等. 纳米SiO2抛光液的制备及在蓝宝石抛光中的应用[J]. 润滑与密封, 2013, 38(7): 88-91.
[9]Zhou Yan, Pan Guoshun, Shi Xiaolei, et al. Effects of ultra-smooth surface atomic step morphology on chemical mechanical polishing (CMP) performances of sapphire and SiC wafers[J]. Tribology International, 2015, 87: 145-150.
[10]Ma Zhenguo, Liu Yuling,Wu Yahong, et al. Research on sapphire substrate nano-CMP [J]. Micronanoelectronic Technology, 2008, 45(1): 51-54.
马振国, 刘玉岭, 武亚红, 等. 蓝宝石衬底nm级CMP技术研究[J]. 微纳电子技术, 2008, 45(1): 51-54.
[11]Xu Wenhu, Lu Xinchun, Pan Guoshun, et al. Effects of the ultrasonic flexural vibration on the interaction between the abrasive particles; pad and sapphire substrate during chemical mechanical polishing (CMP)[J]. Applied Surface Science, 2011, 257(7): 2905-2911.
[12]Liu Yuling, Tan Baimei, Niu Xinhuan, et al. Control technique of sapphire roughness in CMP processing[J]. Journal of Functional Materials,2008,39:209-212.
Effect of chemical mechanical planarization material on sapphire polishing rate and roughness
JIA Shaohua,LIU Yuling,WANG Chenwei,YAN Chenqi
(Institute of Microelectronics Technology and Material,Hebei University of Technology, Tianjin 300130, China)
Abstract:The article adopted a new type of alkaline sapphire polishing slurry self-developed. FA/O nonionic surfactant added in the process of sapphire CMP can decrease sapphire surface roughness. Meanwhile, it realized high removal rate difference of convex and concave area on the condition that the decline trend of removal rate is not so obvious, which is benefit for achieving global planarization of sapphire. Obtain the optimum pH value that can realize relatively higher removal rate and lower roughness through experiment. Also effect of particle dispersion with same mass fraction and particle size and polishing temperature on sapphire removal rate and surface roughness was studied.
Key words:sapphire; CMP; surfactant; dispersion; temperature
DOI:10.3969/j.issn.1001-9731.2016.02.047
文献标识码:A
中图分类号:TN305.2
作者简介:贾少华(1989-),女,河北沧州人,在读硕士,师承刘玉岭教授,从事集成电路工程研究。
基金项目:国家中长期科技发展规划02科技重大专项资助项目(2009ZX02308)
文章编号:1001-9731(2016)02-02242-05
收到初稿日期:2015-04-23 收到修改稿日期:2015-09-30 通讯作者:刘玉岭,E-mail:liuyl@jingling.com.cn
