基于TCAD模拟的Buffer单粒子效应解析分析
2014-09-06李晓辉邱恒功邓玉良
杜 明,邹 黎,李晓辉,邱恒功,邓玉良
(深圳市国微电子有限公司,广东 深圳 518057)
基于TCAD模拟的Buffer单粒子效应解析分析
杜明,邹黎*,李晓辉,邱恒功,邓玉良
(深圳市国微电子有限公司,广东 深圳 518057)
摘要:半导体器件和集成电路的辐射效应,其本质就是电子空穴对的产生和复合、电荷的传输与收集、界面态和氧化层陷阱电荷积累等一系列的物理过程。这些物理过程会受到各种因素的影响,例如上拉补偿管的尺寸、重离子入射角度、器件的外延层浓度等。使用TCAD器件/电路混合模式仿真了以上这些关键变量,同时分析了以上效应对对Buffer电路单粒子效应的影响。最终实验结果证明该模拟方法接近于真实情景。
关键词:混合模拟;TCAD;单粒子效应;缓冲;上拉补偿
近年来,随着单粒子效应对航空航天器的安全运行造成的危害日益突出和严重,国内外利用空间搭载和辐照实验等对器件和整机进行了各种试验[1]。利用空间搭载或辐照实验来获取器件在真正空间应用时可能发生故障的几率的代价是非常昂贵的,不仅影响到实验时间、费用和人力的大量消耗,而且实验过程不易调整和反复移植。TCAD仿真工具可以精确预测辐照环境下的器件性能,评价器件和电路的抗单粒子水平,经济省时且可过程可控。
本文针对当前以及未来主流工艺下影响最为严重的单粒子效应进行研究,并且结合了CMOS集成电路中最基本的元器件—Buffer单元,根据TCAD混合模拟深入探讨了辐射效应模拟方法、重离子物理模型、影响单粒子效应的几种重要因素,为器件的选型和实际辐射环境中单粒子翻转率的预估提供了理论依据。
1 重离子物理模型
在TCAD的器件仿真器SDEVICE中,重离子入射后,跟电流连续性方程所对应的过剩载流子产生率定义为:
G=T(f)R(w)L(I)
式中,R(w)和T(f)分别为描述重离子产生的电子空穴对的空间分布和时间分布[2],L(I)是入射离子的深度函数分布,与离子的种类、能量、射程相关;通常设定R(w)服从指数分布或者高斯分布,T(f)服从高斯分布。
假设重离子注入区域为NMOS的漏区,注入前,漏极接1.2 V电压,衬底接地。模拟的漏区采用长方体对称。NMOS的工艺参数如下:栅氧厚度为2.58,衬底掺杂浓度为5×1014cm-3,源/漏结深为0.08 μm,LDD结深为0.012 μm,LDD浓度峰值为2×1019cm-3。
在对NMOS的SEU进行模拟计算时,物理模型考虑了载流子浓度对寿命影响的SRH复合、Auger复合、载流子散射、迁移率随掺杂浓度变化和禁带变窄等,轰击的重离子采用Gaussian分布建模,载流子输运调用流体动力学模型[3]。其他的模型和参数采用SDEVICE默认。
模拟的基本过程是:构建合理的器件模型后,首先不考虑产生、复合项,求取器件的准稳态解,得到器件的稳态电特性;然后引入辐照效应,在准稳态解的基础上考虑单粒子注入的影响,求得不同LET、不同偏压情况下的单粒子瞬态电流脉冲。
2 单粒子效应的混合模拟和分析
3D器件/电路混合模拟可以用来判断单粒子翻转LET阈值。在仿真计算中首先要根据经验判断出最敏感的区域(通常为MOS晶体管的反偏漏区)。采用混合模拟方法计算出的LET阈值也能与辐照实验结合较好的符合。采用全3D的数值模拟能够模拟器件的灵敏区域的面积,并进而计算得到器件的单粒子翻转截面。
混合模拟中使用的Buffer单元电路结构如图1,其中MP1的尺寸为0.6 μm/0.13 μm,MP2的尺寸为3 μm/0.13 μm,MN2的尺寸为1.38 μm/0.13 μm,这3个MOS管都是使用PDK模型,并且仿真时使用spice2dessis程序将spice网表和BSIM3模型参数整合在dessis识别的*.scf网表中。敏感单管MN1则使用3D器件模型代入。
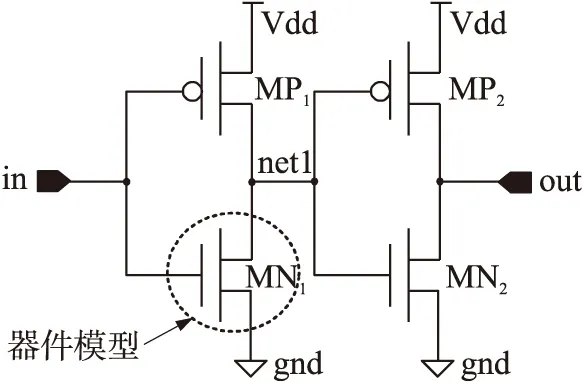
图1 混合模拟所使用的电路结构
混合模拟结果的精确程度与器件模型的准确程度直接相关[4]。建立器件模型时需根据BSIM模型中的已有参数,确定栅氧厚度,初步确定沟道掺杂浓度范围,并通过阈值电压计算沟道表面的掺杂浓度;结合已知的硅衬底电阻率,计算衬底掺杂浓度;然后进行器件校准,针对性的调节一些关键参数,例如LDD区域的掺杂浓度和深度、沟道掺杂浓度和深度等,使得TCAD仿真得到的器件特性和SPICE仿真得到的器件特性符合度达到95%以上。图2所示为130 nm CMOS工艺下经校准后的NMOS器件模型的3D视图。

图2 130 nm CMOS工艺下NMOS的器件模型

图3 重离子入射前后Buffer电路各节点的瞬态输出电压
仿真设定重离子撞击器件发生在0.76 ns时刻(此时NMOS器件MN1处于截止状态),入射方向为垂直入射,入射位置为本文认为的敏感区域即NMOS器件的漏极中心点,粒子入射深度设为穿透整个器件(达到最大入射深度)。粒子轨迹半径为0.1 μm,LET值设定为60 MeV·cm2/mg。电离电荷的产生率在空间和时间上均呈高斯分布。设定模拟初始步长为1 ps,步进为1.4,最大步长为5 ps,电源电压Vdd设定为1.2 V。
图3所示为重离子入射前后Buffer电路各节点的瞬态输出电压曲线。其中左图为重离子入射前的输出电压,右图则是重离子入射后的各节点的输出电压,Buffer单元的第1级输出v(net1)和第2级输出v(out)的逻辑状态都发生了翻转,发生了明显的单粒子效应。
当单粒子轰击工作在截止状态的NMOS管(MN1)的漏区时,会导致漏极和相应阱之间的PN结穿通,并在轨迹上电离产生大量的自由电子空穴对,从而导致漏区的电势瞬间发生翻转,这一过程主要是因为电荷随着粒子轨迹所形成的导电通道迅速被漏极收集,而与该NMOS管相对应的补偿管(MP1)来不及补偿其电势[5]。随后,一方面补偿管会逐渐恢复该MNOS管漏极的电势,另一方面,由于该NMOS管体区的电子迅速被漏极吸收,导致另外一种载流子电荷(空穴)停留在体区,这些遗留的空穴电荷会对该NMOS管体区电势产生扰动,这种扰动就会导致CMOS结构中的寄生双极晶体管导通并使得更多的电荷从该MOS管的源极流向漏极,从而增加了漏极收集电荷的数量,减缓了其电势恢复的过程,最终导致在该MOS管漏极处形成的瞬态电流脉冲出现一个拖尾的“台阶区”,如图4所示。

图5 恢复管尺寸改变对瞬态电流脉冲的影响
2.1补偿管尺寸对瞬态电流脉冲的影响
通常认为MOS管对应恢复电路的驱动能力越强[6],轰击该MOS管漏极产生的瞬态电流脉冲越小。改变NMOS器件对应的恢复管(MP1)的尺寸进行单粒子轰击模拟,模拟结果如图5。从图5可以看出,恢复管的尺寸越大,产生的瞬态电流脉冲峰值增大而脉宽减小。峰值增大是因为漏极收集电荷的数目随着相应恢复管的尺寸增大而增大,这与脉宽减小并不矛盾,根据MOS管的漏结电容计算推导公式:
Cdiff=CjLdW+Cjdw(2Ld+W)
其中,Cj为单位面积的底板电容,Cjdw为单位长度的漏极侧壁电容,二者对于同一种工艺视为常数,W为MOS管的宽度,Ld为漏极长度。从该式子可以看出,当MOS管尺寸值增大时,漏结电容会相应的增大,根据稳定状态下电荷与电容和电压的关系Q=CV,保持相同电位时所需电荷数也会相应的增加,而且决定NMOS器件瞬态电流脉冲宽度的核心因素是漏极吸收电荷的时间长短而非电荷量[7]。
2.2入射角度对漏电流的影响
如图6所示,当入射角度从0°增加到75°时,粒子在敏感区中的电离路径依次增加,相应的有效LET值也会增加,即瞬态电流脉冲峰值和脉宽都随入射角度的增大而增大。

图6 重离子不同入射角度对漏电流的影响
首先,粒子入射角度的不同会导致有效LET值的改变。由于器件的敏感区多为薄的长方体,当入射角度增加时,通过该敏感区的粒子电离路径随之增加,从而淀积更多的能量,即遵从通常所说的余弦定律[8]:
LETeff=LET/cosθ
其次,入射角度增大会导致粒子轨迹在灵敏区中穿透的路径同样以余弦定律边长,从而收集更多的电荷;再次,粒子有效注入量会随入射角度增大而减少[9]。这3种因素的共同作用使得瞬态电流脉冲峰值和脉宽随入射角度增大而增大。

图7 不同外延层浓度对漏电流的影响
2.3外延衬底浓度对漏电流的影响
由图7可见,当外延层浓度变大时,脉冲峰值增大,宽度变窄。这是因为外延衬底浓度大时,少数载流子浓度低,初始时浓度梯度大,扩散作用强[10],所以峰值电流大。而峰值宽度之所以变窄,是因为衬底浓度大,电荷漏斗消失更快,漏斗助漂移作用减小。
一般说来,在高掺杂或中等掺杂的衬底中,一开始是漏斗助漂移占主导,接着就是扩散占主导;而在低掺杂的外延层中,电荷的收集主要靠漏斗助漂移,这是因为这时的电荷漏斗比较强,不容易消失,要使电荷漏斗消失就必须使其电荷通过扩散或漂移达到和衬底一样的浓度。由此可见,在一定程度上,提高外延衬底浓度,可以降低单粒子翻转的概率。
3 翻转截面曲线
翻转截面曲线是指器件的单粒子翻转截面随LET变化的曲线,它用来表征器件抗单粒子翻转能力。我们选用5种不同能量、不同LET值的重离子入射情况进行3D器件/电路混合模拟,最后使用三维数值计算得到重离子引起的翻转截面曲线。同时进行重离子宽束实验利用HI-13串列加速器宽束开展了对测试片的单粒子效应试验获得了器件的单粒子翻转截面与LET值之间的关系曲线,3D混合模拟计算和辐照实验得到的翻转截面曲线如图8所示。
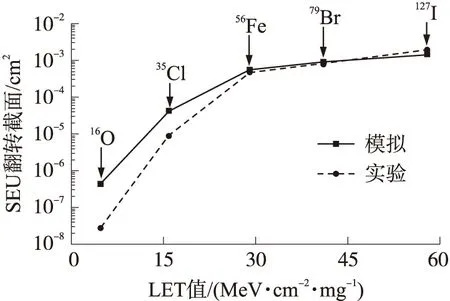
图8 三维模拟数值计算和辐照实验得到的器件翻转截面曲线
从图8可以看出,重离子加速器实验结果和三维数值模拟计算得到的结果符合度较高,两种翻转截面的差异小于15%,这表明通过三维数值计算可以比较准确的预测重离子引起的翻转截面。
4 结论
本文利用TCAD器件/混合模式仿真了Buffer电路单元的重离子单粒子效应,仿真结果表明:上拉补偿管的尺寸增大,瞬态电流脉冲的峰值增大而脉宽减小;入射角增大会导致有效LET值的改变,并使粒子在覆盖层中的穿透路径也同样以余弦定律变长;提高外延衬底浓度可以在一定程度上提高器件的抗单粒子能力。最后将三维数值模拟计算得到的结果与辐照实验结果对比,表明了采用三维数值模拟可以准确预测器件的抗单粒子翻转能力,能够为深亚微米器件甚至纳米器件的抗辐照设计和加固提供理论依据和数据支持。
参考文献:
[1]Steven M.Picosecond Lasers for Single-Event Effects Testing.Aerospace[EB/OL][2006-04-03].http://www.aero.org/publications/crosslink/summer2003/04.html.
[2]Jones R.ESA Laser SEE Studies[EB/OL].2001-01.
[3]Inguimbert C,Duzellier S,Ecoffet R,et al.IEEE Trans Nucl Sci,2000,47(3):551-558.
[4]Black J D,Allen M L,et al.Multiple-bit Upset in 130 nm CMOS Technology[J].IEEE Transactions on Nuclear Science,2005,52(6):2536-2541.
[5]Amusan O A,Witulski A F,Massengill L W,et al.Charge Collection and Charge Sharing in a 130 nm CMOS Technology[J].Nuclear Science,IEEE Transactions on,2006,53(6):3253-3258.
[6]Buchner S P,Baze M P.Single-Event Transients in Fast Electronic Circuits[C]//IEEE NSREC Short Course.2001:50.
[7]赖祖武.抗辐射电子学-辐射效应及其加固原理[M].工业出版社,1998:12-15.
[8]曹建中.半导体材料的辐射效应[M].科学出版社,1993:21-25.
[9]贺朝会,李永宏,杨海亮.单粒子效应辐射模拟实验研究进展[J].核技术,2007,30(4):347-351.
[10]侯明东,甄红楼,张庆祥,等.重离子在半导体器件中引起的单粒子效应[J].原子核物理评论,2000,17(3):165-170.

杜明(1973-),男,湖南省岳阳市人,学士,高级工程师。研究方向为集成电路可靠性设计和物理实现,duming@ssmec.com;

邹黎(1986-),女,江西省赣州市人,硕士,工程师。研究方向为超大规模集成电路设计(VLSI设计),zouli@ssmec.com。
AnalysisofSingleEventEffectonBufferCELLBasedonTCADSimulation
DUMing,ZOULi*,LIXiaohui,QIUHenggong,DENGYuliang
(Shenzhen State Microelectronics Co.,Ltd,Shenzhen Guangdong 518057,China)
Abstract:For semiconductor devices and ICs,the essence of radiation effect is a series of physical process including the generation and recombination of electron-hole pairs,the transmission and collection of charge,the interface state and accumulation of oxide trapped charge.Several factors might affect the physical process,such as the size of the pull-up compensating MOSFET,the incidence angle of the heavy ion,the substrate concentration of the device.This paper simulates how these key variables influence on the single event effect of the Buffer cell using mixed-mode TCAD simulations.Finally the experiment result approach to the real scene.
Key words:mixed-mode;TCAD;Buffer;single event effect;pull-up compensating
doi:EEACC:059010.3969/j.issn.1005-9490.2014.05.002
中图分类号:O472.8
文献标识码:A
文章编号:1005-9490(2014)05-0808-04
收稿日期:2013-10-23修改日期:2013-12-05
