图解电镀铜填孔机理
2011-07-31杨智勤张曦陆然韩卓江
杨智勤 张曦 陆然 韩卓江
(无锡赫普轻工设备技术有限公司,江苏 无锡 214125)
1 前言
近年来,电子产品追求轻薄短小的目标,上游IC元件日趋微小化,在有限的表面上,装载更多的微型器件促使印制电路板的设计趋向高精度、高密度、小孔径方面发展,传统的过孔与导通孔互联的多层PCB板逐渐已不能满足产品需求。同时半导体行业的元件垂直整合、直接连通,尽量减少透过电路板或封装基板来做电讯互通,这些高密度的互联技术,从上游的半导体制程到中游的封装载板制程,一直到下游的电路板制程,都需要电镀铜填孔技术,为了适应印制电路板的发展,盲孔的电镀铜填孔工艺得到了广泛研究[1]。
本文主要从电镀铜填孔过程监控切片图分析其机理模型,以期加深广大业者对电镀铜填孔机理的认识。
2 电镀铜填孔机理
2.1 CEAC电镀铜填孔机理
盲孔电镀铜填孔的技术,首次由IBM应用于双镶嵌制程技术,利用电镀铜完成IC晶片的内连接导线制作。IBM公司提出IC上的盲孔电镀铜填孔机理,认为之所以出现电镀时产生“孔底上移”现象的原因,是因为添加剂的吸附、消耗和扩散的作用,电镀铜添加剂抑制了铜离子的电化学沉积,当其吸附在阴极上会阻碍铜离子的镀析。同时,添加剂本身会被阴极电位裂解,所以沿着孔口到孔底,存在添加剂的浓度差,孔底位置,添加剂浓度低,因此铜沉积的速率沿着孔口到孔底越来越快,产生“孔底上移”的作用,图1是盲孔电镀铜填孔的切片图,由图1可知,盲孔基本被铜填充,实现了盲孔的电镀铜填孔。

图1 盲孔电镀铜填孔示意图
随着对填孔机理的不断研究,Moffat等[2]提出了“曲率提升加速剂覆盖率”(Curvature Enhanced Accelerator Coverage,CEAC)机理来解释盲孔电镀铜填孔作用机理,此机理模型后来又修正为“曲率提升吸附物覆盖率”机理模型,这种模型机理是主要基于试验和仿真模拟,在非平坦表面添加剂吸附率的差异,孔壁侧向铜离子镀析速率不同,孔底面积几何内缩,改变了盲孔的几何外型,在此过程中电解质变得不重要,盲孔的几何外型发挥重要作用,随着整平剂的吸附钝化了光亮剂的作用,CEAC机理预测了盲孔电镀铜填孔过程中盲孔几何外型的改变趋势和填孔电镀的Bottom-up机理,这种模型解释了一定条件下的Super-Filling原理。因为盲孔电镀铜填孔添加剂中,不只有光亮剂会吸附、整平剂和载运剂也有可能。CEAC机理模型解释超级等角沉积(Superconformal Electro Deposition)电镀铜填孔机理,能够预测盲孔电镀铜填孔过程中会产生“裂缝”和“空洞”缺陷,图2和图3是两种缺陷的实际盲孔电镀铜填孔过程监控切片图,两种缺陷在盲孔AR值偏小和盲孔孔型不佳的情况下,发生几率将倍增,也验证了盲孔电镀铜填孔CEAC机理的合理性。

图2 填孔“裂缝”缺陷

图3 填孔“空洞”缺陷
另外,通过盲孔电镀铜填孔不同阶段的切片图,可以更加清晰了解到CEAC机理模型的原理,图4和图5分别是电镀时间为14 min和28 min时的电镀铜填孔的图片,由图可知,随着铜离子的电化学沉积过程的持续进行,盲孔孔底面积几何内缩,“孔底上升”趋势明显;图6是盲孔电镀铜填孔过程中,人为设置断电流后的切片图片,实际整个电镀过程被人为的分为两个阶段,图中的微蚀分界线是电镀过程中两个阶段的外在体现,由图可知,盲孔电镀铜填孔的初始阶段,盲孔孔底面积几何内缩,盲孔几何外型发生改变,证实了CEAC机理的合理性。

图4 14min填孔切片图

图5 28min填孔切片图

图6 填孔断电流切片图
2.2 CDA电镀铜填孔机理
Dow[3]等研究了对流强弱对与盲孔电镀铜填孔的影响,提出了“对流有关性吸附”(Convection Dependent Adsorption,CDA)机理,解释了“孔底上移”的原因,此机理模型理论与CEAC机理模型类似,但不依赖盲孔孔底面积内缩,主要原理是盲孔孔底Cu+与光亮剂中S元素形成配合物,光亮剂富集在孔底,内层和外层的沉积速率不同,孔底铜的高速率沉积实现Bottom-up机理。Dow研究了对流强弱对与盲孔电镀铜填孔影响,对流越强,铜离子反而不利于沉积,相反,对流较弱,铜离子电化学沉积容易析出。CDA机理模型说明无论电镀配方中是否具有光亮剂,孔底表面曲率是否改变,或有无添加剂都无太大影响。为了验证此机理模型的合理性,Dow设计了试验证实盲孔的“孔底上移”行为与孔底的几何面积内缩无关,而与对流的强弱有关,试验设计盲孔的侧壁无导通铜层,板面与孔底导通,详见图7。因此在电镀时,绝对不会发生孔底面积几何内缩,电镀时铜离子必须从孔口扩散至孔底,铜离子电化学沉积过程中,应当首先选择在板面上的铜层析出,然后才会扩散至孔底铜层析出,电镀时若提供不同强度的对流,板面位置和孔底位置的铜层厚度将不一致,对流强时,孔底铜的电化学沉积速率大于板面的铜的电化学沉积速率,孔底位置铜厚度大于板面铜厚度,反之亦然。
图8所示现象即为CDA模型的现实表现,在加工过程中,盲孔闪镀铜层异常,盲孔电镀铜填孔后发现,盲孔无法实现填孔,孔内具有明显的孔底铜和板面铜的微蚀分界线,盲孔在孔壁铜缺失的情况下,“孔底上移”现象依然可见,电化学沉积铜的过程中,电镀铜层的生长主要符合CDA机理模型,与孔底表面曲率上升,孔底几何面积内缩无关。

图7 Dow试验模型图
2.3 孔壁完整性对电镀铜填孔的影响
以上论述可知,CEAC和CDA机理模型能够解释电镀铜填孔机理,并可从实际的电镀过程中得到证实,笔者在负责电镀铜填孔工艺时,发现一个现象确难以用以上理论进行解释,盲孔在孔壁铜存在异常时,无法发生“孔底上移”现象。因此设计沉铜板件,浸水后过酸洗烘干,改变孔壁沉铜层的致密性,电镀铜填孔后如图9中所示,盲孔孔底面积几何开始内缩,在弱对流下,板面铜厚度大于孔底铜厚度,说明了在电镀铜填孔过程中,CEAC和CDA机理都存在,而实际盲孔确无法实现电镀铜填孔,“孔底上移”现象。基于此现象可以推断,孔壁铜质量对电镀铜填孔作用非常显著,可以看出孔壁完整性是电镀铜填孔的基础条件,当盲孔孔壁不完整时,CEAC机理模型无法实现,这可能是因为孔壁铜的不完整时,氯离子在孔壁的吸附性差,而电镀铜填孔过程中氯离子的作用显著,其主要与光亮剂、载运剂形成复合物,只有在氯离子的作用下,光亮剂和载运剂的脱吸附动力学才能实现,因为PEG、SPS或MPS的吸附需要大量的氯离子,孔壁铜的不完整性,影响了氯离子在铜层表面的吸附作用,也影响了电镀铜填孔机理的产生,产生了如图9所示的电镀铜填孔表现,由此说明,孔壁铜完整对电镀铜填孔影响重大,只有在孔壁铜完整的条件下,CEAC电镀铜填孔才能实现。
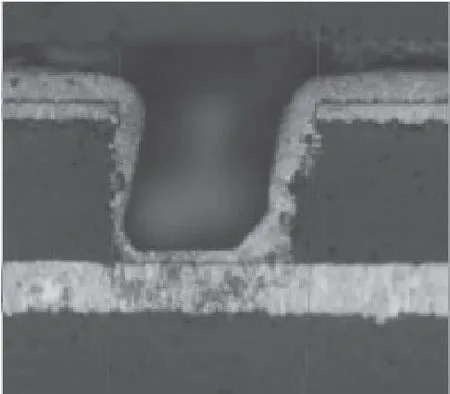
图9 电镀铜填孔图
3 总结
在电镀铜填孔机理未提出之前,往往将填孔机制理解成抑制剂吸附于板面,光亮剂吸附于孔底,不同有机添加剂的选择性吸附,铜离子的电化学沉积是从底部缓慢的逐渐上移,实现激光盲孔的电镀铜填孔,而CEAC和CDA机理的提出,打破了我们对电镀铜填孔的认识,盲孔的电镀铜填孔并非简单的孔底铜上移,而是遵循一定的机理模型;另外,通过实际的盲孔过程监控切片图发现,电镀铜填孔的完美实现,是基于孔壁铜完整性的前提,只有保持孔壁铜的完整,电镀铜填孔机理才能发生。
[1]Ryszard Kisiel, Jan Felba, Janusz Borecki,et al.Problems of PCB microvias fi lling by conductive paste,Microelectronics Reliability, 2007(47):335–341.
[2]T.P.Moffat , D.Wheeler, S.-K.Kim, et al.Curvature enhanced adsorbate coverage mechanism for bottomup superfilling and bump control in damascene processing, Electrochimica Acta, 2007(53):145–154.
[3]Wei-Ping Dowa,Ming-Yao Yena,Sian-Zong,et al.Filling mechanism in microvia metallization by copper electroplating,Electrochimica Acta,2008(53):8228–8237.
