化学机械抛光(CMP)过程中抛光盘温度控制的分析研究
2011-03-23孙振杰费玖海
孙振杰,刘 涛,费玖海
(中国电子科技集团公司第四十五研究所,北京 101601)
在化学机械抛光过程中,温度的变化对化学机械抛光的工艺性有显著的影响,因此晶片在抛光过程中实施温度控制是非常必要的,因此建立一种行之有效的抛光温度控制方法,是CMP工艺研究的一个重要方面。
1 化学机械抛光的加工机理
如图1所示,在化学机械抛光过程中,晶片粘贴在抛光头(承载器)的下表面,抛光头与抛光盘各自以一定的速度旋转,在抛光压力的作用下,晶片、抛光液和抛光垫彼此接触,抛光过程中,由于机械摩擦的去除作用而产生大量的热量,热量的积累导致抛光盘表面温度上升。
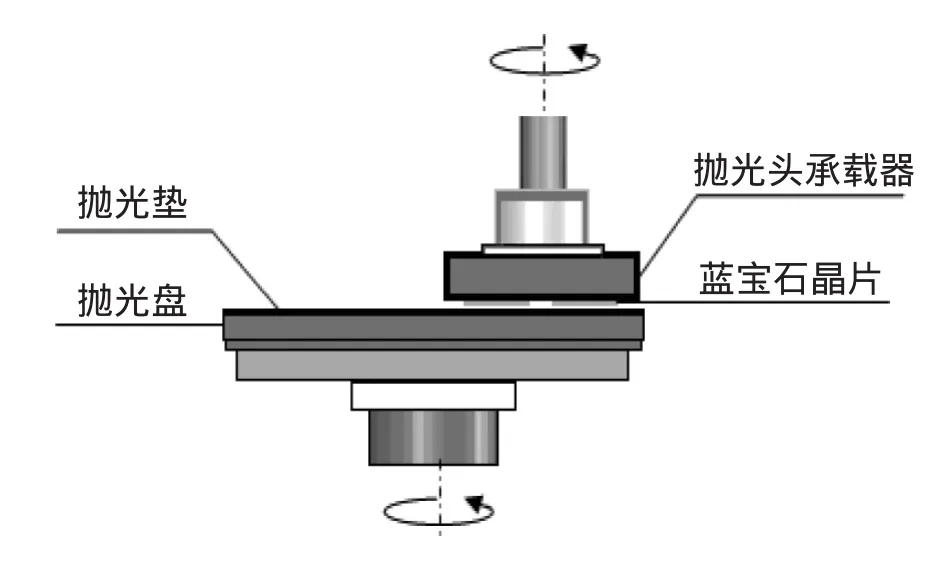
图1 蓝宝石抛光示意图
2 温度对抛光效果的影响分析
在化学机械抛光过程中,温度对抛光效果的影响有以下几个方面,一是使得抛光垫发生局部热变形,改变了其弹性和全局平整度,从而改变了晶片表面压力分布的均匀性,使得抛光过程中材料去除率一致性变差,最终导致抛光后晶片翘曲度、弯曲度指标降低,影响抛光效果;二是温度过高使得粘接晶片的石蜡软化,粘接力减小,出现晶片脱落和碎片现象;三是影响了抛光液与晶片之间的化学反应。
以蓝宝石晶片(单晶Al2O3)抛光为例,抛光过程中,材料首先与化学抛光液中的碱性物质发生化学反应:

上述化学反应本身是一个放热过程,化学反应产生的热量,在一定程度上能够促进和加快反应速度,从而加大材料的去除率,提高生产效率。但是,随着热量积累,过高的温度有可能改变抛光液的化学组成,改变抛光液的pH值,降低反应速度,同时,温度过高也会促使抛光液中纳米粒子表面活性剂的分解脱离,从而导致晶片表面出现划痕。因此在抛光过程中温度必须在合适的范围内,才能满足蓝宝石晶片的平整化要求。大量的抛光工艺实验证明,蓝宝石晶片的抛光温度的最佳控制范围应该在35℃~40℃。
通过实验得到温度对晶片粘接力的影响如图2所示。

图2 温度对晶片粘接力
通过实验得到温度变化时抛光液pH值对抛光速率的影响如图3所示
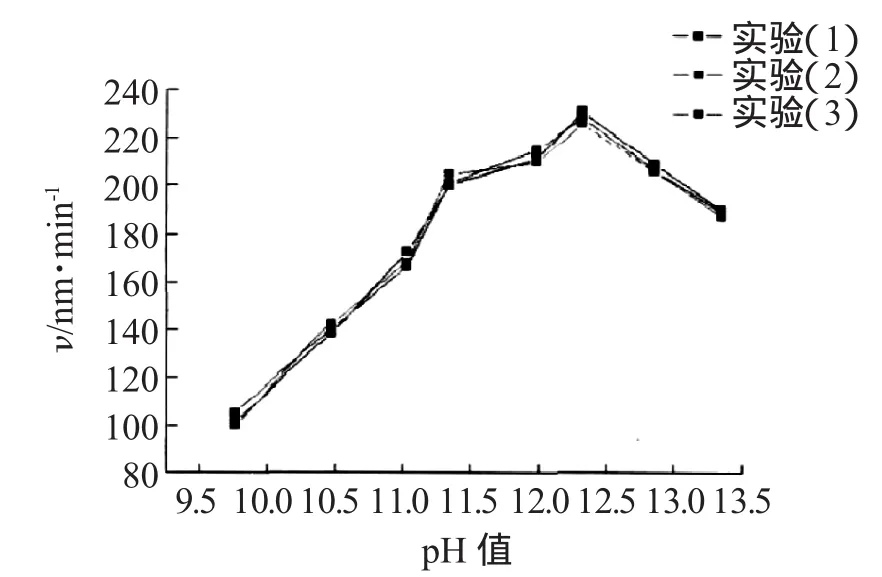
图3 抛光液pH值对抛光速率的影响曲线
通过实验得到温度对抛光速率的影响曲线如图4所示。

图4 温度对抛光速率的影响曲线
实验曲线表明,当温度低于25℃时,晶片的粘接力较大,但是抛光速率较低,随着温度的上升速率增加很快,当温度高于40℃后,晶片的粘接力下降,抛光速率增长缓慢。
3 温度控制系统的设计
为了获得理想的抛光去除率和抛光效果,在化学机械抛光过程中通常采用一定的技术措施进行温度控制,一种简单而有效的方法就是采用抛光盘水冷却的方式进行抛光温度控制。
由图1可知,抛光垫粘附于抛光盘表面,抛光过程中摩擦产生的热量将通过抛光垫直接传递给抛光盘,导致抛光盘表面温度升高,在抛光盘的内部设计一种循环通道,采用冷却水在抛光盘内部循环流动的方法将抛光盘本身的热量带走,从而使抛光盘表面温度降低,通过控制冷却循环水的流量和循环时间,使整个系统的热交换达到一种相对平衡状态,使抛光盘表面温度保持在一定范围内,最终实现抛光过程中的温度控制。
图5为采用冷却水循环的方法进行温度控制的抛光盘内部结构图,由图可以看出,抛光盘内部水槽成蝶形,使得抛光过程中,主要工作区域的热交换更趋向于均匀,有效避免了抛光盘局部温度不一致的情况。

图5 抛光盘结构图
图6为温度控制原理示意图,系统的工作原理是:置于抛光盘上方的温度传感器检测到抛光盘温度达到设定值时,通过PLC控制启动水泵,从而把水箱中的冷却水输送到蝶形水道,经过循环后流回水箱。经过多次水的循环后,水箱中的水温度改变,此时置于水中的温度传感器检测达到设定值后,由进出水电磁阀和浮球液位开关共同控制水箱中的水能够及时更换。
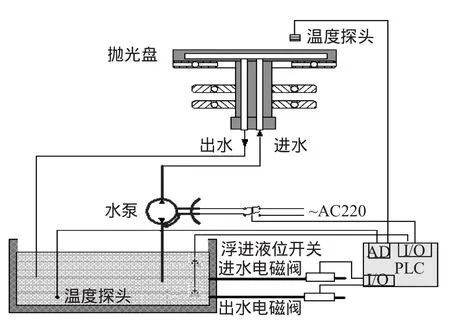
图6 温度控制原理图
通过上述控制原理完成的温度控制系统,在蓝宝石晶片抛光实验中进行了验证,对抛光温度控制的效果非常明显,达到了设计要求。
4 蓝宝石抛光温度控制分析研究
前面已经介绍过,在化学机械抛光过程中,温度控制的必要性以及温度控制的最佳范围。但是,不同的环境温度对抛光温度控制系统的要求也不同,不同室温下,温度控制情况也有差别,下面通过实验进行说明。
4.1 室温18℃时的抛光实验
实验过程中,为了研究室温对抛光温度的影响,我们分别采用不同的抛光参数组合进行抛光实验,实验结果数据显示,在室温18℃情况下,无论哪种抛光参数组合对应的抛光温度基本上相同,如下表1所示。

表1 相同室温(18℃)下不同抛光参数对应抛光垫温度
上述抛光实验过程中由于环境温度较低,为了验证环境温度对抛光温度的影响,抛光过程中未使用温度控制系统,要将抛光温度控制在35~38℃最佳的范围内达到最佳抛光效果,温度控制系统则需要对循环水进行加热,以提高抛光垫表面的温度。
4.2 室温25℃时的抛光实验
在室温为25℃时,无论上述哪种参数组合,如果不使用温度控制系统,都会造成抛光垫温度过高,因此为了满足抛光工艺要求,应该使用温度控制系统采用冷却水循环,以降低抛光垫表面的温度。以下折线图说明了在室温25℃,温度控制系统循环水温度在23℃以下时,不同抛光参数对应的抛光垫温度变化曲线。
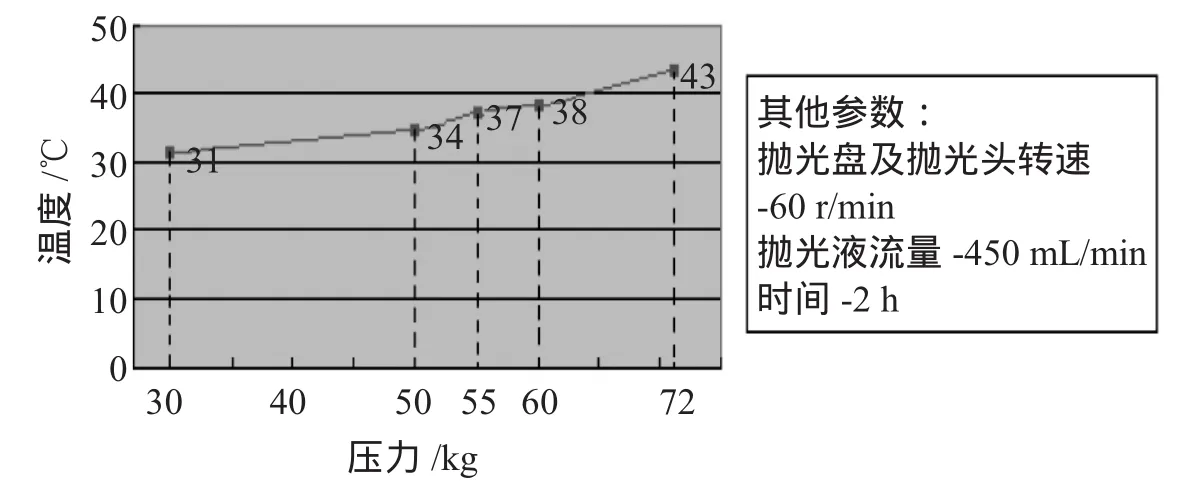
图7 压力与抛光垫温度的关系
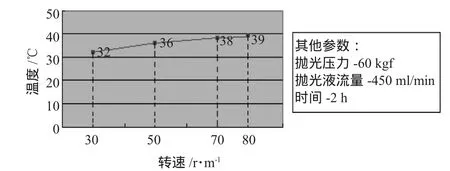
图8 转速与抛光垫温度的关系
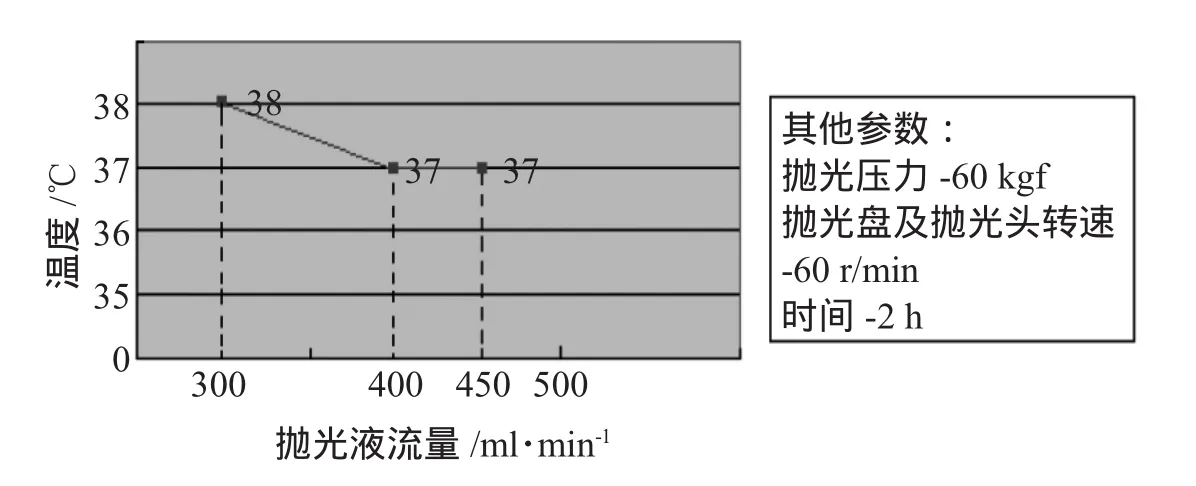
图9 抛光液流量与抛光垫温度的关系
由图7、图8和图9可知,在严格控制循环水的温度下,不论哪种抛光参数,抛光垫的温度都基本控制在40℃之下,满足化学机械抛光的要求。
通过上述两组实验可知,在抛光过程中温度的控制是必要的,而且不同环境温度对温度控制的要求也不同。在实际的抛光过程中,一般抛光过程都是在室温一定的净化间内进行,因此抛光时只需考虑一种情况即可。
室温25℃时,在未使用温度控制系统进行抛光实验,结果发现在抛光1 h左右,抛光垫温度高达55℃,此时出现晶片脱落现象,使得实验无法继续进行。实验再次证明了在抛光过程中,使用温度控制系统的必要性。
5 结束语
影响抛光去除率和表面平坦化的因素有很多,通过实验,我们知道对温度进行控制是非常重要的,经过以上的研究分析,我们得到了一种切实可行的方法,完善了抛光中平坦化加工工艺方案,最终实现了均匀的抛光去除率。
[1]赵之雯,牛新环,檀柏梅,袁育杰,刘玉岭.蓝宝石衬底材料CMP抛光工艺研究[J].微纳电子技术2006(1):19.
[2]王娟,檀柏梅,赵之雯,李薇薇,周建伟.蓝宝石衬底片的抛光研究[J].电子工艺技术2005,26(4):229.
[3]H.L.Zhu,L.A.Tessaroto,R.Sabia.Chemical mechanical polishing(CMP)anisotropy in sapphire[J].Applied Surface Science,2004,236(1-4):120-130.
