样品温度对CF3+与Si表面相互作用影响的分子动力学模拟*
2010-09-08宁建平吕晓丹赵成利秦尤敏贺平逆ABogaerts苟富君
宁建平吕晓丹赵成利秦尤敏贺平逆A.Bogaerts苟富君
1)(贵州大学等离子体与材料表面作用研究所,贵阳550025)
2)(贵州大学材料科学与冶金工程学院,贵阳550003)
3)(比利时安特卫普大学化学系PLASMANT课题组,比利时B-2610)
4)(四川大学辐射物理及技术教育部重点实验室,成都610064)
5)(荷兰皇家科学院等离子体所,荷兰2300)
(2009年6月11日收到;2010年2月3日收到修改稿)
样品温度对CF3+与Si表面相互作用影响的分子动力学模拟*
宁建平1)2)吕晓丹1)赵成利1)秦尤敏1)2)贺平逆1)A.Bogaerts3)苟富君4)5)†
1)(贵州大学等离子体与材料表面作用研究所,贵阳550025)
2)(贵州大学材料科学与冶金工程学院,贵阳550003)
3)(比利时安特卫普大学化学系PLASMANT课题组,比利时B-2610)
4)(四川大学辐射物理及技术教育部重点实验室,成都610064)
5)(荷兰皇家科学院等离子体所,荷兰2300)
(2009年6月11日收到;2010年2月3日收到修改稿)
利用分子动力学模拟方法研究了不同温度下CFx层对CF3+刻蚀Si表面过程的影响.由模拟数据可知,温度对C和F的沉积有显著的影响;通过提高样品的温度,物理刻蚀得到了加强,而化学刻蚀被减弱.同时,随着温度的升高,Si的刻蚀率相应增加.刻蚀产物中的SiF,SiF2的量随温度的增加而增加,SiF3的量与基体温度没有直接的关系.Si刻蚀率的增加主要是通过提高SiF,SiF2从表面脱离的量得以实现的.通过比较发现CF3+在Si表面的沉积对后续的刻蚀过程产生了巨大的影响,具体表现为大大增加了Si的刻蚀率,减弱了Si的化学刻蚀机理.
分子动力学,等离子体,刻蚀,样品温度
PACC:6120J,7920
1. 引言
近年来,等离子体刻蚀被广泛地应用于微电子领域[1—3].但因等离子体与材料表面作用的复杂性以及实验条件(许多表面分析工具如低能量电子衍射(LEED)、X射线光电子能谱(XPS)等都要求在超高真空下工作)和等离子体环境(如等离子体源中等离子体与样品表面的高度耦合)的限制[4],很难全面了解刻蚀的微观机理.分子动力学(MD)模拟方法因其突破了上述限制,能观测到原子级别的微观动力学数据并能实现原位和实时分析,而被广泛应用到研究等离子体与表面相互作用的领域,并取得了和实验相符合的结果[5,6].Gou等[7]对CF与Si (100)-2×1表面的作用进行了模拟(垂直入射,室温,入射能量分别为2,12和50 eV),模拟结果表明,随着CF与Si表面发生相互作用,表面将形成SixCyFz反应层,但观察不到刻蚀现象.反应层的厚度随入射能量的增加而增加.当入射能量为50 eV时在反应层中有SiC和SiFx(x=1—3)生成,这与实验观察结果是相符合的.同时他们利用Humbird等优化了的Tersoff-Brenner(TB)函数模拟了CF+3对单晶硅Si(100)-2×1的刻蚀[8].模拟结果表明,随着入射能量的增加,C在表面的吸附量增大,并且Si的刻蚀量也相应地增加;表层Si—C键的密度并不随着Si的刻蚀而降低.产生的刻蚀产物以SiF为主.本课题组对室温下F2在垂直入射条件下与Si (100)-2×1表面相互作用进行了MD模拟研究[9].模拟结果发现Si的刻蚀量随着能量的增加而增加;稳定态时会形成SiFx反应层,其厚度同样随着能量的增加而增加.
对于含F等离子体刻蚀Si表面而言,基底温度在实验中是一个很容易控制并起到重要作用的参数.Gou等[10]采用MD模拟研究了基底温度对刻蚀的影响.他们用能量为100 eV的CF+3去轰击温度分别为100,300,600和800K的Si(100)-2×1表面.实验和模拟结果都表明,CF3+对Si的刻蚀是通过在样品表面发生沉积生成一层CFx反应层实现的[11,12].但是不同温度的反应层会对后续的刻蚀产生怎样的作用还不清楚.因此在本文中,我们将采用与Gou等相同的模拟条件,研究在不同的衬底温度下该CFx反应层对CF3+刻蚀Si表面的影响.
2. 模型和模拟方法
2.1. 势能函数
分子动力学模拟最早由Alder等[13]于1957年应用于气体和液体状态方程的研究.随着计算机的发展该方法已经被越来越多的学者用于研究固体中原子碰撞中的众多问题,如缺陷的形成、溅射机理的研究、表面重构和界面混合等新的领域[14—16].在经典的分子动力学模拟中,粒子的运动完全服从牛顿运动方程,不考虑量子效应.粒子间的相互作用力通过对势能函数求导获得.因此,分子动力学的核心是选择适当的势能函数.对于Si—C—F系统来说,目前大量使用的势函数有两种.其一是由Stillinger和Weber[17]建立的Stillinger-Weber(SW)势能函数,这种势函数考虑了键长、键角、周围原子的种类和数量等的影响;其二是由Abrams和Graves建立的TB势函数[18].在本次模拟中我们所采用的为TB势能函数,具体的函数形式如下:


其中VR(rij)描述的是原子间核与核的排斥能,VA(rij)描述的是吸引能,而bij则是一个多体的经验键序函数,下面将进一步详细介绍.

其中fij(rij)为截断函数,采用其目的是减少计算量;rij为i,j原子之间的距离;Aij,λij为与i,j原子有关的常数.如表1所示.

同样fij(rij)为截断函数,rij为i,j原子间的距离. Bij,μij是与i,j原子有关的常数.如表1所示.
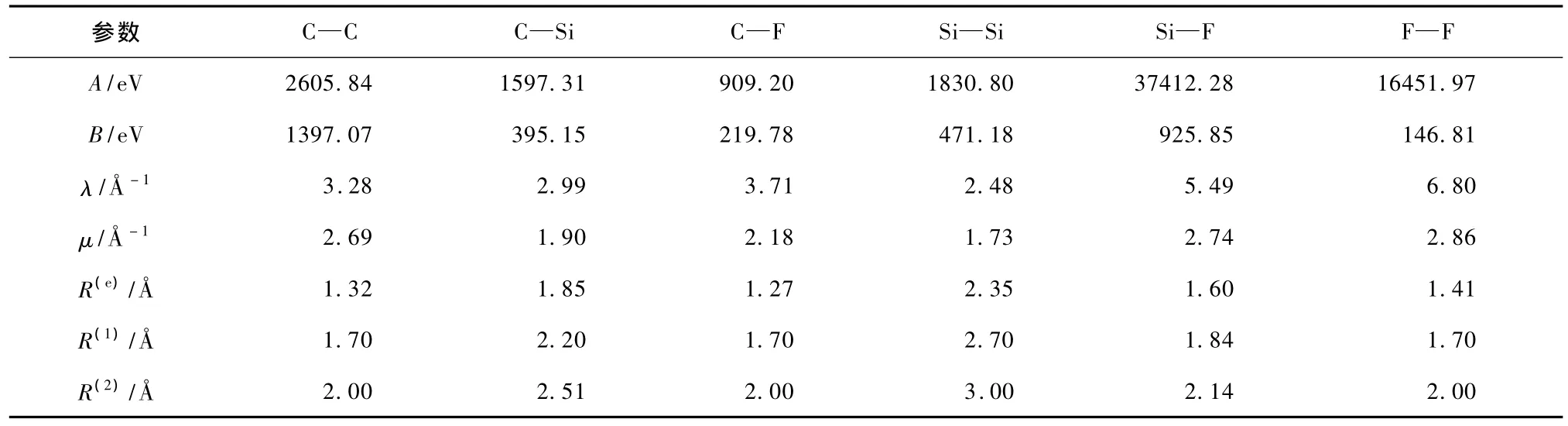
表1 TB函数所用相关参数[18]


bij描述的是i原子周围其他原子的种类、数量、键角等i—j键所产生的影响,其中ζij为“成键竞争”函数;Hij也为一修正函数,属样条插值函数,用于描述当i原子为C原子时,C,Si,F原子与其结合生成不同物质而对i—j键造成的影响.

其中α,β,δ,η为经验参数,具体如表2所示.θijk表示的i—j键与i—k键的夹角.

其中N(F)ij,N(C)ij及N(Si)ij分别表述的是i原子周围最近邻的F,C,Si的原子数量.

表2 TB函数中的相关参数[18]
2.2. 模拟方法及条件
在本文中,我们所用的程序中采用Verlet算法[19]求解Newton运动方程,采用Berendsen温度控制机理[20]确保刻蚀过程中样品温度的恒定.入射CF3+的初始位置在x,y方向上根据系统随机设定,入射离子与样品原子间没有相互作用,但需确保入射离子不与样品边界原子发生作用.入射方向垂直于样品表面.在这里需特别强调一下,在实际中,离子在距样品表面几个埃的位置(还没有通过势函数发生相互作用)会由Auger效应导致二次电子的发射而使得入射离子被中和[21],所以在我们的模拟中最终与Si表面作用的是中性粒子CF3.未轰击前Si样品的表面面积为466.562,样品的高度为43.2.在x和y方向上采取周期性边界条件,样品最下面的四层原子的位置固定.所选取的时间步长为0.001 ps,热浴上升时间为0.01 ps.不同温度下CF3+的入射能量均为100 eV.为模拟实际刻蚀过程中形成的反应层,先用1.5 ML的CF3+将Si(100)-2×1表面轰击得到反应非晶层,该样品即为本次模拟所用的样品.对Si的刻蚀量、入射离子的量以及溅射产物的量的衡量采用单位“ML”.它是与样品尺寸大小有关的量,在本文中1 ML相当于50个CF3+.
3. 结果与分析
在保证其他参数(如样品尺寸、时间步长、单个轨迹的时间)完全一致的基础上,我们用能量为100 eV的CF+3去轰击温度分别为100,300,600和800K的已经沉积了CFx层的Si(100)表面,对模拟数据进行分析来研究在不同样品温度时已沉积的CFx层对刻蚀的影响.
图1(a),1(b)分别描述了样品表面C,F的沉积量与温度的关系.由图1(a)可以看出,C在样品表面的沉积量与温度的高低有明显的关系.在最初阶段,温度对C的沉积量的影响并不显著,随着入射离子量的增加,温度的影响越发明显.由图1(a)可知,当入射离子的量达到约6.5 ML时,温度为100K的样品表面C的沉积量最大,而到16 ML时温度为800K的样品表面C的沉积量又为最大值.由图1(b)可知,样品表面F的沉积量随温度的变化并不是很明显.当入射离子的量小于4 ML时,温度为300K的样品表面F的沉积量比其他温度的要大.图1(c)显示的是样品温度与Si的刻蚀量的关系.可以看出,随着样品温度的升高,刻蚀量逐渐增加.通过计算,在100,300,600,800K达到稳定态时的刻蚀率分别为0.52,0.75,0.86,0.94.与文献[10]相比之后可发现,由于CFx层的形成,使得相同温度条件下的Si的刻蚀率大大加强.
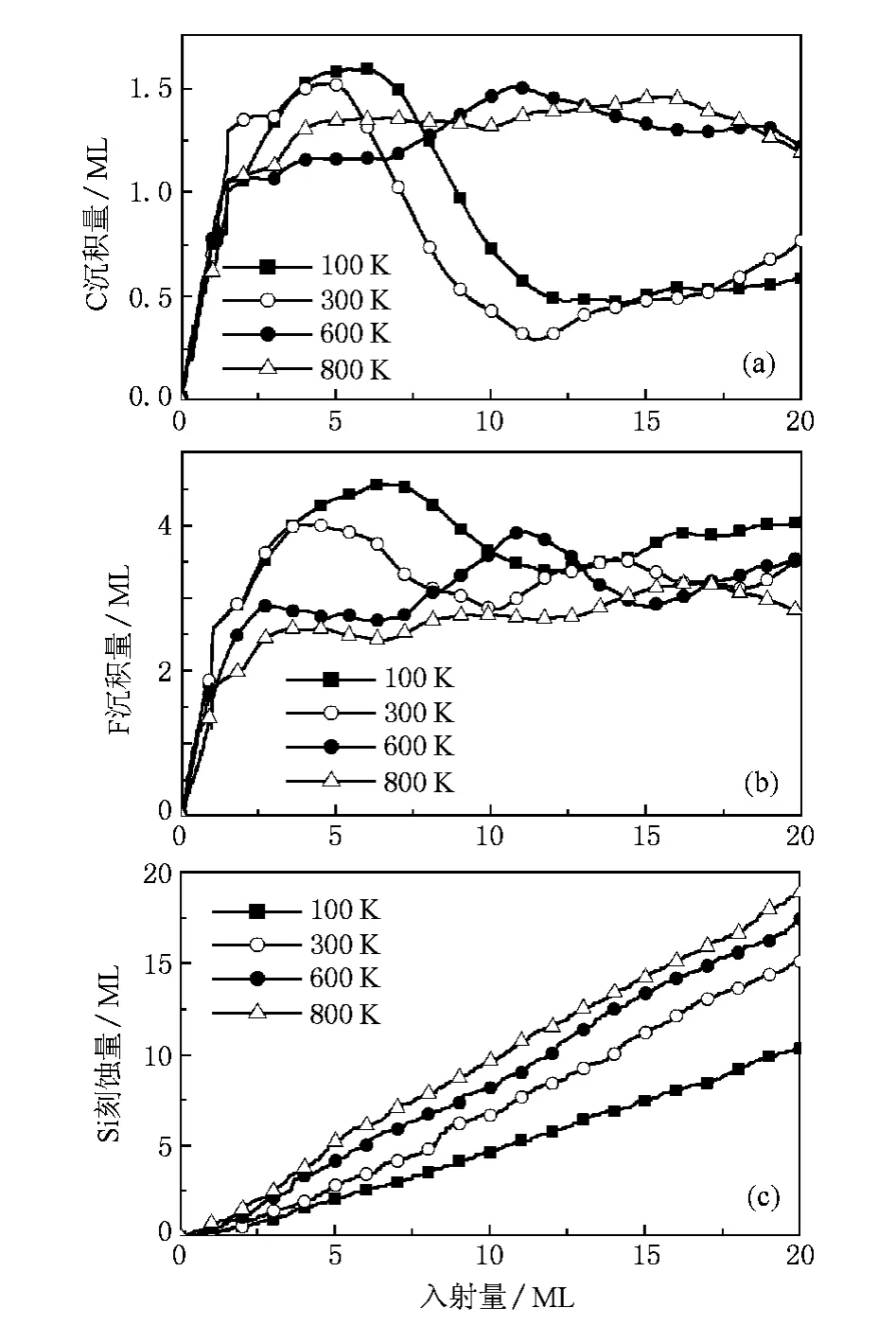
图1 沉积量和刻蚀量与入射离子的量的关系(a)C的沉积量,(b)F的沉积量,(c)Si的刻蚀量
我们用20 ML,100 eV的CF3+在300和800K时轰击Si,得到了样品深度与原子密度间的关系,如图2所示.与300K相比,800K时在样品中形成的反应层的厚度更宽,在反应层范围内C,F原子的分布也更为广泛.同时,800K时F的密度和C的密度峰值比300K时略有下降.比较图2(a)和2(b)还可以发现,300K时样品表面出现了富F的反应层,在800K时并未产生该现象.而在文献[10]中,当CF3+直接与Si表面作用时,在300和800K时样品表面均出现了富F层.
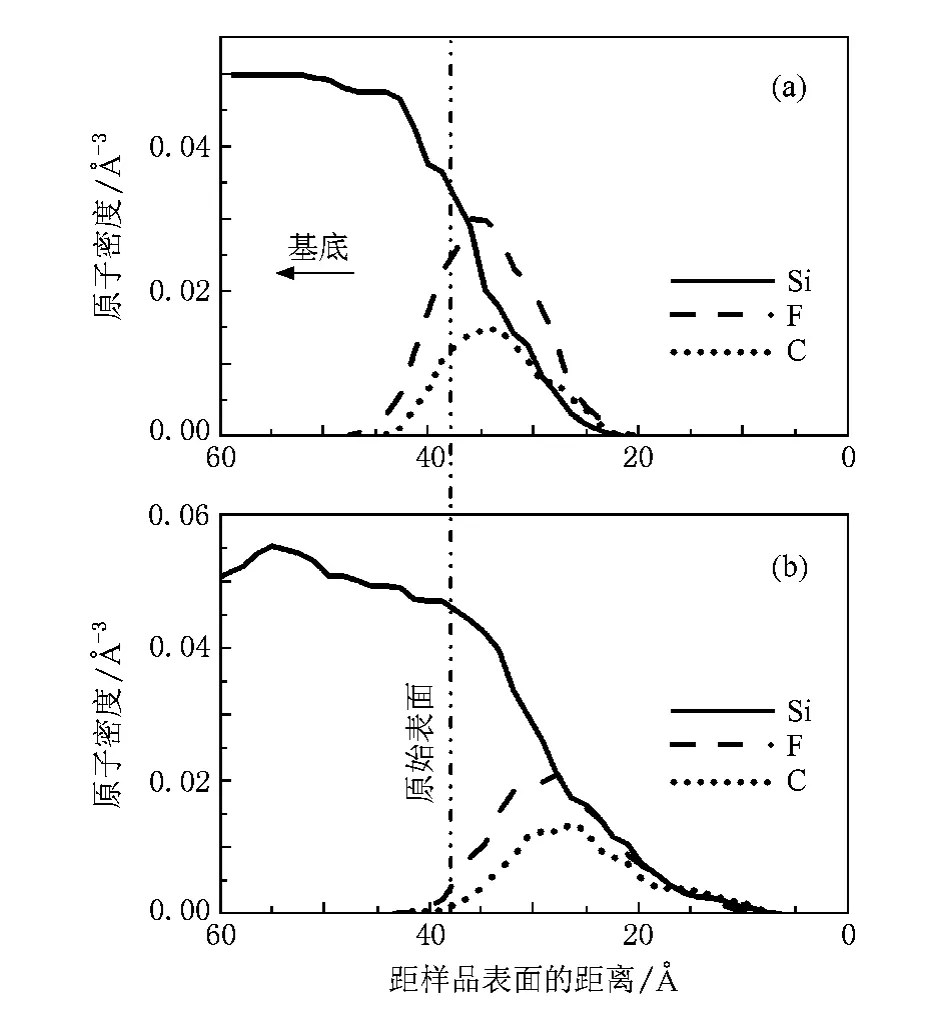
图2 原子密度与样品深度的关系(a)300K,(b)800K
图3表示的是12 ML的CF3+在不同的样品温度下(300和600K)与Si表面作用后的样品示意图.由图3可知,C和F原子不仅沉积在样品表面,而且还发生了离子注入.比较图3(a)和3(b)可以发现,相比300K来说,600K时Si原子的刻蚀量要大一些,这与图1(c)所示信息相符.同时,600K时形成的反应层更宽,Si表面的非晶化程度更大.由图3我们还可以发现600K时样品表面的粗糙度更大.
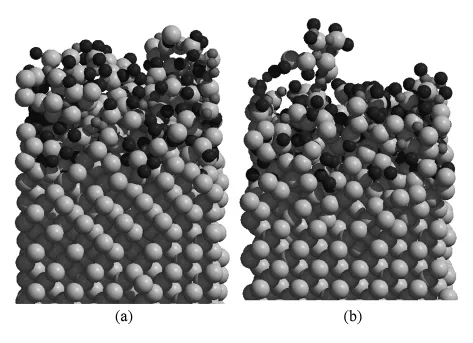
图3 轰击后样品Si的示意图(a)300K,(b)600K
图4描述的是Si的刻蚀产物的量与样品温度的关系.由图4可知,随着样品温度的升高,刻蚀产物SiF和SiF2的量逐渐增加,刻蚀产物SiF4的量逐渐减小.而SiF3的量受样品温度的影响较小,基本上没有太大的变化.在温度为100K时,SiF3的量比其他产物的量要大,其中SiF的量是四者中最少的.随着表面温度的升高,SiF2成为主要的刻蚀产物.在800K时,SiF的量与SiF3的量接近,SiF2的量比二者的两倍还要多.当CF3+直接与Si表面作用时[10],SiF的量非常少,而SiF4的量对温度并不十分敏感.
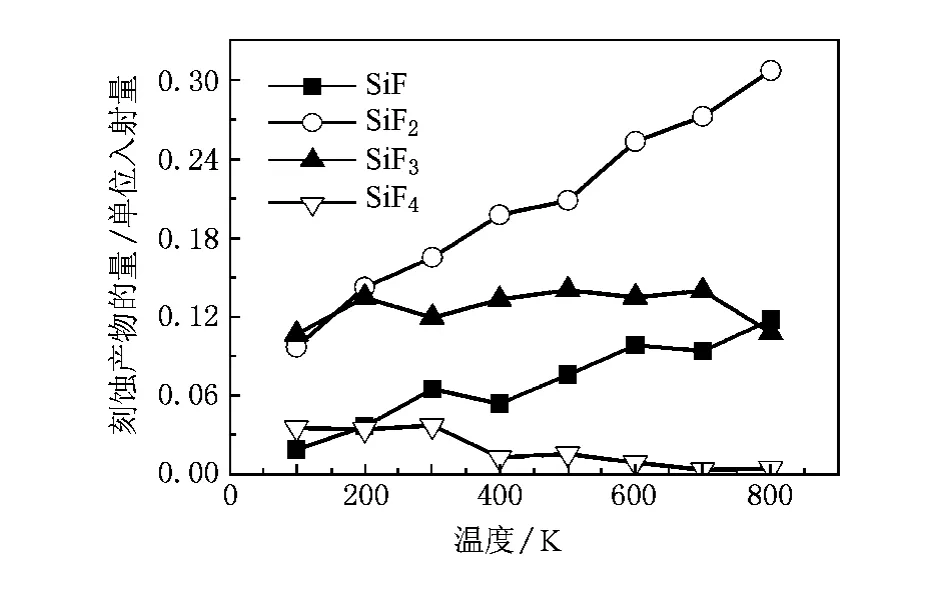
图4 Si的刻蚀产物与样品温度的关系
图5显示了在300和600K时每入射单位量的CF3+所产生的刻蚀产物SiF2,SiF3和SiF4的量与刻蚀时间的关系.从图5中可知,在刻蚀未达到平衡态时,刻蚀产物的量随着刻蚀的进行急剧增加.当样品温度为300K时,在整个刻蚀过程中,SiF2的量先增加后减小,SiF3的量整体呈上升趋势.而SiF4的量在入射量为7 ML时达到最大值,而后呈现下降趋势,并最终趋于稳定状态.并且在整个过程中,刻蚀产物SiF2的量比SiF3和SiF4都要大.当样品温度为600K时,SiF2比SiF3先出现,在入射量为3 ML时,二者量值达到最大,而后随着刻蚀的进行逐渐趋于稳定.当CF3+入射量大于5 ML时,SiF4才开始出现,在整个刻蚀过程中量值的变化均比较平缓,且比SiF2和SiF3的量要小,这一点与文献[10]中所示信息相符.
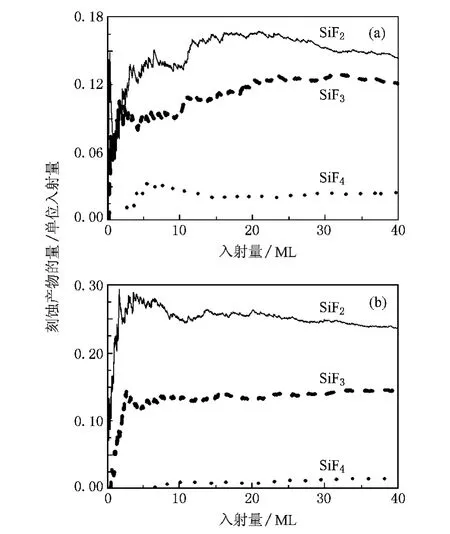
图5 Si的刻蚀产物的对比(a)300K,(b)600K
4. 讨论
根据大量的实验结果[12,22],人们普遍认为等离子体刻蚀原理主要有以下3种:物理刻蚀、化学刻蚀和化学反应增强的物理刻蚀.
1)物理刻蚀指的是入射离子与样品表面的原子进行动量的交换,使样品表面的原子直接脱离表面的过程.如惰性离子Ar+溅射Si的过程.
2)化学刻蚀是由Tu等[23]提出的,首先具有化学活性的入射粒子与样品表面发生化学反应生成易挥发的SiFx(x=1—4),然后这些基团分子可能直接从样品表面脱附的过程.
3)化学反应增强的物理刻蚀是由Mauer等[24]在研究CF4等离子体刻蚀Si时提出的.这个模型认为等离子体中的F原子与基底中的Si原子发生化学反应生成SiFx,这将削弱SiFx中Si与表面其他Si原子的结合力.这些在样品表面形成的SiFx在载能离子轰击下将通过动量交换获得动能脱离表面而形成刻蚀产物.
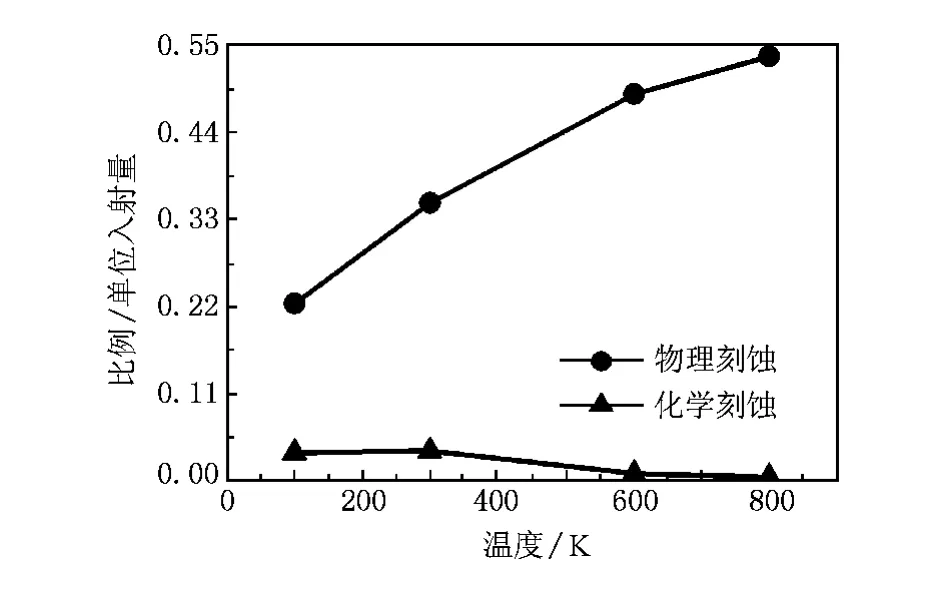
图6 化学与物理刻蚀比例与样品温度的关系
在CF3+与Si表面相互作用的过程中,沉积在Si表面的F原子将与Si发生化学反应生成SiFx.这些基团分子可能在热振动下脱附表面形成刻蚀产物;或者在后来的CF3+轰击下,这些SiFx基团分子可能获得动能而脱离表面.在我们的模拟过程中,将上述模型(1)和(3)统称为物理刻蚀.而模型(2)定义为化学刻蚀.图6是我们在具体的刻蚀过程中每入射单位量的CF3+对样品所产生的刻蚀效果中,物理刻蚀与化学刻蚀各自所占的比例与温度的关系的统计分析.由图6我们可以看出,在整个温度范围内,物理刻蚀比化学刻蚀所占比例要大,这一结果与文献[10]中所示结果相同.物理刻蚀占的比例均随着温度的升高而升高,化学刻蚀所占比例随着温度的升高而降低,这与文献[10]的结果并不相符.文献[10]中,在整个温度范围内化学刻蚀所占比例增加得比较平缓,与温度的关系近似于一条直线;物理刻蚀占的比例在100—300K范围内变化很大,当温度大于300K时变化缓慢.在我们的模拟中,温度对物理刻蚀和化学刻蚀均产生了显著的影响.由图6我们可以得出Si的刻蚀主要是通过物理刻蚀实现的.
5. 结论
在我们进行的模拟中,随着温度的升高,C的沉积量相应增加,而F的沉积随温度的变化并不明显.同时,随着温度的升高,Si刻蚀量逐渐增加,在100,300,600,800K达到稳定态时的刻蚀率分别为0.52,0.75,0.86,0.94.随着温度的升高,刻蚀产物SiF和SiF2的量逐渐增加,SiF4的量逐渐减小,而SiF3的量受温度的影响较小.通过提高样品的温度,物理刻蚀得到了加强,而化学刻蚀被减弱.Si的刻蚀率的增加主要是通过提高SiF,SiF2从表面脱离的量而得以实现的.通过比较发现CF+3在Si表面的沉积对后续的刻蚀过程产生了巨大的影响,具体表现为大大增加了Si的刻蚀率,减弱了Si的化学刻蚀机理.
[1]Chang J P,Cobum J W 2003 J.Vac.Sci.Technol.A 21 S145
[2]Dai Z L,Mao M,Wang Y N 2006 Physics 35 693(in Chinese)[戴忠玲、毛明、王友年2006物理35 693]
[3]Chai C C,Yang Y T,Li Y J,Jia H J,Ji H L 1999 Acta Phys. Sin.48 550(in Chinese)[柴常春、杨银堂、李跃进、贾护军、姬慧莲1999物理学报48 550]
[4]Wang Y N 2000 J.Dalian Univ.Technol.40 12(in Chinese)[王友年2000大连理工大学学报40 12]
[5]Humbird D,Graves D B 2004 J.Appl.Phys.96 2466
[6]Gou F,Zen L T,Meng C 2008 Thin Solid Films 516 1832
[7]Gou F,Gleeson M A,Kleyn A W 2007 Surf.Sci.601 76
[8]Gou F,Gleeson M A,Kleyn A W 2007 Surf.Sci.601 4250
[9]Gou F,Lu X,Qian Q,Tang J Y 2007 Nucl.Instrum.Meth.B 265 479
[10]Gou F,Gleeson M A,Kleyn A W 2008 Int.Rev.Phys.Chem. 27 229
[11]Abrams C F,Graves D B 1999 J.Appl.Phys.86 5938
[12]Yin P H,Saxena V,Steckl A J 1997 Phys.Stat.Sol.202 605
[13]Alder B J,Wainwright T E 1957 Chem.Phys.27 1208
[14]Helmer B A 1997 J.Vac.Sci.Technol.A 15 2252
[15]Helmer B A 1998 J.Vac.Sci.Technol.A 16 3502
[16]Zhou Z Y,Wang T B,Cheng Z N 1999 Acta Phys.Sin.48 2228(in Chinese)[周正有、王铁兵、程兆年1999物理学报48 2228]
[17]Stillinger F H,Weber T A 1985 Phys.Rev.B 31 5262
[18]Abrams C F,Graves D B 1999 J.Appl.Phys.66 5938
[19]Verlet L 1967 Phys.Rev.159 98
[20]Berendsen H J C,Postma J P M,Gunsteren W F V,DiNola A,Haak J R 1984 Chem.Phys.81 3684
[21]Abrams C F,Graves D B 1999 J.Appl.Phys.86 5938
[22]Winters H F,Coburn I W 1979 Appl.Phys.Lett.34 70
[23]Tu Y Y,Chuang T J,Winters H F 1981 Phys.Rev.B 23 823
[24]Mauer J L,Logan J S,Zielinski L B 1978 J.Vac.Sci.Technol. 15 1734
PACC:6120J,7920
*Project supported by Outstanding Young Scientific and Technological Personnel Training Program of Guizhou Province,China(Grant No. 700968101)and the International Thermonuclear Experimental Reactor(ITER)Special Program(Grant No.2009GB104006).
†Corresponding author.E-mail:g.fujun@hotmail.com
Molecular dynamics simulation of temperature effects on CF3+etching of Si surface*
Ning Jian-Ping1)2)Lü Xiao-Dan1)Zhao Cheng-Li1)Qin You-Min1)2)He Ping-Ni1)A.Bogaerts3)Gou Fu-Jun4)5)†
1)(Institute of Plasma Surface Interactions,Guizhou University,Guiyang550025,China)
2)(Material and Metallurgy,College of Guizhou University,Guiyang550003,China)
3)(Research Group PLASMANT,University of Antwerp,B-2610 Wilrijk-Antwerp,Belgium)
4)(Key Laboretory of Radiation Physics and Technology Ministry of Education,Chengdu610064,China)
5)(Foundation of Material Institute for Plasma Physics,3439 MN Nieuwegein,Netherlands)
(Received 11 June 2009;revised manuscript received 3 February 2010)
Molecular dynamics method was employed to investigate the effects of the reaction layer formed near the surface region on CF3+etching of Si at different temperatures.The simulation results show that the coverages of F and C are sensitive to the surface temperature.With increasing temperature,the physical etching is enhanced,while the chemical etching is weakened.It is found that with increasing surface temperature,the etching rate of Si increases.As to the etching products,the yields of SiF and SiF2increase with temperature,whereas the yield of SiF3is not sensitive to the surface temperature.And the increase of the etching yield is mainly due to the increased desorption of SiF and SiF2.The comparison shows that the reactive layer plays an important part in the subsequeat impacting,which enhances the etching rate of Si and weakens the chemical etching intensity.
molecular dynamics,plasmas,etching,sample temperature
book=694,ebook=694
*贵州省优秀青年科技人才培养计划(批准号:700968101)和国际热核聚变实验堆(ITER)计划专项(批准号:2009GB104006)资助的课题.
†通讯联系人.E-mail:g.fujun@hotmail.com
