原子级控制的约瑟夫森结中Al2O3 势垒层制备工艺
2022-11-14李中祥王淑亚黄自强王晨穆清
李中祥 王淑亚 黄自强 王晨 穆清†
1)(郑州大学国家超级计算郑州中心,郑州 450001)
2)(数学工程与先进计算国家重点实验室,郑州 450001)
3)(郑州大学计算机与人工智能学院,郑州 450001)
4)(复旦大学微电子学院,上海 200433)
5)(上海集成电路制造创新中心,上海 200433)
传统热氧化方式制备约瑟夫森结中AlOX 势垒层是将高纯度氧气扩散到Al 表面进行,但该方式制备的势垒层氧化不完全,厚度难以精准控制.本文采用原子层沉积方式在金属Ti 表面逐层生长Al2O3 势垒层,并制备出三明治结构的Ti/Al2O3/Ti 约瑟夫森结.通过调节Al2O3 势垒层的沉积厚度和约瑟夫森结的面积研究了其相应的微观结构及电学性质.实验结果表明,原子层沉积方式生长的单层Al2O3 薄膜厚度约为1.17 Å(1 Å=10-10 m),达到原子级控制势垒层厚度,通过调节势垒层厚度实现了对结室温电阻值的控制,并通过优化结面积获得了室温电阻均匀性良好的约瑟夫森结.
1 引言
作为超导量子电路中唯一的无损耗非线性元件[1],约瑟夫森结通常是一种超导体-绝缘体-超导体结构的超导隧道结,其工作原理是基于极低温下由电子形成的库珀对的隧穿效应.由于半导体工业的兼容性,约瑟夫森结是实现超导量子比特的重要方式之一,中间超薄绝缘体构成的势垒层是实现两侧超导电极相干性的关键所在[2].在材料选择上,由于Al 的氧化物质地坚固,钝化性能好且适合库珀对的隧穿,一般采用Al 的氧化物作为约瑟夫森结的势垒层[3,4].目前,通常采用原位热氧化方式将氧气扩散到Al 表面制备AlOX势垒层[5],但该反应是自限制的,形成的AlOX薄膜会阻碍氧原子扩散到下方的Al 表面,随着反应时间增加,AlOX薄膜逐渐变厚,最终将彻底阻挡氧原子,使其无法扩散至Al 表面,从而达到生长极限厚度[6].同时,由于氧分压难以精确控制等问题,热氧化工艺难以制备出均匀且厚度精准控制的势垒层.此外采用热氧化方式制备的AlOX势垒层(其化学计量是不确定的,一般利用退火工艺将AlOX转变为质量较高的Al2O3[7]),存在例如氧空位等缺陷会引起量子电路中的两能级涨落,这也是造成量子比特退相干的主要原因[8].想要进一步提高退相干时间,关键在于提升势垒层质量,所以使用一种新的势垒层生长方式制备约瑟夫森结势在必行.
原子层沉积(atomic layer deposition,ALD)是一种化学沉积过程,能够满足连续、自限制表面反应的原子层控制和共形沉积的需要[9],自限制表面反应限制外界原子向薄膜下方扩散,从而在薄膜上方不断堆积,每个循环生长一层原子薄膜.如图1(a)所示,ALD 生长Al2O3发生在水和三甲基铝(trimethylaluminium,TMA)交替暴露的过程中,这一过程可以描述为[10-12]
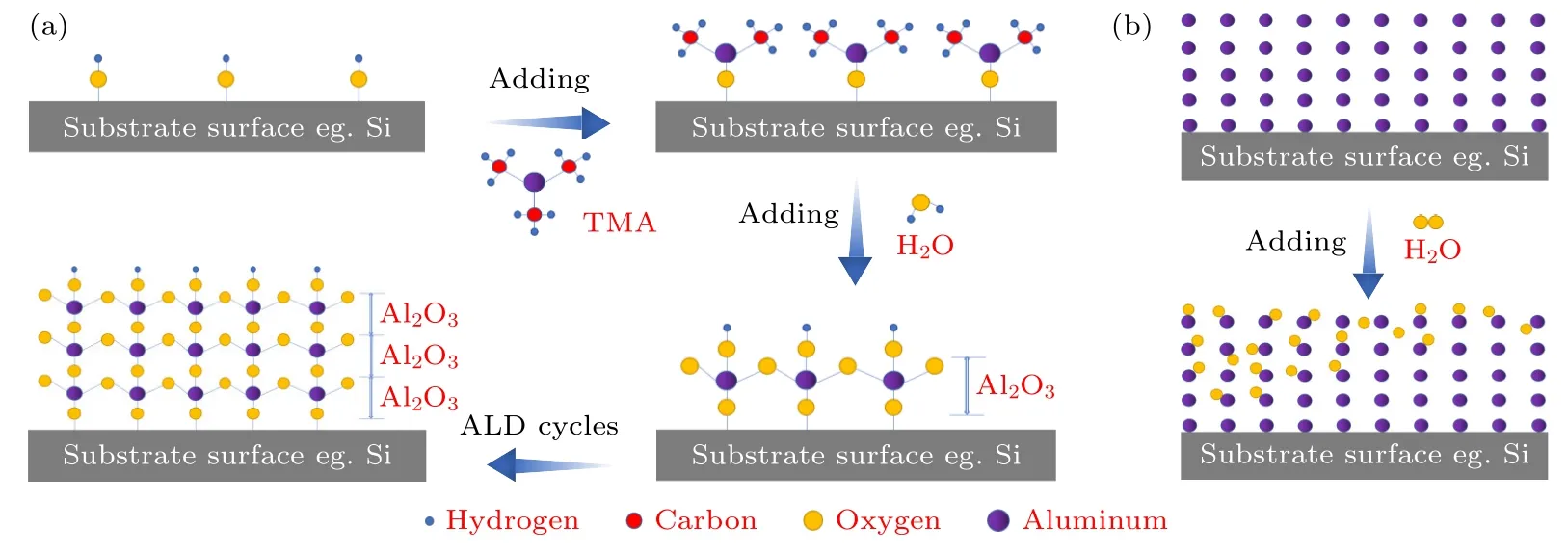
图1 ALD 与热氧化方式生长氧化铝势垒层的过程示意图(a)ALD 生长Al2O3 的过程;(b)热氧化方式生长AlOX 的过程Fig.1.Schematic diagram of the process of growing aluminum oxide layer by ALD and thermal oxidation:(a)Process of growing Al2O3 by ALD;(b)process of growing AlOX by thermal oxidation.

其中,带*号表示表面物质.衬底可选用硅(Si)或者一些金属,因其表面比较容易羟基化.TMA(Al(CH3)3)与表面羟基(OH-)反应,会在表面沉积一层Al(CH3)2,之后通入惰性气体引入水,水在表面反应物上又再次羟基化,形成一个完整的ALD循环,生长一层Al2O3薄膜.重复这一过程可以获得连续、均匀、无孔的高质量Al2O3薄膜[13],制备出的薄膜两能级缺陷密度较低[14].然而,热氧化(图1(b))是通过氧气从Al 表面向下扩散形成氧梯度生长AlOX隧道势垒层,可控性较差.因此ALD通过逐层向上生长的方式制备Al2O3隧道势垒层具有显著优势.在上述研究背景下,本文对ALD方式生长的Al2O3隧道势垒层及制备出的相应Ti/Al2O3/Ti约瑟夫森结进行了探索和研究,利用ALD 生长Al2O3薄膜的各项优点,通过剥离工艺制备出了多组势垒层厚度不同、结区面积不同的Ti/Al2O3/Ti约瑟夫森结,并对其断面微观结构以及电学性质进行了测量研究.
2 实验
2.1 约瑟夫森结制备
首先,沉积底电极.在Si 衬底上旋涂光刻胶,利用光刻技术定义出底层金属图形,然后采用磁控溅射方式以0.28 nm/s 的速率沉积Ti 金属薄膜(图2(a)),之后使用剥离工艺将图形转移到金属层,形成底电极.随后,开始制备势垒层.由于样品在剥离工艺结束后在转移过程中会接触空气,底电极表面不可避免会形成一层自然氧化层(图2(b)).使用基于氦氢混合气体(95%He∶5%H2)的反应预清洁(reactive pre-clean,RPC)技术去除底电极表面自然氧化层[15](图2(c)),并在真空(9.9×10-6Torr,1 Torr=1.33×102Pa)中原位传输样品到薄膜生长腔室.在进行ALD 反应之前,由于腔室温度较高,一般将样品在腔室内预热5 min,有利于衬底表面羟基化,使反应更加顺利.采用ALD方式在底电极表面生长Al2O3势垒层(图2(d)),腔室温度为300 ℃,每次循环通入0.5 s 的水,氮气吹扫反应残余物9 s,接着通入TMA 0.5 s,氮气吹扫反应残余物5 s.最后,沉积顶电极.顶电极定义方式和沉积方式(图2(e))与底电极相同,剥离后,顶电极与底电极金属线条垂直相交形成完整的约瑟夫森结(图2(f)).其中,约瑟夫森结的面积固定为44 µm×44 µm,在该结面积下分别生长12,15,20,25 个循环的势垒层,制备出4 组不同势垒层厚度的约瑟夫森结,底部与顶部的Ti 电极厚度均为100 nm.此外,将势垒层ALD 循环次数固定为12 次循环,在相同势垒层厚度下,分别制备0.04,0.09,0.25,0.49,1.00 µm2等5 组不同面积的约瑟夫森结,顶部与底部的Ti 电极厚度均为30 nm.
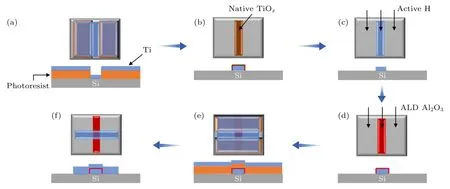
图2 约瑟夫森结制备过程示意图(a)光刻后第一次溅射Ti 示意图;(b)光刻胶剥离后,Ti 金属电极表面立即形成自然氧化层;(c)使用RPC 技术利用活性氢去除氧化层;(d)去除自然氧化层后原位ALD 生长Al2O3;(e)第二次光刻确定顶电极图案,并进行第二次溅射Ti;(f)金属剥离形成完整的结Fig.2.Schematic diagram of Josephson junction preparation process:(a)Schematic diagram of the first sputtered Ti after photolithography;(b)natural oxide layer formed on the Ti metal electrode surface immediately after lift-off process;(c)removal of the oxide layer using the RPC technique by reactive hydrogen;(d)in situ ALD growth of Al2O3 after removal of the natural oxide layer;(e)the second photolithography to determine the top electrode pattern and sputtered Ti again;(f)lift-off process to complete the junction.
2.2 约瑟夫森结的表征测试
利用透射电子显微镜(transmission electron microscope,TEM)对约瑟夫森结中Al2O3隧道势垒层的厚度进行表征.利用拥有0.5 µm 铂探针的多点接口(multi point interface,MPI)探针台以及是德科技(Keysight)4200 参数分析仪测量约瑟夫森结室温下的电流-电压(I-V)曲线,并从I-V曲线的斜率中提取室温电阻(Rn).安倍戈卡-巴拉托夫(Ambegaokar-Baratof)公式[16]预测隧道电阻,即室温电阻和结面积(A)的乘积,与其临界电流密度(JC)成反比:

其中Δ为超导能隙,e是元电荷.为实验测量室温电阻判断参数是否符合要求提供了依据[17,18].此外,约瑟夫森结室温电阻值的波动会受到结区面积变化的影响[19,20],不同结面积的约瑟夫森结的室温电阻值波动程度不同.
3 结果分析与讨论
为了研究ALD 逐层生长Al2O3势垒层的效果,我们使用TEM 对势垒层断面微观结构进行了测量表征.图3(a)显示了势垒层厚度为12 次循环(12 层Al2O3薄膜)的Ti/Al2O3/Ti 约瑟夫森结断面结构.测量得到的Al2O3势垒层厚度为1.4 nm,则单层 Al2O3薄膜厚度约为1.17 Å(1 Å=10-10m),说明使用ALD 工艺通过控制循环的次数,可以实现对Al2O3势垒层厚度的原子级控制.
接下来测量了不同势垒层厚度下约瑟夫森结的室温电阻,来探究势垒层厚度与室温电阻之间的关系,见图3(b).结面积固定为44 µm×44 µm,势垒层厚度的变化通过ALD 循环次数来控制.对不同势垒层厚度下约瑟夫森结的室温电阻进行了多次测量,并统计其平均值.当势垒层厚度大于12 次循环时,随循环次数增加,室温电阻值呈指数变化增长,RnA变化范围约为104-108Ω·µm2,说明室温电阻值与势垒层厚度呈指数关系.根据测量得到的电阻值以及(3)式,在Ti 的超导临界转变温度0.4 K 下计算得到临界电流密度JC与ALD循环次数之间的关系.随着循环次数增加,临界电流密度JC呈指数下降,其变化范围约为10-4-100A/cm2.这些结果表明可以通过调节循环次数,实现原子级控制势垒层厚度,从而精准地控制室温电阻值,得到所需的临界电流密度.
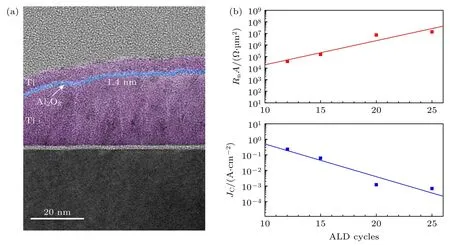
图3 (a)势垒层厚度为12 层Al2O3 薄膜的约瑟夫森结断面结构TEM 图像;(b)隧道电阻RnA,计算得到的JC 与ALD 循环次数的关系Fig.3.(a)TEM image of Josephson junction cross-sectional structure with Al2O3 tunnel barrier’s thickness is 12 layers;(b)relationship between the tunnel resistance RnA,the calculated JC and the ALD cycles.
为了探究ALD 方式制备的约瑟夫森结室温电阻均匀性问题,在势垒层厚度为12 次循环(12 层Al2O3薄膜)下,制备了5 组Ti/Al2O3/Ti约瑟夫森结,其结面积大小分别为0.04,0.09,0.25,0.49,1.00 µm2.通过测量其室温电阻值并采用相对标准偏差(relative standard deviation,RSD)的方式来计算其均匀性.图4 显示了不同结面积下约瑟夫森结的典型I-V曲线以及电阻均匀性与结面积之间的关系,具体测量值见表1.

表1 不同结面积的约瑟夫森结室温电阻比较Table 1. Comparison of room temperature resistance of Josephson junctions with different areas.

图4 不同结面积下约瑟夫森结的室温电阻测量结果以及其均匀性数据图(a)室温下测量的不同结面积下约瑟夫森结的I-V曲线;(b)结面积与电阻值之间的关系(图中点表示测量电阻的平均值,Y 误差棒使用标准差计算)Fig.4.Room temperature resistance measurements of Josephson junctions at different junction areas and their uniformity data plotted:(a)I-V curves of Josephson junctions at different junction areas measured at room temperature;(b)relationship between junction areas and resistance values(The dots in the graphs indicate the mean values of the measured resistances,and the Y error bars are calculated using the standard deviation).
约瑟夫森结的电阻值与结面积成反比,结面积越小,其电阻值越大.此外,器件尺寸越小,对制备工艺的要求越高,结面积越小的约瑟夫森结在制备过程中越难以控制参数,因此会导致其电阻值的RSD 偏大.通过约瑟夫森结面积的优化以及电阻均匀性的对比,在结面积为0.25 µm2时获得了均匀性较好的室温电阻值,其RSD 为21%,该结论可为将来批量制备约瑟夫森结以及可扩展的量子芯片提供参考.
4 结论
采用原子层沉积Al2O3薄膜制备技术和剥离工艺,以Al2O3薄膜作为势垒层在Si 衬底制备了三明治结构的Ti/Al2O3/Ti 约瑟夫森结,并对制备约瑟夫森结的微观结构以及室温条件下的电学性质测试进行研究.实验结果表明,单层Al2O3薄膜厚度约为1.17 Å,达到了原子级控制.随着ALD循环次数增加,Rn呈指数增长(循环次数变化范围为12-25 时,其对应电阻变化范围约为104-108Ω·µm2),因此可通过调节ALD 循环次数来控制势垒层厚度,进而实现对室温电阻的调控.此外,通过优化约瑟夫森结面积,在结面积为0.25 µm2时获得了RSD 为21%的均匀性较好的室温电阻.后续工作中,我们将持续优化ALD 生长Al2O3薄膜的条件,并通过多样化基底材料与多样化势垒层生长工艺相结合的探索,为实现高质量可扩展的超导量子芯片提供有价值的技术参考.
