ReSe2/WSe2 记忆晶体管的光电调控和阻变特性*
2022-11-14余雪玲陈凤翔相韬邓文刘嘉宁汪礼胜
余雪玲 陈凤翔 相韬 邓文 刘嘉宁 汪礼胜
(武汉理工大学理学院物理科学与技术系,武汉 430070)
记忆晶体管是结合了忆阻器和场效应晶体管特点的多端口器件.二维过渡金属硫化物拥有独特的电子结构和性质,在电子器件、能源转化、存储器等领域都有广泛的应用.本文以二维金属硫化物为基础,制备了ReSe2/WSe2 双p 型的范德瓦耳斯异质结记忆晶体管,探究其在电控、光控以及光电协控下的阻变特性变化.结果表明: 栅压是调控记忆晶体管性能的重要手段,可有效地调控开关比在101-105 之间变化;不同波长光照或者光功率密度的变化可以实现记忆晶体管高低阻态和开关比的调控;而且,光电协控也可使器件开关比在102-105 范围内变化,并分析了不同调控条件下器件阻态变化的原因.此外,在经历了225 次循环和1.9 ×104 s 时间后,ReSe2/WSe2 异质结构记忆晶体管仍能保持接近104 的开关比,表明器件有良好的稳定性和耐久性,将是一种很有发展潜力的下一代非易失性存储器.
1 引言
忆阻器是一种连接磁通和电荷的非线性元件,其物理模型由蔡少棠教授从理论推导而出[1].自2008 年实验室证实存在TiO2忆阻器[2]以来,忆阻器在逻辑运算、非易失性存储、人工突触、光电突触[3,4]等领域引起科学家们的广泛关注和研究.随着信息社会的不断发展,人们对微纳电子应用的需求极速增长,传统的基于大块金属氧化物的忆阻器由于存在稳定性低、氧化层厚等问题,难以满足人们对超高性能计算与非易失性存储的需求[5,6].而低维半导体材料拥有优良的导电性、高稳定性、高开关比以及良好的灵活性等,是新型电子和光电应用的理想材料[7-9].
如今,很多二维材料已被应用于制备具有超高集成度[10,11]、超低功耗[12]、超高读写速度[13,14]的忆阻器.如MoS2作为过渡金属硫族化合物的典型代表,是忆阻器件中研究最广泛的二维材料之一.2018 年,Sangwan 等[15]报道了一种基于Au/MoS2(多晶单层)/Au 水平结构的多端口记忆晶体管[16],将忆阻器和场效应晶体管的性能结合在以二维半导体材料为沟道的单个器件中[17],其不仅能响应偏置电压的输入信号,还可响应栅极输入的电信号以及外加光信号,成功实现了多端口调控.
在阻变材料的选取中,除了利用单一的二维材料外,还可以将两种不同的二维材料构建成范德瓦耳斯异质结来综合利用它们的光电特性,提升器件性能.2021 年,Zhang 等[18]制备了基于WS2/MoS2异质结的忆阻器,其拥有104的开关比,高低阻态保持时间为 5×103s.与WS2类似,WSe2也具有良好的稳定性,在潮湿的环境中比MoS2更抗氧化[19].而ReSe2是一种具有扭曲三斜结构的二维材料,具有独特的、各向异性的电子和光学特性.2021 年,Rehman 等[20]利用微机械剥离法制备了基于ReSe2/石墨烯异质结的记忆晶体管,通过改变栅压(-90 V-90 V)实现了开关比在102-105范围内的调控.除以上异质结的研究外,2019 年,殷俊[21]通过光刻工艺和磁控溅射法制备了基于W/HfO1.97/HfO1.7/Pt 同质结构的忆阻器,实现了多种突触可塑性.
目前,关于WSe2和ReSe2搭建范德瓦耳斯异质结[22]制备记忆晶体管的研究报道还比较少.结果表明,基于ReSe2/WSe2的p-p 型记忆晶体管,不仅拥有良好的阻变性能,还拥有优异的稳定性和耐久性,其综合性能在二维材料记忆晶体管中表现出巨大的潜力;此外,该记忆晶体管在电场、光场和光电协同调控下均表现出明显的阻态变化行为,有望为基于二维材料忆阻器的研究提供新的思路和方向.
2 实验部分
制备ReSe2/WSe2异质结记忆晶体管的实验流程如下: 首先,选用带300 nm 二氧化硅层的p+型硅衬底,分别使用丙酮和无水乙醇超声清洗10 min 和5 min,氮气吹干备用;接着进行二维材料的转移,采用微机械剥离法先转移WSe2到硅衬底上,然后利用转移平台,借助PDMS 胶带辅助将ReSe2搭在WSe2上形成异质结构;紧接着在异质结上部旋涂一层光刻胶,通过紫外光刻定制沟道宽为10 µm 的电极图案,再用显影液将电极图案显出;之后,通过热蒸发在器件上表面沉积一层50 nm 厚的金膜;最后,使用Lift-off 工艺,用丙酮清除多余的光刻胶和金膜,就可以得到Au/ReSe2/WSe2/Au 结构的记忆晶体管,器件结构如图1 所示.

图1 ReSe2/WSe2 异质结晶体管的结构图Fig.1.Structure diagram of the ReSe2/WSe2 heterojunction memtransistor.
ReSe2/WSe2异质结的表面形貌用DI Nanoscope Ⅳ原子力显微镜表征;拉曼光谱利用LabRAM HR Evolution 光谱仪测试,激发波长532 nm;器件的I-V性能利用Keithley 4200-SCS 半导体参数测试仪分析;使用Keithley 2400 源表测试阻态保持特性.以上测试均在室温、空气、电磁屏蔽条件下进行.
3 结果与分析
3.1 器件的微观表征及分析
图2(a)给出了ReSe2/WSe2异质结的原子力显微镜(AFM)图.从图2(a)可以看出,微机械剥离法制备出来的ReSe2和WSe2表面形貌都很平整.沿图2(a)中白线所示的厚度变化示于图2(b),可以发现,ReSe2层的厚度大约为8 nm,WSe2层的厚度大约为16 nm.根据研究结果,单层ReSe2的厚度大约是0.7 nm,单层WSe2的厚度也约为0.7 nm,所以该结构中ReSe2约有11 层,WSe2约有22 层,均为典型的多层结构.图2(c)给出了ReSe2和WSe2的拉曼光谱,其中WSe2的主特征峰位于249 和260 cm-1,分别对应和2LA 振动模式[23].和WSe2相比,由于ReSe2层独特的三斜结构,ReSe2的特征峰众多,分布在100-270 cm-1之间[24].我们标记了其中主要的峰位,如127,163和177 cm-1,分别对应A1g,E1g和E2g振动模式.

图2 ReSe2/WSe2 异质结的形貌表征(a)ReSe2/WSe2 异质结的AFM 图;(b)沿图(a)中白色箭头的厚度数据图;(c)WSe2 和ReSe2 的拉曼光谱图Fig.2.Surface topography image of ReSe2/WSe2 heterojunction memtransistor:(a)AFM image of ReSe2/WSe2 heterojunction;(b)height profile of ReSe2/WSe2 along the thin white line in panel(a);(c)Raman spectra of the WSe2 and ReSe2 layer.
3.2 器件的高低阻态和稳定性测试
为了研究Au/ReSe2/WSe2/Au 记忆晶体管的阻变开关特性,图3(a)给出了黑暗条件下、栅压Vg=0 V 时对器件施加源漏双向扫描电压时得到的Id-Vds特性曲线,源漏电压Vds变化范围分别为-5-5 V,-10-10 V,-15-15 V 和-20-20 V,图中的箭头和数字分别代表扫描的方向和顺序;Id为漏电流.对器件测试之前,首先对器件施加一个单向负偏压进行初始化(0→-Vds),将器件从高阻态(HRS)改变为低阻态(LRS).然后施加双向扫描电压,其扫描顺序为-Vds→0 V,0 V→Vds,Vds→0 V,0 V→-Vds,分别对应图中的1,2,3,4 过程,而过程4 又将作为下一个双向扫描的初始化过程.
由图3(a)可以发现: 不同的源漏扫描电压范围下,器件拥有不同的忆阻特性,扫描电压范围越大,开关比越高,如Vds=-20-20 V 时,开关比可达1.39×106.此外还可以看出,器件表现出明显的非易失性双极性阻变行为,而且处于负偏压下的特性曲线绕出了“8”字样.在I-V回扫中,器件中的电荷存储在多层ReSe2,WSe2内部的缺陷及两种材料接触界面处的陷阱中,此时的工作机制应为电荷俘获和释放机制(charge trapping/detrapping process)[25-27].因为在阻变材料和忆阻器的制备过程中,不可避免地会引入一些缺陷和杂质,而这些杂质和缺陷的存在会在材料的禁带中引入缺陷或杂质能级.在器件的阻变开关过程中,这些杂质和缺陷作为电荷陷阱将会俘获大量的载流子,导致器件的初始状态处于高阻态;当这些电荷陷阱释放被俘获的载流子时,器件的电阻迅速减小,器件将由高阻态转变为低阻态.因此器件中的杂质和缺陷对载流子的俘获和释放实现了器件的阻态转变.
为了研究ReSe2/WSe2异质结的稳定性,在黑暗条件下对器件进行了225 个周期的循环测试,源漏扫描电压为-15-15 V.图3(b)给出了器件在进行225 次循环周期下的高低阻态变化图.由图3(b)可以看出,随着循环周期的进行,器件的高阻态电阻值虽有上下浮动现象,但总体保持稳定(阻值高于1010Ω),低阻态则自始至终都很稳定.值得注意的是,器件在225 个循环周期下仍然能保持高于104的开关比,说明器件不仅拥有良好的开关性能,还拥有良好的稳定性.同时也探究了器件的耐久性,读取电压仍为2.4 V,测试结果示于图3(c).测试结果显示:在1.9×104s 时间内,器件的高低阻态几乎不随时间变化,始终能保持接近104的开关比.
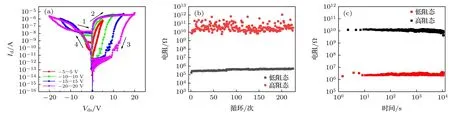
图3 在0 V 栅压下,Au/ReSe2/WSe2/Au 记忆晶体管的阻变特性(a)在不 同源漏扫描电压下的Id-Vds 特性曲线;(b)连续225 次循环周期下器件在Vds=2.4 V 时的高低阻值变化图;(c)器件在室温下高低阻态保持特性图Fig.3.Resistance characteristics of the Au/ReSe2/WSe2/Au memtransistor at Vg= 0 V:(a) Id-Vds characteristic curves of Au/ReSe2/WSe2/Au memtransistor at different source drain sweeping voltages;(b)reversible resistance switching between the HRS and LRS over 225 cycles at Vds=2.4 V;(c)the retention characteristics of the device at room temperature.
为了明确Au/ReSe2/WSe2/Au 记忆晶体管的阻变转换机制,图4(a)给出了ReSe2和WSe2单独的能带结构,其中ReSe2和WSe2的带隙分别为1.08 eV[28]和1.5 eV[29].虽然ReSe2和WSe2均为p 型材料,但ReSe2的费米能级(EF=-4.27 eV)高于WSe2的费米能级(EF=-4.75 eV),因此两者接触形成平衡态时,ReSe2能带整体下移,而WSe2能带整体上移,在两者交界处形成p-p 结的内建电场,平衡条件下两者间形成的能带图示于图4(b),其中EC和EV分别表示导带底和价带顶.

图4 ReSe2/WSe2 记忆晶体管的阻变转换机制分析(a)ReSe2 和WSe2 单独的能带图;(b)ReSe2/WSe2 异质结的平衡能带图;(c)负偏置电压下的双对数Id-Vds 曲线Fig.4.Resistance switching mechanism analysis of ReSe2/WSe2 memtransistor:(a)Energy band arrangement for ReSe2 and WSe2;(b)energy band diagram of ReSe2/WSe2 heterojunction;(c)logarithmic Id-Vds curves of the memtransistor in the negative bias region.
测试时ReSe2作为漏端,WSe2作为源端.虽然整个Vds扫描循环是以顺时针方向来切换高、低阻态,但负偏压方向与p-p 结的内建电场方向相反,因此阻态转换的工作机制和以n 型沟道材料为主的忆阻器基本类似.在初始化过程(“4”过程)中,电压从0 V→-Vds,随负偏压的增加,内建电场被削弱,因此器件虽然保持HRS,但电流不断增加;当电压为-Vds时,器件转为LRS.这个转变过程是缓慢的,和氧化物忆阻器中的基于导电细丝导电的机制完全不同[30,31].在“1”过程中,电压从-Vds→0,虽然外加偏压在下降,内建电场逐渐恢复,但器件保持LRS.当偏压为0 V→Vds时,外加偏置电压的方向与内建电场方向相同,不断增强内建电场,但此时存储在缺陷和陷阱中的空穴不断被提取出,器件保持LRS,对应“2”过程.当正偏置电压达到Vds时,内建电场得到增强,导致器件从LRS 转变为HRS;并保持HRS 状态从Vds扫回0 V,对应“3”过程.
为进一步分析Au/ReSe2/WSe2/Au 记忆晶体管的导电机制,将0 V→-15 V 时器件从HRS 到LRS 过程中(即“SET”过程)的Id-Vds曲线以双对数坐标轴的形式绘于图4(c).此线即图3(a)中的“4”线,为了方便数学处理,电压以|Vds|表示.由于ReSe2/Au 电极、WSe2/Au 电极形成的肖特基势垒以及ReSe2/WSe2界面间的内建电场,器件初始表现为HRS.随着负向扫描电压的增加,WSe2和ReSe2中的空穴开始填充器件中的缺陷直至饱和,此时器件电流逐渐增加,但电阻始终保持HRS.
从Id-Vds曲线的斜率判断,当负偏压较低时,曲线的斜率为2,满足Child 公式(I∝V2),表明此时是浅缺陷控制的空间电荷限制电流传导,当负偏压进一步增加,曲线斜率增加到4、甚至5,此时I∝Vα(α>2),对应陷阱填充限制,反映载流子被更深的陷阱所俘获.随着反向偏压的进一步增加,肖特基势垒和内建电场逐渐降低,当电压达到-15 V 时,器件阻态从HRS 转化为LRS.只是此时电流反而有所下降,可能原因是由于外加电压的下降,空穴迅速被ReSe2和WSe2中更深层的缺陷俘获导致载流子浓度降低[32].
3.3 器件的电场栅极调控
为了探究ReSe2/WSe2记忆晶体管的电控性能,对器件施加小幅度的正、负栅压,得到的Id-Vds特性曲线如图5 所示.在图5(a)中,随着栅压从-0.1 V 变化到-1 V,负偏置电压下低阻态的Id向高电流方向移动,反映了记忆晶体管的p 型特性,此时低阻态的阻值随负栅压的增大而减小.而且,施加的负栅压越大,低阻态下的Id-Vds曲线越往上移动,当Vg=-1 V 时曲线不再绕“8”字,形成了完整的闭回曲线.同时,-1 V 以内的负栅压对正偏置电压下的阻变特性几乎没有影响.而由图5(b)可以看出,对于1 V 以内的正栅压,负偏压下的电流随栅压增加明显下降,但对器件正偏置电压下的阻变特性影响不大.

图5 在-1 V <Vg <1 V 范围中,不同栅压下ReSe2/WSe2 记忆晶体管的阻变特性(a)负栅压Vg=-0.1--1 V 时的Id-Vds 特性曲线;(b)正栅压Vg=0.1-1 V 时的Id-Vds 特性曲线(0 V 作为参考)Fig.5.Resistance characteristics of ReSe2/WSe2 memtransistors at different gate voltages in the range of -1 V <Vg <1 V:(a) Id-Vds characteristic curves at negative gate voltage Vg=-0.1--1 V;(b)Id-Vds characteristic curves at positive gate voltage Vg=0.1-1 V(the black line with Vg=0 V is as a reference).
较高栅压下测试ReSe2/WSe2异质结记忆晶体管的电控性能,结果示于图6.从图6(a)可以看出,由于器件的p 型特性,当负栅压|Vg|≥10 V 时,器件在负偏置电压下的高低阻态电流均对比零栅压时有明显增加,此外,在正偏置电压下的低阻态电流基本保持不变,而高阻态电流有小幅度的上升.图6(b)显示了正栅压Vg≥10 V 时器件的Id-Vds特性曲线,此时图中的Id-Vds曲线变为单极性.从图6(b)可以看出,随着栅压的增加,正偏置电压下的HRS 电流急剧增大,当Vg增加到25 V 时,HRS 电流上升到10-9A 以上,相比Vg=0 V时上升了3 个数量级,而LRS 电流相对来说几乎不变,这导致器件在Vds=2.4 V 时的开关比急剧减小.

图6 高栅压(|Vg|>10 V)时,不同栅压下Au/ReSe2/WSe2/Au 器件的阻变特性(a)负栅压Vg=-10--25 V 时的Id-Vds 特性曲线(其中0 V 曲线作为参考);(b)正栅压Vg=10-25 V 时的Id-Vds 特性曲线Fig.6.Resistance characteristics of Au/ReSe2/WSe2/Au device at higher gate voltages(|Vg|>10 V):(a) Id-Vds characteristic curves at negative gate voltages Vg=-10--25 V(the black line with Vg=0 V is as a reference);(b) Id-Vds characteristic curves at positive gate voltages Vg=10-25 V.
为阐明ReSe2/WSe2记忆晶体管的阻变机理,图7 给出负偏置电压(Vds<0)时,不同栅压下ReSe2/WSe2记忆晶体管的简化能带图.从图7 可以看出: 有外加负偏压时,空穴从源端注入,越过WSe2/Au,ReSe2/Au 肖特基势垒以及ReSe2/WSe2界面势垒,进入漏端,形成沟道电流,此时能带图示于图7(a).当外加负栅压时,ReSe2/WSe2中的准费米能级下移,由于WSe2和ReSe2均为p 型材料,沟道中以空穴导电为主,准费米能级的下移使空穴更容易从源端进入WSe2中,如图7(b)所示,因此沟道中空穴浓度增加.又因为负偏置电压会降低ReSe2/WSe2界面势垒,因而当Vg=-1 V 时,低阻态电流增长得更快,负偏置电压下的曲线不呈现“8”字,而是形成了一条完整的闭合曲线,如图5(a)所示.当外加较高的负栅压时,在负偏压范围内,器件的高低阻态电流均有明显的提升;而在正偏压范围内,器件的低阻态电流仅依赖于Vds的扫描范围[33],对栅压并不敏感,仅高阻态电流有小幅增长.

图7 Au/ReSe2/WSe2/Au 记忆晶体管的简化能带图(Vds<0)(a)Vg=0 V;(b)Vg<0 V;(c)Vg>0 VFig.7.Simplified band diagram of Au/ReSe2/WSe2/Au memtransistor(Vds<0):(a)Vg=0 V;(b)Vg<0 V;(c)Vg>0 V.
当外加正栅压时,ReSe2/WSe2中的准费米能级上移,对于源端的空穴来讲,进入到WSe2层中的势垒升高,沟道中载流子明显减少,如图7(c)所示,因此正栅压降低了沟道中的空穴浓度.负偏置电压下,器件高、低阻态的电流均出现了下降,在较高的正栅压下,甚至改变了记忆晶体管的极性,如图6(b)所示.而外加正偏置电压时,正偏置电压增强了内建电场,但较高的正栅压会抑制WSe2/Au肖特基势垒,这两者的共同作用导致器件中高阻态电流有较大增加,而低阻态电流对栅压的影响不敏感,基本保持不变,因此器件的开关比急剧下降.
表1 列出了栅压在0-25 V 范围内变化时器件在Vds=2.4 V 的HRS 和LRS 阻值以及对应开关比.可以看出,当栅压增加,HRS 阻值快速降低,而LRS 阻值小幅度增加,以致开关比持续地减小.当Vg=25 V 时开关比已从Vg=0 V 时的2.66×105降至4.70×101.

表1 不同正栅压下器件的详细参数Table 1. Detailed parameters of the device under different positive gate voltages.
因此,对器件施加正、负栅压都可以调节器件的开关比.相比于Vg=0 V,当Vg=10 V 时开关比就能被调控超过2 个数量级,Vg=25 V 时能被调控将近4 个数量级,由此可见,正栅压可大幅度调控器件的开关比,从2.66×105降至4.70×101.负栅压下,由于高阻态电流有所上升,当Vg=-25 V时器件开关比达到最小值2.52×103,因此可实现开关比在2.52×103-2.66×105范围内的调控.
3.4 光场栅极调控
为了探究光场对器件性能的影响,对器件施加不同波长的单色光照射,入射波长光功率密度为0.15 mW·cm-2,在Vg=0 V 下测试其Id-Vds特性,得到的结果如图8 所示,其中暗场条件下的Id-Vds曲线作为参考.图8 中显示,器件的高阻态Id在正偏压下明显增加,这是因为ReSe2层和WSe2层都是良好的光吸收层[34,35].对器件施加不同波长光照后,其Id-Vds特性曲线呈现出可调的高电阻状态.入射波长为500 nm 时,对应高阻态电流最大,随波长进一步增加,器件在正偏置电压下的高阻态电流逐渐降低,表明ReSe2/WSe2异质结对500 nm波长的光吸收率最高.

图8 Au/ReSe2/WSe2/Au 器件在不同波长光栅调控下的Id-Vds 曲线Fig.8.Id-Vds curves of the Au/ReSe2/WSe2/Au device under optical modulation with different wavelengths.
当施加400-800 nm 的波长光照时,器件的阻态变化主要归因于光生伏特效应,光照在沟道材料中产生电子-空穴对,并在内建电场的作用下快速分离形成光生电流.ReSe2/Au 和WSe2/Au 界面上的表面态可俘获光生载流子,降低肖特基势垒高度,因此光照的效果类似于外加正栅压,此时能带变化可参考图7(c),引起高阻态电流的明显上升,器件开关比下降.当光照波长增加到1000 nm时,器件对入射光波的吸收减弱,此时的开关比恢复到接近黑暗条件下的开关比.
不同光功率密度对器件阻变特性影响的结果示于图9.参考图8 的结果,分别选取波长为500,800和1000 nm 的光照.图9(a)中,当λ=500 nm 时,随入射光强从3.53 µW·cm-2增至1.16 mW·cm-2,低阻态电流基本无变化,而正偏压下的高阻态电流逐渐增加,表明HRS 阻值不断下降.因为ReSe2/WSe2结构在500 nm 附近的光响应最高[29],光照在ReSe2层和WSe2层中产生电子-空穴对,光生载流子在内建电场的作用下分离,分别移向源极和漏极,增加了沟道内载流子的浓度,因此光功率密度变化可调节器件的开关比.在图9(b)中,λ=800 nm时,器件的光吸收减弱,表现为高阻态电流随着光强的增加增长缓慢,因此800 nm 波长的光照对器件的阻变特性影响较小.图9(c)中,由于ReSe2/WSe2结构对1000 nm 波长无明显吸收,此波长的光强变化对阻变特性基本无影响.

图9 不同波长、不同光强下器件的Id-Vds 特性曲线(a)500 nm光照;(b)800 nm 光照;(c)1000 nm 光照Fig.9.Id-Vds curves of the device under different wavelengths and powers:(a)500 nm illumination;(b)800 nm illumination;(c)1000 nm illumination.
受实验条件限制,三种波长下的光功率取值并不完全相同,但不同波长下的光强均涵盖了3 个数量级的变化,且得到的结论保持一致,即在器件发生光吸收的情况下,随着光照功率密度越大,正偏压下高阻态电流增加,器件的开关比减小.
3.5 光场和电场的双栅协控
从前面单独的电场、光场对器件性能调控的结果可知,栅压和光照都能有效调控器件的高阻态,从而在一定范围内调控器件的开关比.为了研究电栅和光栅协控对器件性能的影响,在500 nm 波长光照下,入射功率保持0.15 mW·cm-2时,对器件施加不同的栅压,得到的Id-Vds曲线如图10 所示.
由图10 可知,在500 nm 波长光照下施加栅压,对器件的阻变特性有明显的调控效果.在图10(a)中,随着负栅压的不断增加,器件的Id整体向上移动,这和图6(a)中暗条件下加负栅压的结果类似.当Vg=-25 V 时,沟道中的空穴浓度明显增加,加上外加光照的双重影响,正偏压下的HRS 电流有较大增加,导致器件的开关比下降.在图10(b)中,当外加正栅压时,Id-Vds曲线转化为单极性曲线,这个结果和图6(b)的结果类似,都显示出正栅压使曲线从双极性变为单极性.与图6(b)不同的是,在500 nm 波长光照下,此时器件从双极性转变为单极性所需要的最小栅压仅为5 V.同样,过高的正栅压会增加正偏压下的HRS 电流,引起器件的开关比下降.

图10 500 nm 波长光 照和电场同时调控下器件的阻变特性(a)负栅压Vg=-5-25 V 时的Id-Vds 曲线;(b)正栅压Vg=5-25 V 时的Id-Vds 曲线Fig.10.Resistance characteristics of electric and light dual-gate tunable memtransistor with illumination wavelength of 500 nm:(a) Id-Vds curves at negative gate voltages Vg=-5-25 V;(b)Id-Vds curves at positive gate voltages Vg=5-25 V.
将500,800 和1000 nm 光波长照射下,器件的高低阻态以及开关比随栅压的变化总结于图11.

图11 光场和电场的双栅协控下,Au/ReSe2/WSe2/Au 记忆晶体管特性(a)器件的高低阻态随栅压、波长的变化;(b)开关比随栅压、波长的变化Fig.11.Electric and light dual-gate tunable Au/ReSe2/WSe2/Au memtransistor:(a)The high and low resistance states of the devices under different gate voltages and different incident wavelengths;(b)on/off ratio of the devices under different gate voltages and different incident wavelengths.
从图11 可以看出,当入射波长为500 nm 时,沟道材料出现很强的光吸收,导致沟道内光生载流子浓度迅速升高,HRS 的电阻明显降低,器件开关比变小.并且,HRS 和LRS 受栅压的影响并不相同.LRS 主要受偏置电压Vds扫描范围的影响,对栅压不敏感,因此栅压变化过程中,LRS 基本保持不变.对于HRS,外加负栅压时,会从源端向沟道内注入大量的空穴,导致电阻值的下降,而正栅压下,源、漏电极处的肖特基势垒被抑制,同样带来电阻值的下降.因此,器件开关比从Vg=0 V 时的1.07×104降到Vg=-25 V 时的3.11×102和Vg=25 V 时的1.17×102.
当入射波长增加到1000 nm 时,由于ReSe2/WSe2材料对此波段光照基本不吸收,沟道内载流子浓度降低,开关比与暗条件下开关比接近,为4.91×105.在负栅压调控时,此时光照影响可忽略,栅压的增加引起沟道中载流子的注入,高阻态电阻降低到不足109Ω,开关比低至1.54×102.正栅压调控时,较高的栅压抑制了肖特基势垒,高阻态电阻降为109Ω,开关比降低到4.89×102.而对于800 nm 光照,高、低电阻和开关比变化趋势与500和1000 nm 结果基本一致,开关比变化范围为3.07×102-8.34×104,位于两者之间.
4 结论
本文通过微机械剥离法制备了ReSe2/WSe2双p 型记忆晶体管,并系统地研究了电学栅控、光学栅控和光电双栅协控下器件的阻变特性和阻变机制.暗条件下,该记忆晶体管可实现105的开关比、225 个循环周期以及1.9×104s 的保持时间,表明其拥有优异的循环稳定性和耐久性.而通过改变栅极电压、光照条件以及两者的组合,可实现可调开关比.与n 型记忆晶体管有明显区别的是: 负栅压将增加沟道中的空穴浓度,此时开关比变化不如加正栅压时变化明显.正栅压条件下,开关比变化范围为101-105;而负栅压下,开关比变化范围仅为103-105.同时,对比了不同光照和光功率密度对器件开关比的影响,发现器件在有光吸收的情况下,随着光照功率密度增加,HRS 电阻减小,器件的开关比降低.在电栅和光栅协同控制时,器件开关比的调制范围为102-105.阻态可调的ReSe2/WSe2记忆晶体管为模拟电路带来了新的发展方向,同时有实现高稳定性、高集成度的大规模集成忆阻器矩阵的潜力,在人工智能和类脑计算领域具有广阔的应用前景.
