衬底材料对石墨烯薄膜生长影响研究
2022-08-20蒋志伟樊瑞祥杨玉帅
刘 姗 ,王 伟 ,蒋志伟 ,樊瑞祥 ,杨玉帅 ,王 凯
(1.河北工业大学 电子信息工程学院,天津 300401;2.天津市电子材料与器件重点实验室,天津 300401)
在过去几十年间,随着现代电子设备对集成电路性能的需求不断提高,硅基电路特征尺寸已经步入10 nm级别[1]。然而,集成度的提高也带来了阈值电压降低、漏电流增大等一系列短沟道效应,严重影响器件寿命[2]。随着半导体器件尺寸不断地缩小,传统硅基电路的缺点逐渐暴露,寻找新型半导体材料是进一步推动集成电路发展的重要思路。石墨烯是碳原子以sp2杂化形成的二维蜂窝状材料[3],具有优异的电学性能以及散热性能[4-5],在室温条件下,Si 的电子迁移率仅为1350 cm2/(V·s)[6],而单层石墨烯薄膜的电子迁移率高达2×105cm2/(V·s)[6],以石墨烯代替硅作为CMOS 电路有源层能大幅度提高芯片运行速度。高K 介质是一种重要的薄膜材料,与传统SiO2介质层相比,高K 介质材料有更厚的等效物理厚度,在集成电路中能够完美替代SiO2[7]作为栅极材料,以高K 绝缘介质HfO2为衬底可直接应用于制备石墨烯场效应晶体管(GFET)半导体工艺中。因此,石墨烯薄膜原位生长优化对石墨烯器件的发展与应用具有重要意义。
当前,石墨烯薄膜的制备方法主要包括机械剥离法、SiC 热分解法、氧化还原法以及化学气相淀积法(CVD)[8]。其中,等离子体化学气相淀积(PECVD)作为一种特殊的化学气相淀积技术,利用了反应气体在射频电场下的辉光放电,能够大大降低沉积石墨烯薄膜时的温度,是低温无转移生长石墨烯薄膜的重要手段。在基于PECVD 技术沉积石墨烯薄膜制备的报道中,这些研究按照衬底材料分类可以分成两类。一类是以Ni、Cu、Co 为代表的金属衬底[9-12],另一类则是以Si 和SiO2为代表的绝缘衬底[13]。当前研究显示,金属衬底生长的石墨烯薄膜尺寸大、表面连续程度高,碳原子较难在绝缘衬底上形成连续的石墨烯薄膜[14]。然而,在金属衬底上生长的石墨烯薄膜还需转移才能进一步应用,这个过程不仅会增加石墨烯薄膜的缺陷度、降低薄膜质量,同时大大提高了石墨烯薄膜的制备工艺难度。探索碳原子在不同衬底上的沉积机理,对于直接在绝缘衬底尤其是高K 介质衬底上获得高质量石墨烯薄膜具有重要意义。
本文从薄膜材料表面能入手,探究碳原子在Ni、SiO2和HfO2衬底的成膜机理。利用电子束蒸镀技术,制备了高质量金属Ni 以及HfO2高K 介质薄膜,采用PECVD 法在低温条件下(450 ℃)分别以Ni、SiO2和HfO2薄膜为衬底制备石墨烯薄膜,分析总结了衬底材料性质对PECVD 法生长石墨烯薄膜的影响。
1 实验
1.1 实验材料
所使用的材料有:20 mm×20 mm 重掺杂精密单抛硅片(P<100>型,电阻率<100 Ω·cm,厚度(500±10)μm);10 mm×10 mm 重掺杂SiO2硅片(P <100 >型,SiO2厚度(100±10) nm);纯度为99.99%的Ni 与HfO2颗粒;无水乙醇;N2;Ar/CH4/H2气体。
1.2 实验过程
1.2.1 Ni、SiO2以及HfO2薄膜的获取
直接切割生长有SiO2薄膜的晶圆获取SiO2薄膜样品。采用电子束蒸镀法进行Ni 与HfO2薄膜的制备,设备结构图如图1 所示,真空电子束蒸镀法利用电子枪发射高能电子,在电场的作用下将电子束流携带的能量集中在蒸发源,短时间内局部的高温就能熔化并蒸发固体状态的靶材料,是一种典型的物理沉积技术。

图1 电子束蒸镀原理图Fig.1 Schematic diagram of electron beam evaporation
首先分割硅晶圆为面积为2 cm×2 cm 的样品,使用无水乙醇清洗Si 基片并使用N2烘干,待基片干燥后放入沉积室;然后对电子束蒸镀反应腔室进行超低真空处理,以降低污染源密度,使腔室内部真空度达到3×10-3Pa;最后,进行5 min 预热处理后正式蒸镀样品,其中Ni 薄膜制备过程中,将腔室压强维持在2×10-3Pa 左右,HfO2薄膜淀积过程中通过调节束流大小将内部压强维持在3×10-3Pa 左右。通过膜厚检测仪实时监测获取的薄膜厚度,分别在Si 基片上获取100 nm厚度的Ni 以及HfO2薄膜。
1.2.2 石墨烯薄膜的制备
采用PECVD 法在Ni、SiO2以及HfO2衬底上分别进行石墨烯薄膜的沉积,PECVD 利用了CH4/H2/Ar气体在射频电源作用下的辉光放电,不仅大大降低了石墨烯薄膜生长的温度,而且能够直接在衬底薄膜原位生长石墨烯薄膜。
PECVD 制备石墨烯薄膜的实验过程如下:(1)使用无水乙醇在超声振荡器中清洗Ni、SiO2以及HfO2薄膜,在N2气氛条件下干燥后放入样品室;(2)为降低腔室杂质粒子,提高薄膜质量,使用分子泵对样品室抽真空处理,直到真空度为5×10-4Pa;(3)射频清洗,预设衬底温度为450 ℃,并启动衬底温度加热开关,打开Ar 气路开关,控制反应室压强为110 Pa,设置射频电源功率为100 W,开启射频电源,进行3 min Ar放电以驱赶样品室内各种杂质,进一步提高样品室洁净度;(4)沉积石墨烯薄膜,关闭射频电源开关,待衬底达到实际预定值后,开启CH4和H2气路控制开关,设置衬底偏压为100 V,待反应腔室压强升至300 Pa 左右启动射频电源,开启衬底偏压,维持状态90 s后依次关闭衬底偏压、射频电源、衬底加热装置、CH4以及H2开关,等衬底温度降至室温后关闭Ar 气路开关,取出Ni、SiO2以及HfO2衬底密封处理以待后续测试。
1.3 样品表征
使用原子力显微镜(AFM 德国5600LS 型)表征Ni、SiO2、HfO2以及石墨烯薄膜表面形貌;采用表面均方根粗糙度(RMS)值Sq表征薄膜表面粗糙度;通过接触角测量仪(上海中晨JC2000DM)分析Ni、SiO2和HfO2薄膜表面能相对大小;利用阻抗分析仪(德国Novocontrol Concept40 型号)分析SiO2与HfO2绝缘衬底的介电性能;使用激光拉曼光谱仪(雷尼绍Invia Reflx)快速精准检测石墨烯成膜质量。
2 衬底薄膜的测试分析
2.1 表面形貌表征
使用原子力显微镜在1 μm×1 μm 范围内扫描Ni、SiO2以及HfO2薄膜表面3D 形貌如图2 所示,其中(a)为Si 衬底上金属Ni 薄膜的表面形貌,(b)为绝缘衬底SiO2形貌,(c)为高K 衬底HfO2薄膜形貌。AFM 测试结果显示,Ni 薄膜表面有较多均匀尖锐突起,而且其表面均方根粗糙度Sq值远高于HfO2薄膜,表明采用电子束蒸镀法制备的Ni 膜相较于HfO2薄膜的表面粗糙度更高。这是由于金属Ni 的熔点较低,生长速率快,而且Ni 更容易与Si 表面的悬挂键结合,在薄膜连续生长阶段岛状生长占优势,从而导致Ni 薄膜的表面粗糙度最高。

图2 衬底薄膜的AFM 图。(a) Ni 薄膜;(b) SiO2薄膜;(c) HfO2薄膜Fig.2 Substrate film AFM diagrams.(a) Ni film;(b) SiO2 film;(c) HfO2 film
2.2 绝缘衬底的电学性能测试
HfO2与SiO2相比有更高的介电常数,在相同厚度的条件下,使用HfO2材料代替SiO2作为晶体管栅极可以大大降低隧穿电流的大小,这一特点为进一步缩小集成电路尺寸提供了可能。设置阻抗分析仪扫描频率为1 MHz,扫描电压范围设置为-3~3 V 时,测量HfO2与SiO2薄膜的介电损耗角正切值以及电容大小,将薄膜化简平行板电容模型,利用测得电容值计算HfO2与SiO2薄膜的相对介电常数。测试显示,SiO2与HfO2薄膜的损耗角正切值均小于0.02,介电损耗小。图3 为SiO2与HfO2薄膜的相对介电常数与外加扫描电压的关系,经计算得到SiO2与HfO2薄膜的相对介电常数均值分别为3.41 和23.68,基于电子束蒸镀技术制备的HfO2薄膜的电学性能较接近理论值,而且HfO2薄膜的介电性能大大优于SiO2薄膜的介电性能。
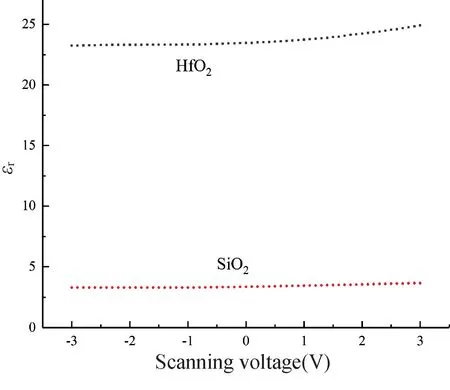
图3 SiO2与HfO2薄膜的相对介电常数Fig.3 Relative permittivity of SiO2 and HfO2 films
3 石墨烯薄膜分析与生长机理研究
3.1 石墨烯薄膜的分析
采用激光拉曼散射仪进行石墨烯薄膜表征,原子力显微镜用以进行石墨烯薄膜片层的辅助分析。图4(a)、(b)和(c)分别为Ni、SiO2以及HfO2衬底上石墨烯薄膜的拉曼光谱,Ni、SiO2和HfO2衬底上石墨烯薄膜的AFM 测试结果分别如图5(a)、(b)以及(c)所示。表1 为石墨烯薄膜的拉曼表征和AFM 数据。

图4 衬底温度450 ℃、偏压100 V、射频功率100 W 时石墨烯拉曼光谱。(a)Ni 衬底;(b)SiO2衬底;(c)HfO2衬底Fig.4 Raman spectra of graphene at 450 ℃with bias voltage of 100 V and RF power of 100 W.(a)Ni substrate;(b) SiO2 substrate;(c) HfO2 substrate

图5 石墨烯薄膜的AFM 表征。(a) Ni 衬底;(b) SiO2衬底;(c) HfO2衬底Fig.5 Graphene film AFM images.(a)Ni substrate;(b) SiO2 substrate;(c) HfO2 substrate

表1 石墨烯薄膜的拉曼表征和AFM 数据Tab.1 Raman peak intensity and AFM roughness of graphene film
在本实验工艺条件下,三种不同衬底上的石墨烯薄膜拉曼光谱测试数据均出现了明显的石墨烯特征峰G、G’ 峰,表明Ni、SiO2以及HfO2衬底上均沉积了石墨烯薄膜。其中Ni 衬底上石墨烯拉曼光谱G 峰峰形尖锐,其半峰宽为87 cm-1,拉曼光谱数据显示IG’/IG≈0.332,D 峰峰值远远小于G 峰峰值,而且AFM测试薄膜粗糙度Sq为1.20 nm,这与衬底粗糙度相差较大,表明较厚的石墨烯沉积在Ni 表面;SiO2衬底上石墨烯拉曼数据显示为尖锐的G 与G’ 峰,D 峰峰值强度较低,说明石墨烯薄膜中碳原子sp2杂化占优势,结合AFM 测试开展石墨烯沉积实验后的SiO2薄膜Sq大小为0.558 nm,表明SiO2衬底上制备的石墨烯薄膜缺陷低,形貌较为平坦;在HfO2衬底上沉积的石墨烯拉曼测试显示有尖锐的G 峰,G 峰半峰宽约为103 cm-1,其IG’/IG≈0.403,D 峰与G 峰的峰强之比约为0.840,说明石墨烯薄膜的边缘较多,而且,AFM 形貌图像显示石墨烯薄膜平坦度高,表明在此条件下生长了小面积的多层石墨烯。在PECVD 法制备石墨烯薄膜的实验中,通过分析石墨烯拉曼数据和AFM 形貌数据可知Ni、SiO2以及HfO2衬底均获取了质量较高的石墨烯薄膜。但在相同实验条件下,碳原子在Ni 衬底上沉积的石墨烯薄膜最厚,石墨烯薄膜在Ni 衬底的质量低于SiO2以及HfO2衬底。
3.2 石墨烯薄膜生长机理
图6(a)、(b)、(c)分别为Ni、HfO2和SiO2薄膜与水滴的接触角成像。其中Ni 与水的接触角最小,HfO2次之,SiO2薄膜与水滴的接触角最大,这表明Ni表面有较多的悬挂键,对水分子有较强的吸引力,表现为较强的亲水性能;SiO2薄膜的亲水性最低,表面能较小;HfO2的表面能则位于其他两种材料之间。

图6 衬底薄膜与水滴的接触角。(a) Ni 薄膜;(b) HfO2薄膜;(c) SiO2薄膜Fig.6 The contact angle between film and the water drops.(a) Ni film;(b) HfO2 film;(c) SiO2 film
结合三种衬底材料接触角测试结果,可以得到不同衬底材料上石墨烯两种不同的生长机理。碳原子在金属Ni 衬底形成石墨烯薄膜的生长机理如图7(a)所示,在衬底加热为450 ℃的实验条件下,Ni 对碳原子有一定的溶解能力,碳原子通过Ni 表层扩散进入衬底内部,实验完成后关闭衬底加热开关,在衬底温度逐渐降至室温的过程中,扩散进入衬底内部的碳原子会析出表面进而形成连续石墨烯薄膜,在Ni 衬底上,碳原子以溶解-析出的方式成膜,这种石墨烯薄膜的生长模式与碳原子在900 ℃成膜理论一致[15]。以SiO2、HfO2为代表的绝缘衬底石墨烯生长原理如图7(b)所示,碳原子不易扩散进入绝缘衬底内部,因此在SiO2、HfO2衬底上,依靠碳原子的直接淀积生成连续石墨烯薄膜。接触角测试表明HfO2薄膜有更高的表面能,在石墨烯生长过程中,较强的表面能抑制了薄膜生长过程中碳原子沿衬底的迁移,因此在HfO2表面上较难获取大面积的石墨烯薄膜。降低HfO2薄膜的表面能将有助于采用PECVD 法制备大面积石墨烯。

图7 石墨烯生长机理。(a) 金属Ni 衬底;(b) 绝缘衬底Fig.7 Growth mechanism of graphene film.(a) Metallic Ni substrate;(b) Insulating substrate
4 结论
本文研究了衬底材料对PECVD 法淀积石墨烯薄膜的影响,探究了在不同衬底材料表面碳原子沉积机理。首先采用电子束蒸镀法在硅基板上分别制备了100 nm 厚的Ni 以及HfO2薄膜,然后在450 ℃温度下,采用等离子体增强化学气相淀积法在Ni、HfO2以及SiO2衬底上均成功制备了石墨烯薄膜。最后对Ni、HfO2和SiO2薄膜的表面能以及石墨烯薄膜质量进行了测试分析。拉曼测试与AFM 数据表明,在相同实验条件下,石墨烯薄膜在Ni 衬底上沉积最厚,同时缺陷密度最高;在SiO2衬底获取了覆盖率较低、缺陷较少的石墨烯薄膜;高K 介质材料HfO2薄膜碳原子覆盖率最低,石墨烯较难直接在高K 介质上生长。测试了三种衬底与水滴的接触角,分析了Ni、SiO2与HfO2衬底表面能的差异,并得出碳原子以高温吸附-低温析出方式在Ni 衬底上形成连续石墨烯薄膜,在绝缘衬底上,碳原子则以直接沉积方式生长为石墨烯薄膜,高表面能抑制碳原子在绝缘衬底的横向迁移,因此,碳原子较难在HfO2衬底生长,HfO2衬底表面石墨烯薄膜的覆盖率较低。本研究表明,采用PECVD 法直接在HfO2衬底上获取大面积沉积石墨烯薄膜的关键在于降低HfO2薄膜的表面能,促进碳原子沿衬底的横向迁移。
