HEMT器件电磁脉冲毁伤机理仿真分析及试验研究
2020-07-16安宁柴常春刘彧千
安宁 柴常春 刘彧千
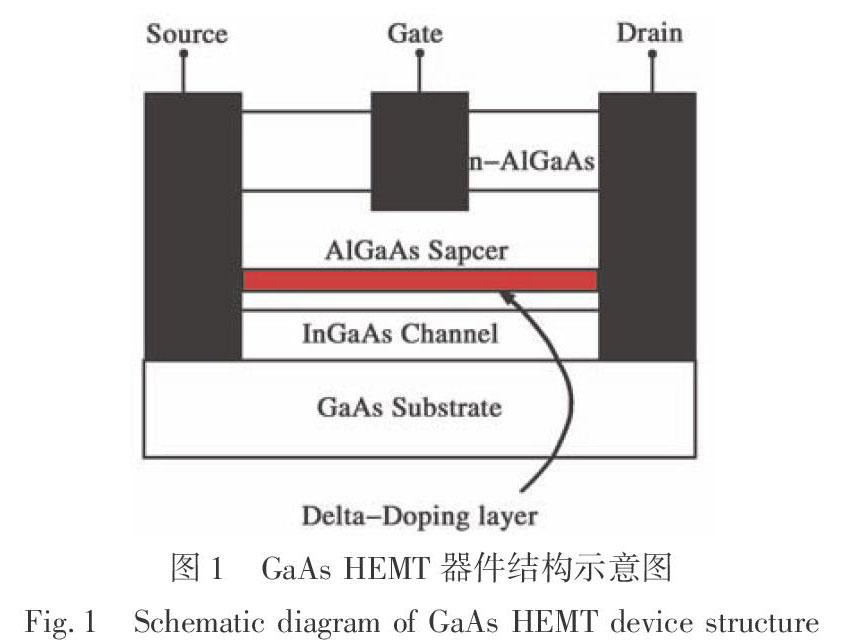
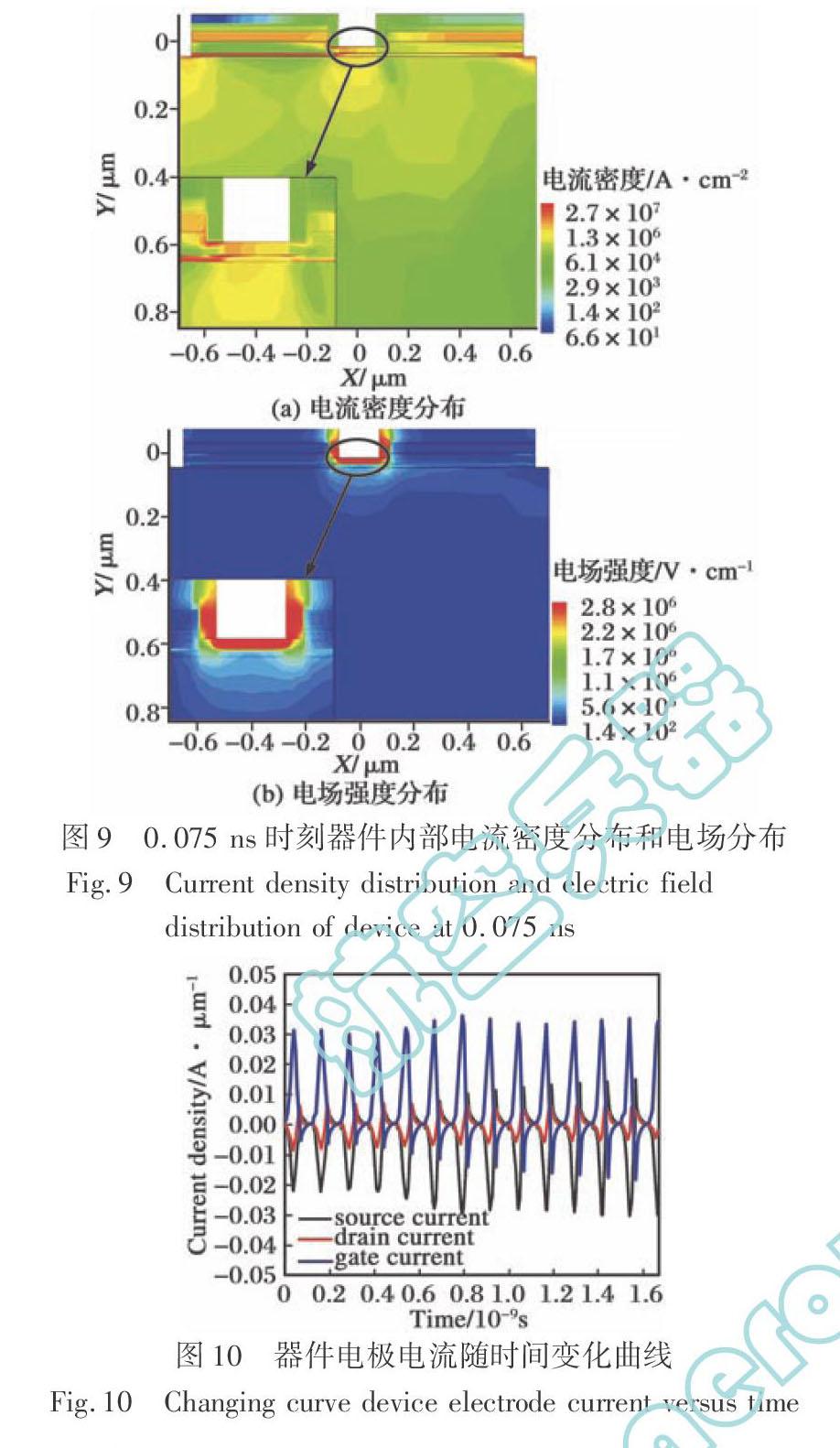

摘 要:以强电磁脉冲为典型代表的复杂电磁环境对雷达前端关键模块与器件的可靠性不断构成威胁。本文对雷达前端电路中低噪声放大器的关键器件——GaAs HEMT进行了强电磁脉冲效应仿真研究与试验验证。利用仿真软件构建了GaAs HEMT的二维热电模型,并对器件栅极注入强电磁脉冲的情况进行了仿真,研究发现,该注入条件下器件内部峰值温度呈现周期性的上升-下降-上升-下降趋势,最终达到GaAs的熔点温度, 导致器件烧毁,烧毁位置在栅极下方偏向源极的位置。通过对低噪声放大器芯片进行注入实验和剖片分析,在TEM显微镜下观察到GaAs HEMT器件栅极下方靠近源极的区域有明显烧毁,与仿真结果相符。通过对仿真数据的处理和拟合,总结了器件烧毁功率阈值和能量阈值与注入微波脉宽的关系,得出器件烧毁的功率阈值随着脉宽的增大而减小,能量阈值随着脉宽的增大而增大,与经验公式相符。
关键词: 低噪声放大器;强电磁脉冲;HEMT器件;功率阈值;能量阈值; 电磁毁伤
中图分类号:TJ95; TN959.73 文献标识码:A 文章编号:1673-5048(2020)03-0088-05
0 引言
毫米波低噪声放大器芯片应用于毫米波雷达的前端电路中,对经过的高频小信号起到放大作用,通常前端电路直接与外部天线相连,因此更容易受到强电磁脉冲的干扰与打击。GaAs HEMT器件由于技术成熟、成本较低,同时又有着较好的低噪声放大性能,所以被广泛用于毫米波低噪声放大器芯片中。在强电磁脉冲的干扰下[1],如果GaAs HEMT器件发生毁伤,会导致整个雷达前端电路的功能发生退化。
近年来,针对不同类型半导体器件的电磁脉冲毁伤效应研究已受到广泛的关注。对于双极型晶体管,文献[2-5]分别针对器件基极、集电极、发射极的强电磁脉冲的损伤机制以及对于功率频率等不同脉冲参数对器件损伤的影响进行了一系列的理论分析、效应仿真和实验研究。同时,文献 [6-10]对数字集成电路中CMOS器件的强电磁脉冲的损伤效应、闩锁效应以及强电磁脉冲注入下产生的位翻转和特性退化,以及功率脉宽等因素对于器件损伤效应的影响进行了研究。
本文研究了强电磁脉冲注入下GaAs器件的损伤效应及机理[11-12],通过Sentaurus-TCAD仿真软件建立了典型GaAs HEMT的二维热电模型,并将强电磁脉冲以正弦信号的形式注入器件的栅极,通过对器件内部电场强度、电流密度和温度随时间的变化情况进行分析,得到了HEMT器件的损伤机理。 将仿真结果与TEM下观察到的实际剖片结果进行对比,得到良好的一致性。最后,通过对数据的处理和拟合,分别得到了器件在电磁脉冲注入下,毁伤功率阈值和能量阈值与脉冲脉宽之间的关系。
1 器件模型建立
1.1 器件结构模型
典型GaAs pHEMT结构如图1所示,包括:半绝缘GaAs衬底;InGaAs沟道;Delta掺杂区,可以让量子阱更深,二维电子气浓度更高;i-AlGaAs层,减少电离杂质对二维电子气的影响;n-AlGaAs层,为InGaAs沟道中的二維电子气提供电子;中间及两端顶部深色区域为金属电极。
利用半导体仿真软件Sentaurus-TCAD建立了与图1结构相同的0.15 μm HEMT器件结构图,如图2所示。器件竖直方向的尺寸从上到下分别为50 nm Si3N4钝化层,30 nm GaAs 帽层,34.5 nm AlGaAs阻挡层,10 nm InGaAs沟道。横向的尺寸分别为0.05 μm的源极(漏极和源极为左右对称结构), 0.15 μm的栅极。器件的掺杂从图2中可以看出。
1.2 器件物理模型
Sentaurus-TCAD仿真软件通过数值迭代求解泊松方程、电流连续性方程和热载流子方程来模拟计算器件内部微观结构的电、热学特性。在强电磁脉冲的注入下,器件内部的温度会发生剧烈变化,因此,需要在一般载流子输运方程上再考虑温度对电流密度的影响:
式中: Jn,Jp分别为电子和空穴的电流密度;n,p分别为电子和空穴的密度;μn,μp分别为电子和空穴的迁移率;Pn,Pp分别为电子和空穴的绝对热电功率;Фn,Фp分别为电子和空穴的准费米能级;q为电子的电量;T为温度。
由于器件会产生自热效应,为了求解器件内部的温度分布情况,还需要考虑热传导方程[13]:
式中: c为晶格热熔;k为热导率;EC,EV分别为导带底和价带顶的能量;kB为玻尔兹曼常数;R为复合率。
1.3 器件直流特性
为了验证仿真模型可以正常工作,分别对器件的开启特性曲线和输出特性曲线进行了仿真。
漏极电压为恒定2.5 V时,对器件进行开启特性的仿真,如图3所示。
从图3中可以看出,器件为典型的耗尽型HEMT器件,对器件的开启特性曲线进行反向延长,与横轴的交点可以得到器件的开启电压Vgsoff约为-1.4 V。
对器件的输出特性曲线进行仿真如图4所示。图中给出了栅压-0.8~0.8 V步长为0.4 V的5种不同栅压下的器件输出特性曲线,从图中的标注可以看出,当器件工作在Vgs=0 V,Vds=2 V时,器件的工作电流约为0.7 μA。
2 器件强电磁脉冲效应机理分析
仿真电路如图5所示。由图中可以看出,器件漏极接2 V的正电压,栅极处于零偏状态。在仿真条件上,设置器件的衬底为理想热沉,初始仿真温度设置为室温(300 K)。由于器件内部主要由GaAs组成,所以设置当
器件内部峰值温度达到GaAs的熔点1 511 K时,认为此时器件已经烧毁。
图6为在栅极注入正弦电压幅值为17 V,频率为10 GHz时器件内部的峰值温度随着时间变化的响应情况。由图中可以看出,器件内部的峰值温度呈现出周期性变化的升高-降低-升高-降低情况。
图7为器件烧毁时器件内部的峰值温度在器件内部的分布图像, 从图中可以看出,器件的峰值温度出现在栅极下方,并且呈现出靠近源极的趋势,此时可以判断器件最容易烧毁的位置为栅极下方靠近源极的部分。
器件内部热量的产生可以由下式给出:J=Q×E(4)
式中: Q为器件内部电流密度;E为器件内部电场强度。为了进一步得到器件在电磁脉冲作用下的烧毁机理,通过观察在不同时刻器件内部物理量(主要是电流密度和电场强度)的变化来进行分析和解释。
以第一个周期为例进行分析,图8~9分别为0.025 ns(此时注入信号为正半周期峰值)和0.075 ns(此时注入信号为负半周期峰值)时刻的器件内部电流密度和电场强度分布图像。当信号开始注入时,肖特基结正偏,器件处于放大状态,随着信号电压的增大,由于曲率效应栅极下方靠近源漏端分别出现局部电场极大值。栅源电势差相较于栅漏电势差更大,因此栅极下方靠近源极的地方先出现从栅极到2DEG的导电沟道。随着栅极电压的增大,栅极下方靠近源极的局部区域先达到了雪崩击穿的临界场强(1.75×105 V/cm,从图8(b)中可以看到,电场强度已经远超过这个数量级),随着栅极电压的进一步增大,栅极下方靠近漏极的位置也达到了雪崩临界击穿电场,此时,源极(漏极)电流反转成为反向电流。此时,由图8(a)可以看出,大量载流子从栅极流向沟道,栅电流通过2DEG沟道分别流向源极和漏极;负半周期时,肖特基结反偏,栅极下方势垒层中的耗尽区已经向下扩展到了GaAs衬底,导致AlGaAs沟道中栅极正下方部分的电子被耗尽,器件处于截至状态,HEMT二维电子气导电沟道夹断,电压主要降落在肖特基结上,由于曲率效应导致电场超过雪崩临界击穿场强(由图9(b)可以看出,此时的场强也远大于临界击穿场强),因此雪崩击穿产生大量的载流子在强电场作用下流向源极和漏极,由于部分载流子被耗尽,导致反向的电流值低于正向时的电流值,在图9(a)中还可以看到,栅极到源极的电流要大于漏极电流,这是由于漏极接了恒
定直流源,而源极处于接地状态。此时,电场峰值仍位于栅极下方靠近源漏电极处,由于载波频率高,正半周期雪崩产生的电子无法及时输运,导致电子密度高于其他位置电子密度,因此,电场峰值更高。在高电场和强电流的作用下,正负半周期均产生大量的热量,由于频率很高,这种热量无法及时扩散,器件的温度产生积累,达到GaAs材料的烧毁温度,器件发生烧毁。
器件三个电极电流密度随时间变化曲线如图10所示。根据之前的分析,在电磁脉冲的作用下,电流在正半周期主要由栅极流向源极和漏极,负半周期主要由漏极和源极流向栅极。由于负半周期部分载流子被耗尽,所以电流值会低于正半周期。从图中可以看出,器件的栅极电流在正半周期呈现正值,在负半周期呈现负值,并且正半周期极大值的绝对值大于负半周期的极大值的绝对值,与之前的分析相符。图中还可以看出器件的源极电流大于器件的漏极電流,这也证明了靠近源极一侧更容易受到损伤。
3 试验对比
针对某型低噪声放大器芯片进行高功率微波毁伤试验,在注入功率超过30 dBm时,芯片输出端难以观测到稳定的输出波形,认为此时低噪声放大芯片已经毁伤。
对毁伤样品进行扫描电子显微镜观察,其中,第一级芯片可以看到明显的异常形貌,放大观察如图11所示,可以看到栅极金属条存在明显的过热烧毁情况,且在栅极下方存在明显的烧毁形貌,源极一侧的熔坑明显大于漏极一侧,与仿真结果一致。
4 HEMT器件强电磁脉冲脉宽效应分析
Wunsch、Bell[14]和Tasca[15]等人通过实验研究得到了单脉冲信号作用下PN结损伤的功率P、能量E与脉宽之间的经验公式:
P=c1τ-1(5)
E=c2τ0(6)
式中: P和E分别为电磁脉冲烧毁功率和烧毁能量;c1,c2为常数;τ为脉冲宽度,即注入信号在器件烧毁之前的持续时间。
通过对仿真数据的处理和一定的数据拟合工作,得出图12所示的栅极注入强电磁脉冲信号时,损伤能量阈值、损伤功率阈值与脉宽的关系表达式为
P=0.64τ-0.4(7)
E=0.13τ0.51(8)
可以看到,拟合出的表达式与PN结损伤的经验表达式基本相符,表明半导体器件在受到脉冲信号的影响下,具有相似的规律,并且拟合出的表达式分别具有0.97和0.98的相关系数。表明拟合结果具有一定可信度。
综合仿真结果可以看出,电磁脉冲的脉宽越长,毁伤HEMT器件所需要的功率阈值越低,但同时,所需要的能量阈值也越高。
5 结 论
本文研究了毫米波低噪声放大器关键器件的电磁脉冲效应,利用Sentaurus-TCAD仿真软件建立了0.15 μm的GaAs HEMT器件的二维热电仿真模型,分析得到了器件在强电磁脉冲的注入条件下的损伤机理,观察并解释了器件温度在脉冲周期性干扰下的“升高-降低-升高-降低”趋势,以及最终器件栅极下方靠近源极的部分会发生烧毁的现象。同时,利用实际实验样品剖片在TEM下的实际形貌,观察验证了上述仿真结果。最后,通过数据处理和拟合得出器件的烧毁功率阈值随着脉宽的增大而减小,能量阈值则会随着脉宽的增大而减小的结论,得到相关经验公式,对后续相关研究有一定启发。
参考文献:
[1] 赵鸿燕. 国外高功率微波武器发展研究[J].
航空兵器, 2018 (5): 21-28.
Zhao Hongyan. Research on Overseas High Power Microwave Weapon Development[J]. Aero Weaponry, 2018 (5): 21-28.(in Chinese)
[2] You Hailong, Fan Juping, Jia Xinzhang, et al. Experimental Research on the Damage Effect of HPM on Semiconductor Bipolar Transistor[C]∥ IEEE International Conference on Solid-State & Integrated Circuit Technology,Shanghai, China, 2010.
[3] Ma Zhenyang, Chai Changchun, Ren Xingrong, et al. Microwave Damage Susceptibility Trend of a Bipolar Transistor as a Function of Frequency[J]. Chinese Physics B, 2012, 21(9): 098502.
[4] Fan Juping, Zhang Ling, Jia Xinzhang. HPM Damage Mechanism on Bipolar Transistors[J]. High Power Laser and Particle Beams, 2010, 22(6): 1319-1322.
[5] Ren Xingrong, Chai Changchun, Ma Zhenyang, et al. The Damage Effect and Mechanism of Bipolar Transistors Induced by Injection of Electromagnetic Pulse from the Base[J]. Acta Physica Sinica, 2013,62(6):068501.
[6] Kim K, Iliadis A A, Granatstein V L. Study of the Effects of Microwave Interference on MOSFET Devices in CMOS Integrated Circuits[C]∥International Semiconductor Device Research Symposium, Washington, D C, USA, 2003.
[7] Holloway M A, Dilli Z, Seekhao N, et al. Study of Basic Effects of HPM Pulses in Digital CMOS Integrated Circuit Inputs[J]. IEEETransactions on Electromagnetic Compatibility, 2012, 54(5): 1017-1027.
[8] Zhang Yuhang, Chai Changchun, Liu Yang, et al. Modeling and Understanding of the Thermal Failure Induced by High Power Microwave in CMOS Inverter[J]. Chinese Physics B, 2017, 26(5): 058502.
[9] Liu Yuqian, Chai Changchun, Zhang Yuhang, et al. Physics-Based Analysis and Simulation Model of Electromagnetic Interference Induced Soft Logic Upset in CMOS Inverter[J]. Chinese Physics B, 2018, 27(6): 068505.
[10] Zhang Yuhang, Chai Changchun, Yu Xinhai, et al. Investigation on Latch-Up Susceptibility Induced by High-Power Microwave in Complementary Metal-Oxide-Semiconductor Inverter[J]. Chinese Physics B, 2017, 26(2): 492-498.
[11] Yang Cheng, Liu Peiguo, Huang Xianjun.A Novel Method of Energy Selective Surface for Adaptive HPM/EMP Protection[J]. IEEE Antennas and Wireless Propagation Letters, 2013, 12(1): 112-115.
[12] Zhou Liang,Yin Wenyan,Zhou Weifeng, et al. Experimental Investigation and Analysis of the LDMOS FET Breakdown under HPM Pulses[J]. IEEE Transactions on Electromagnetic Compatibility, 2013, 55(5):909-916.
[13] ISE-TCAD Dessis Simulation Users Manual[M]. Zurich: Integrated Systems Engineering Corporation, 2004.
[14] Wunsch D C,Bell R R. Determination of Threshold Failure Levels of Semiconductor Diodes and Transistors Due to Pulse Voltages[J]. IEEE Transactions on Nuclear Science, 1968, 15(6): 244-259.
[15] Tasca D M. Pulse Power Failure Modes in Semiconductors[J]. IEEE Transactions on Nuclear Science, 1970, 17(6): 364-372.
Simulation and Experimental Study on Damage Mechanism of
Electromagnetic PulseofHEMT Device
An Ning1*,Chai Changchun2,Liu Yuqian2
(1. China Airborne Missile Academy,Luoyang 471009, China;2. Xidian University,Xian 710126, China)
Abstract: The complex electromagnetic environment represented by electromagnetic pulses is a constant threat to the reliability of key modules and devices in the radar front end. In this paper, the simulation and experimental verification of the strong electromagnetic pulse effect are performed for the GaAs HEMT, which is a key component of the low-noise amplifier in the radar front-end circuit. The two-dimensional thermoelectric model of GaAs HEMT is constructed by using simulation software, and the injection of electromagnetic pulse to the gate of the device is simulated. It is found that the peak temperature inside the device exhibits a periodic rise-fall-rise-fall trend under the injection condition, and the final temperature will reach the melting point of GaAs, leading to burnout, which is locatedbelow the gateclosed to the source. Through the injection experiment and the slice analysis of the low-noise amplifier chip, it is observed that the area near the source of the gate of the GaAs HEMT device is burnt
under the TEM microscope, which is in good agreement with the simulation results. Through the processing and fitting of the simulation data, the relationship between burnout power threshold and injection microwave pulse width and the relationship between burnout energy threshold and injection microwave pulse width are analyzed. It can be concluded that the power threshold of the device burnout decreases with the increase of the pulse width, and the energy threshold increases with increasing pulse width,which is consistent with empirical formulas.
Key words: low noise amplifier; electromagnetic pulse; HEMT device; power threshold; energy threshold; electromagnetic damage
收稿日期: 2019-09-14
基金項目: 航空科学基金项目(2018ZC12006)
作者简介: 安宁(1985-),女,河南洛阳人,高级工程师,硕士,研究方向是高功率微波技术。
E-mail: guoguo6522@163.com
引用格式: 安宁,柴常春,刘彧千.HEMT器件电磁脉冲毁伤机理仿真分析及试验研究
[ J].
航空兵器,2020,27( 3): 88-92.
An Ning,Chai Changchun,Liu Yuqian. Simulation and Experimental Study on Damage Mechanism of Electromagnetic PulseofHEMT Device[ J]. Aero Weaponry, 2020, 27( 3): 88-92.( in Chinese)
