偏转角(211)Si基CdTe复合衬底研究
2018-08-08王经纬周立庆
王 丛,高 达,王经纬,强 宇,周立庆
(华北光电技术研究所,北京 100015)
1 引 言
HgCdTe材料是性能优异的红外探测器材料,但由于早期CdZnTe衬底成本高、面积较小、与Si电路热膨胀系数不匹配等原因,长期以来研究者一直寻找合适的替代衬底。早期人们对InSb、Al2O3(蓝宝石)、GaAs、Ge和Si基等替代衬底进行了大量的研究,但随着研究的开展,InSb、Al2O3等衬底的各种缺点就显漏无遗。与其他衬底材料相比,Si衬底具有衬底面积大、材料成本低、Si读出电路的自动热应力匹配、较高的机械强度和平整度等优点,是最合适的替代衬底,是未来实现单片式IRFPA的唯一选择[1-3]。
Si基衬底最大的问题在于与CdTe晶格失配达19.3%,导致外延层晶向控制、高密度位错的抑制等问题变得十分困难。众所周知,衬底与外延材料的晶格失配将导致大量的位错增殖,进而严重影响红外焦平面器件的性能。所以Si基CdTe复合衬底制备急需解决大失配条件下的外延生长技术。针对Si基外延的大失配条件解决方案一般有:缓冲层、Si片晶向偏角、退火等[4-7]。
S.Rujirawat等人的研究发现[7],Si(211)基外延CdTe(211)衬底材料的过程中,大约外延温度在250 ℃时,出现CdTe(211)和CdTe(133)孪晶,经过测试Cd(133)几乎平行于Si(211),CdTe(211)则同Si(211)存在2~ 3°的倾角。De Lyon T J等[8]研究了CdTe(112)外延层与Si(112)衬底朝[111]方向倾角的关系,得到经验公式:φCdTe=0.957×φSi-2.02°。国内的王元樟等[9]对Si基和GaAs基衬底上材料外延偏转的问题做了研究,发现对于Si和GaAs衬底,外延层的[211]均绕外延层与衬底的[0-11]复合轴朝[111]倾斜,其晶向倾角与晶格失配呈线性关系。
本文在前人研究的基础上,结合本课题组的研究现状选取了三个偏转角度进行研究,在偏转角衬底上的材料外延获得一定成果。
2 实 验
本研究使用芬兰DCA公司的P600 MBE外延系统。使用3 in带偏转角的(211)Si晶片进行衬底外延,Si片偏转角由(211)晶面向[111]方向偏转2°、3°、4°。Si片经过RCA湿化学处理后,装入MBE系统[10-11]。
Si片衬底在MBE系统中经过预加热处理,清除表面水气和杂质,进入生长室。Si片表面的氧化层在生长室内采用高温脱氧法进行去除,待Si片冷却至生长温度进行外延生长。采用纯度为7N的Zn,Te,CdTe,As材料作为外延衬底原料。在Si片冷却过程中,首先使用As4束流对Si片表面进行钝化[12],然后使用Te束流钝化Si片表面,确保材料的B面生长。
使用的标准外延过程是,首先使用MEE方法在Si片表面线外延一层ZnTe缓冲层,温度330 ℃,然后在Te束流的保护下进行420 ℃退火处理。接着在ZnTe缓冲层上进行CdTe外延,温度330 ℃,在Te束流和CdTe束流的保护下进行450 ℃退火处理。
通过在线高能电子衍射仪(RHEED)对Si基CdTe复合衬底的生长进行了在线监控。外延后的复合衬底材料晶体质量通过高分辨X光衍射仪进行测试表征,CdTe膜层厚度使用红外傅里叶仪进行测试计算,表面粗糙度使用光学轮廓仪进行测试表征,表面形貌通过金相显微镜进行观察。
3 分析与讨论
衬底的外延工艺见前文所述。偏转角(211)Si基CdTe复合衬底外延采用标准的外延工艺方法并对外延参数进行了实验。#1437、#1440、#1441、#1464分别采用2°、3°、4°和标准(211)Si片进行标准生长。
针对3°Si片做了优化实验:#1463、#1465、#1467、#1466,工艺调整实验条件如表1所示,向下的箭头表示相较于标准工艺降低参数值,空白为无改变。

表1 样品外延条件
3.1 表面形貌
从图1中可以看出,偏转角(211)Si基CdTe复合衬底的表面形貌与标准Si基CdTe复合衬底存在差距。突出表现为,偏转角(211)Si基CdTe复合衬底表面粗糙,肉眼观察明显泛白,表面形貌麻点状起伏明显。这是偏转角Si基CdTe复合衬底外延参数不优化所致,影响形貌的主要参数为ZnTe缓冲层和CdTe衬底层的外延温度和退火温度过高。外延温度过高易在外延时候形成3维岛状生长,而退火温度过高造成表面脱附严重,这两者都可以造成粗糙的表面形貌。
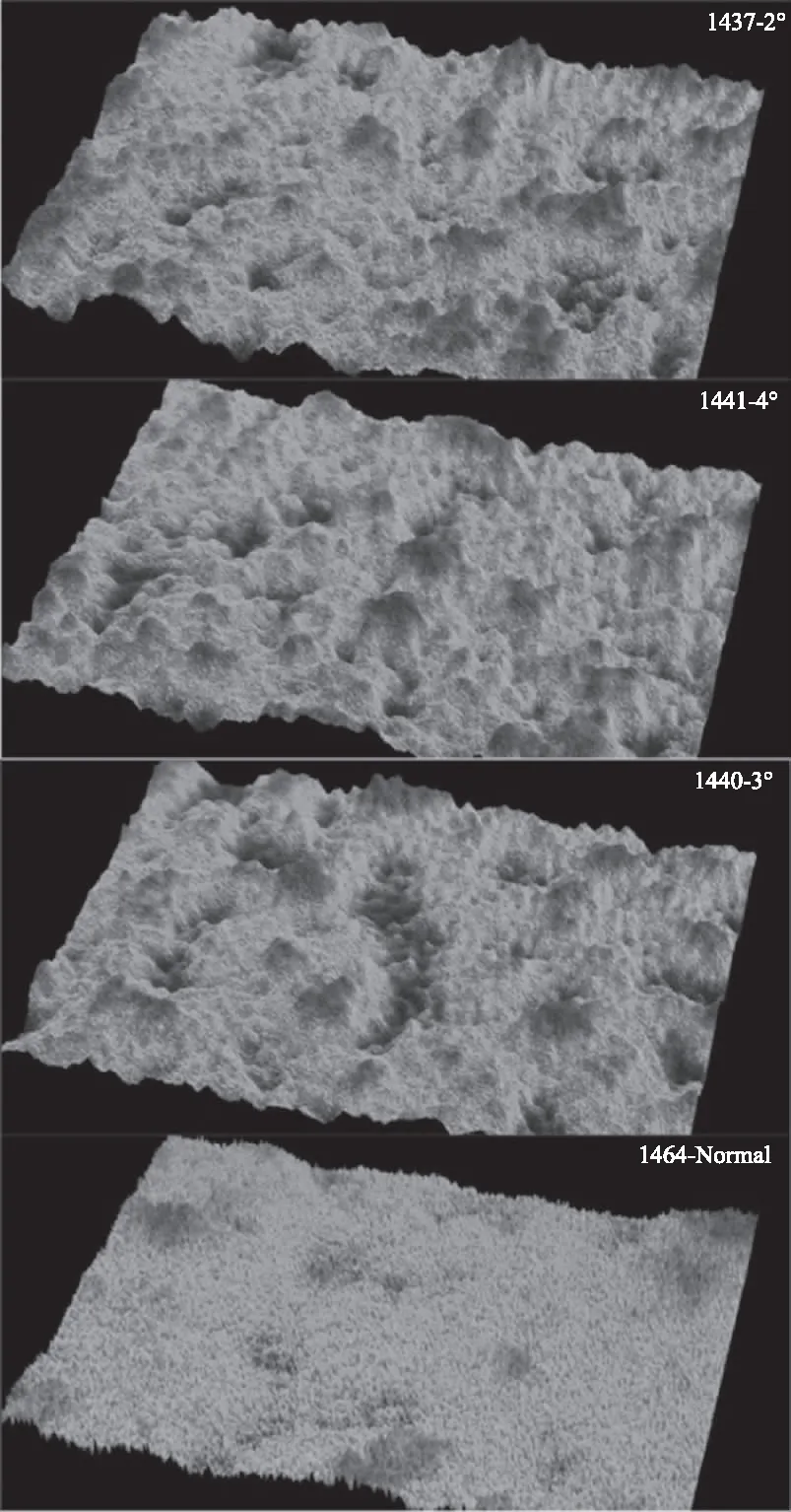
图1 样品光学轮廓仪表面形貌3D模拟图
针对3°偏转角的(211)Si基CdTe复合衬底做外延参数优化实验,并对外延后的复合衬底粗糙度进行了研究,根据光学轮廓仪的测试结果(见图2),标准工艺中,2°和3°样品的粗糙度相当,4°样品高于前两者的粗糙度,表现出明显的差异,且三者的粗糙度都远高于标准样品。工艺调整的样品粗糙度依次降低。从工艺参数方面讲,较低的外延和退火温度有利于降低材料的粗糙度。对比#1463与#1465,外延温度存在优化范围,过度降低外延温度并不能有效地降低粗糙度;而在通过对#1465,#1467和#1466三个样品的参数对比中发现,通过有效地降低ZnTe和CdTe层的退火温度可以降低复合衬底材料的粗糙度。目前的工艺结果与标准的Si基CdTe复合衬底(#1464)在粗糙度参数上还有一定差距。

图2 样品光学轮廓仪粗糙度测试结果
3.2 FWHM
外延的偏转角Si基CdTe复合衬底FWHM值与标准衬底常规FWHM值对比见图3。图3显示2°和3°偏转角的Si基CdTe复合衬底在FWHM值优于标准Si基CdTe复合衬底的结果,平均降低2~3 arcsec,这表明偏转角(211)Si基CdTe复合衬底可以良好的降低衬底的FWHM参数,提高衬底材料的晶体质量。且3°偏转角的(211)Si基CdTe复合衬底在6~9 μm厚度范围内与FWHM值有良好的线性关系,可以通过提高材料的膜厚降低材料的FWHM值,进而达到提高材料晶体质量的目的。而通过多次试验我们发现4°的样品的FWHM值与标准Si基样品存在较大差距,材料晶体质量不高。这与T.J.de Lyon[8]等人的研究结果相符合。
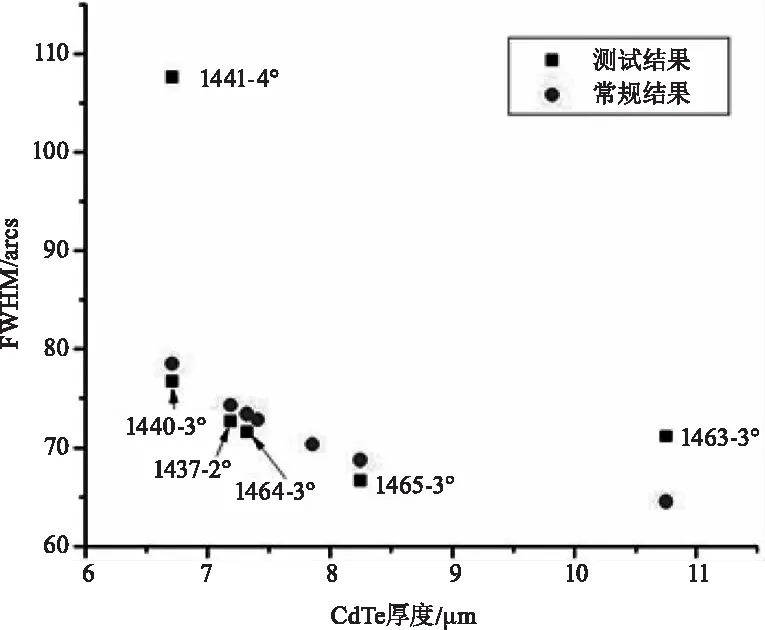
图3 样品FWHM测试结果与标准结果对比
综合上述测试结果,4°偏转角的(211)Si基CdTe复合衬底表面形貌和晶体质量不佳,说明在现有的工艺条件下,4°的偏转角度不利于外延质量的提高。2°和3°的偏转角Si基CdTe复合衬底在晶体质量方面表现出优于标准Si基CdTe复合衬底的特性,虽然在表面形貌和粗糙度方面与标准衬底还有差距,但是通过工艺参数的调节可以得到有效的优化,是未来提高Si基CdTe复合衬底的质量的发展方向。
4 结 论
通过本文的研究,在偏转角Si基CdTe复合衬底外延工艺方面发现,4°偏转角Si片角度偏转过大,不利于复合衬底性能的提高。2°和3°偏转角Si基衬底在晶体质量方面优于标准的Si基CdTe复合衬底,通过工艺参数的优化在表面形貌和粗糙度方面还可以得到提高,相信是未来提高Si基CdTe复合衬底质量的又一发展方向。
