粗糙GaAs(001)表面对In0.15Ga0.85As薄膜生长的影响
2018-04-08杨晓珊罗子江许筱晓张之桓
杨晓珊,郭 祥,罗子江,王 一,杨 晨,许筱晓,张之桓,丁 召
(1.贵州大学 大数据与信息工程学院,贵州 贵阳 550025;2.贵州财经大学 信息学院,贵州 贵阳 550004)
III/V族半导体材料因具有优异的光电特性,在太阳能电池、红外探测器和新型激光器[1-3]等领域受到广泛的研究。为了不断提高半导体材料光电子器件的性能,深入地掌握薄膜的生长机理和更好地控制其生长工艺,成为当前研究的难点和重点。InGaAs作为一种重要的化合物半导体材料,因其具有高迁移率,高吸收系数等特点,已成为制备和研究高频、高速微电子器件等的首选材料[4]。GaAs作为一种典型的闪锌矿型化合物半导体,常被用作InGaAs薄膜生长的衬底,其表面形貌在InGaAs薄膜生长的过程中扮演着重要作用[5]。目前,国内外对InGaAs/GaAs薄膜的研究主要集中于自组装量子点的生长[6-8],而GaAs衬底表面形貌对InGaAs薄膜生长的影响研究较少。
V.P.LaBella[9]等人曾采用分子束外延(Molecular Beam Epitaxy,MBE)生长和反射高能电子衍射仪(Reflection High Energy Electron Diffraction,RHEED)实时监测,对GaAs(001)表面结构进行了深入研究,得到了在不同的衬底温度和As等效速流压强条件下,GaAs(001)表面会呈现出c(4×4)、2×4、c(2×8)、2×1等表面重构,其中c(4×4)和β2(2×4)重构是GaAs(001) 表面外延生长过程中,出现频率最高的两种重构[10]。GaAs表面重构会使其表面呈现出不同的表面形貌,但很多研究都将GaAs衬底表面视为原子级平坦[11-13],忽视了粗糙GaAs衬底表面对后续外延生长的影响。
为了研究粗糙GaAs(001)表面对In0.15Ga0.85As薄膜外延生长的影响,本文利用MBE技术制备了不同形貌GaAs(001)表面,通过扫描隧道显微镜(Scanning Tunnel Microscope, STM)对粗糙GaAs(001)衬底表面形貌进行表征与分析,并以外延生长15 ML的In0.15Ga0.85As薄膜为实例,揭示了薄膜的表面形貌特征由生长模式决定,而生长模式与衬底表能和应变能的相对大小有关,衬底表面能越大,薄膜应变能越小,薄膜越趋向于层状生长,其表面形貌越平整。
1 实验过程
实验是在超高真空(5~8×10-11Torr)的 MBE-STM联合系统里进行。在In0.15Ga0.85As薄膜的制备中,衬底为可直接外延生长的n+型GaAs(001)基片,Si掺杂浓度为1.0×1018cm-3。首先将GaAs衬底送入MBE真空室,在一定的As4压(8.5 μTorr)保护下将衬底温度升到580 ℃后,进行脱氧处理,脱氧完成后,降低衬底温度至560 ℃。然后,以350 nm/h的生长速率沉积0.15 μm的GaAs缓冲层,生长完成后,保持衬底温度不变,进行40min退火,使GaAs衬底表面趋于平坦化。在相同生长条件下,沉积0.5 μm的GaAs,退火30 min后,在As4压保持不变的情况下,以不同速率降低GaAs衬底温度至440 ℃,时间分别为3 min、18 min、36 min。随后以相同的生长条件在上述不同初始表面形貌的GaAs衬底上沉积15 ML(Monolayer, ML) In0.15Ga0.85As薄膜[5],生长条件:温度440 ℃、沉积速率0.343 ML/s,退火时间15 min。样品生长完成后将其进行STM表征与分析。
2 结果与讨论
2.1 GaAs(001)表面形貌
GaAs(001)衬底经脱氧处理、沉积缓冲层后,以不同速率降温至440 ℃,呈现出不同的表面形貌,如图1所示。图1(a)、(b)、(c)分别为用时3 min、18 min、36 min衬底温度从560 ℃降到440 ℃所形成的GaAs(001)表面形貌。富As条件下,对具有β2(2×4)重构的GaAs表面进行适当的降温,β2(2×4)重构表面会形成c(4×4)重构[9],通过RHEED实时监测,观察到GaAs(001) (a)的表面存在β2(2×4)和c(4×4)两种重构,而GaAs(001) (b)、(c)表面仅有c(4×4) 重构[5]。可以看出GaAs(001)表面由c(4×4)重构形成2D岛,其尺寸大小和空间分布都具有随机性,且随着降温速率的减慢,GaAs衬底(a)~(c)表面岛的密度逐渐减少,同时衬底表面也趋于平坦化。即相较于 (b)、(c)的GaAs表面,(a)的GaAs衬底表面更粗糙。周清[5]等人研究发现在预粗糙化的GaAs衬底表面生长的In0.15Ga0.85As 薄膜最佳,即在相同生长条件下,分别在 GaAs衬底(a)、(b)、(c)上生长厚度为15 ML的In0.15Ga0.85As薄膜,发现GaAs衬底(c)上生长的In0.15Ga0.85As薄膜表面较粗糙,而GaAs衬底 (a)上生长的In0.15Ga0.85As薄膜表面较平整。
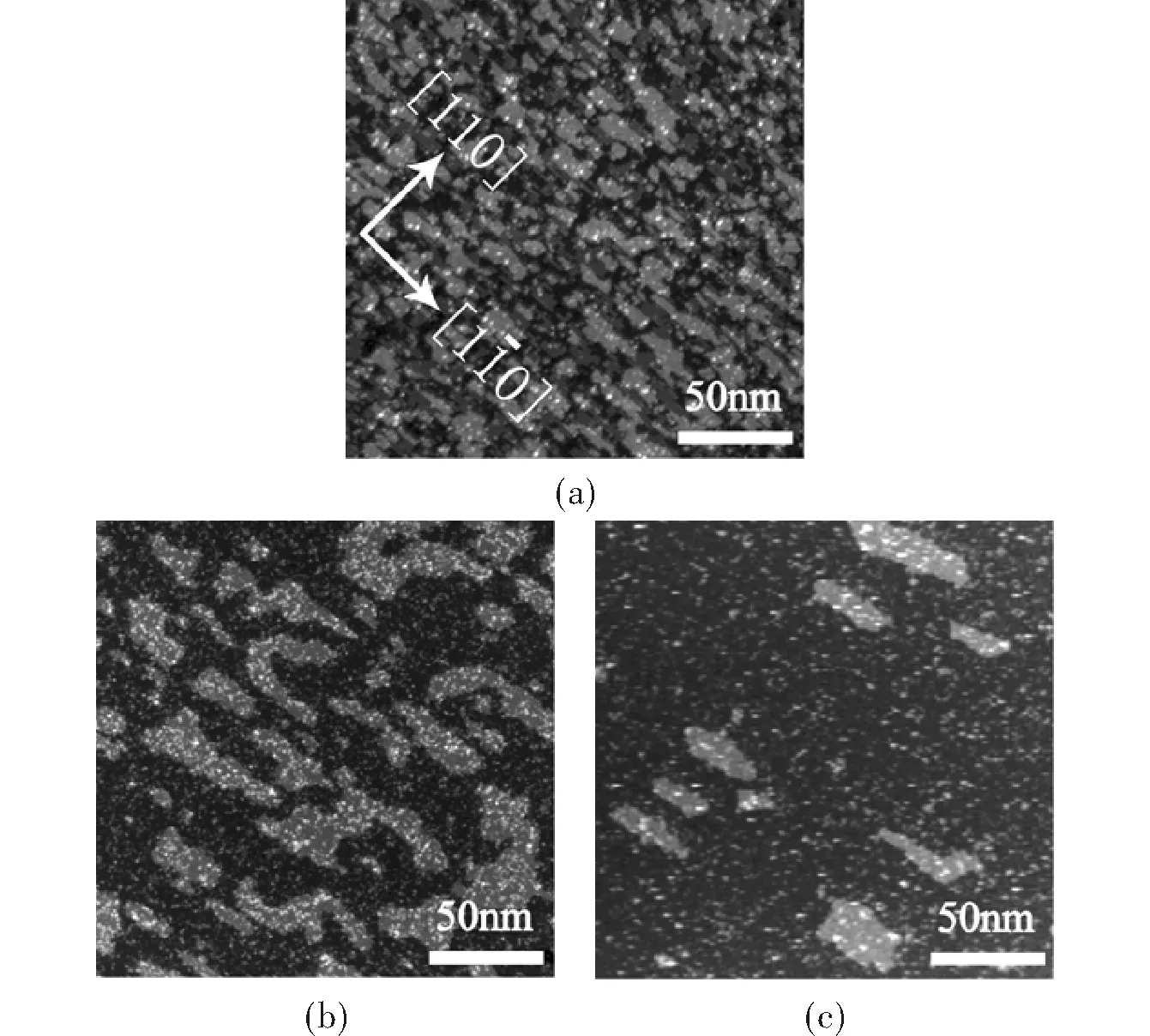
图1 不同速率下温度从560 ℃降到440 ℃ GaAs(001) 表面的STM形貌图
2.2 粗糙GaAs衬底表面及表面能
为了更深入的了解粗糙GaAs衬底表面对In0.15Ga0.85As薄膜生长的影响,对图1中GaAs衬底(a)表面形貌进行了详细分析,结果如图2,STM扫描尺寸为100 nm×100 nm。图2中(b)、(c)分别为 (a)中对应的β2(2×4)和c(4×4)重构球棍模型[14],GaAs(001)表面由c(4×4)重构所形成的2D岛沿 方向的长度为5~27 nm,沿 方向的宽度为2 ~15 nm,长宽比约为3,且图中岛和坑(图中较暗区域)的表面覆盖率分别约为37%、19%。岛的高度(β2(2×4)与c(4×4) 重构表面之间的高度差) 约为0.15 nm,坑的深度(β2(2×4)重构的高度)约为0.28 nm,相当于一个ML。一般可以简单地认为,表面原子排列方式的不同以及表面积的变化是晶体表面能改变的标志,GaAs(001)表面无重构时其表面能[15]为1.06 J/m2,当GaAs表面呈现出β2(2×4)和c(4×4)重构时其表面能[16-17]分别为0.34 J/m2、0.68 J/m2,虽然重构在一定程度上可以减少GaAs衬底的表面能,但重构与重构之间如果存在大量台阶,使得GaAs衬底表面积变大,则其表面能也增加。

图2 粗糙GaAs(001)表面形貌
图3为GaAs(001)衬底表面的截面示意图,GaAs衬底表面由平面和侧面组成,凸出部分为2D岛,凹处为坑。假设图3(a)中的岛和坑由不同长方体堆叠形成,则岛和坑的侧面积可以通过式(1)进行近似计算
S=2∑hi(li+di)i=1,2,3…
(1)
式中li、di、hi分别为岛或坑的长、宽、高,引用下标符号i表示不同大小的岛和坑。当li≫hi,di≫hi时,可将GaAs衬底表面视为平坦状态,如图3(b)所示。具有图3中(a)结构的GaAs衬底表面能较大,其归因于衬底表面积的增加,即GaAs表面岛和坑所形成的侧面积越多,其表面能越大[18]。对比图1中(a)、(b)、(c),GaAs衬底表面能依次减小,可推测In0.15Ga0.85As薄膜[5]表面呈现出的差异性,与GaAs衬底表面能的大小和In0.15Ga0.85As薄膜的生长模式有关。
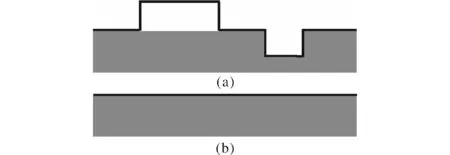
图3 GaAs(001)衬底截面示意图
2.3 In0.15Ga0.85As/GaAs薄膜的生长
薄膜的生长模式主要分为层状生长、岛状生长,层状加岛状生长[14],薄膜以层状模式进行生长时,薄膜表面较平整,而当薄膜出现岛状生长时,薄膜表面则会凹凸不平,变得粗糙。根据Bauer定则[19],薄膜的生长模式主要取决于衬底的表面能Es、外延薄膜的表面能Ef、薄膜与衬底的界面能E*之间的相对大小。当Ef+E*≤Es时,薄膜生长模式为层状生长,E*与薄膜和衬底材料的匹配度有关,可简化为薄膜生长时所具有的应变能Eε。对于同质外延Ef≈Es,E*=0,如图4(a)所示;而对于异质外延,E*>0,主要由薄膜与衬底之间存在的失配所引起。正常情况下,只有当E*足够小且Ef≤Es时,异质外延薄膜才有可能以层状模式进行生长,否则,薄膜很容易进行岛状生长,使得薄膜表面粗糙度增加,如图4(b)所示。相同条件下,在不同表面形貌的衬底上进行外延薄膜生长,衬底表面能越大越有利于薄膜层状生长,薄膜表面越平整,但这并不能忽视衬底和薄膜之间的界面能E*作用,在Ef≤Es情况下,如果衬底表面能增加,其增加量ΔEs大于薄膜所具有的应变能Eε≈E*,薄膜同样以层状模式进行生长,如图4(c)所示。
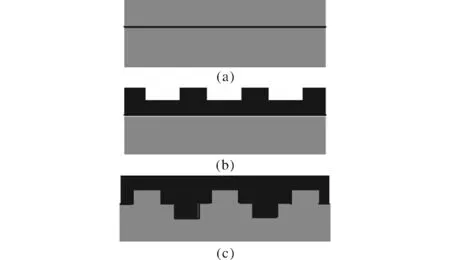
图4 薄膜生长截面示意图
T=300 K时,In0.15Ga0.85As的晶格常数为0.571 3 nm,大于GaAs的晶格常数(0.565 3 nm)。在GaAs衬底上生长In0.15Ga0.85As薄膜时,薄膜在横向上受到压应力,纵向上即生长方向上受到张应力。由于GaAs衬底的厚度远大于生长薄膜的厚度,当忽略衬底的应变,只考虑薄膜所积累的应变大小时,在单位面积内薄膜的应变能为[20]
(2)
式(1)中G、ν、h分别为薄膜的切变模量、泊松比和厚度,ε为衬底与薄膜之间存在的失配度;且
(3)
式(2)中af、as分别是薄膜和衬底的晶格常数。计算出GaAs衬底与In0.15Ga0.85As薄膜之间的失配度ε约为1%。利用式(2),可以计算出面积为100 nm×100 nm的In0.15Ga0.85As薄膜应变能为2.3×103eV,即E*=2.3×103eV。
与平坦GaAs(001)表面相比,图2(a)中以GaAs(001)衬底的岛和坑形成的侧面表面能作为GaAs表面能的增加量ΔEs,通过SPIP测量统计,并利用式(1),得出图2(a)中岛和坑形成的总侧面积约为857.35 nm2,占据GaAs衬底总表面积的8%。GaAs (110)面的表面能[15]为0.86 J/m2,由于 (110)面为GaAs的解理面,若将岛和坑形成的侧面视为GaAs (110)面,可以估算出图2(a)中GaAs表面能的增加量ΔEs约为4.6×103eV。
3 结束语
利用MBE技术在GaAs(001)衬底上沉积GaAs缓冲层后,分别经过3 min、18 min、36 min降温处理,获取不同形貌的GaAs(001)表面,通过STM对其表面形貌进行表征与分析。粗糙GaAs衬底表面由于存在β2(2×4)和c(4×4)两种重构,其表面形成了大量的岛和坑,引起GaAs衬底表面能增加;在生长In0.15Ga0.85As/GaAs薄膜的过程中薄膜具有一定的应变能,对于不同表面形貌的GaAs衬底,衬底表面能越大,薄膜的应变能越小,薄膜更趋向于层状生长;面积为100×100 nm2的粗糙GaAs衬底表面能相对平坦GaAs衬底增加了约4.6×103eV,其增加量大于外延生长15 ML的In0.15Ga0.85As薄膜的应变能2.3×103eV,满足薄膜以层状模式生长条件,故粗糙GaAs(001)表面更利于生长表面平整的In0.15Ga0.85As薄膜。
[1]Tamaki R,Shoji Y,Okada Y,et al.Spectrally resolved interband and intraband transitions by two-step photon absorption in InGaAs/GaAs quantum dot solar cells[J].IEEE Journal of Photovoltaics,2017,5(1): 229-233.
[3]Kaizu T,Suwa M,Andachi T,et al.Polarization anisotropy of electroluminescence and net-modal gain in highly stacked InAs/GaAs quantum-dot laser devices[C].Hawwi:Compound Semiconductor Week,IEEE, 2016.
[4]罗子江,周勋,郭祥,等.高In组分InGaAs薄膜的分子束外延生长及其表面分析[J].材料导报, 2013,27(22):29-32.
[5]Zhou Q,Luo Z,Liu K,et al.Influence of GaAs (001) pregrowth surface morphology and reconstruction on the growth of InGaAs layers[J].Applied Surface Science,2013(268): 151-155.
[6]Golovynskyi S L,Dacenko O I,Kondratenko S V, et al.Intensity-dependent nonlinearity of the lateral photoconductivity in InGaAs/GaAs dot-chain structures[J].Journal of Applied Physics,2016,119(18):1-7.
[7]Kondratenko S V, Iliash S A,Vakulenko O V,et al.Photoconductivity relaxation mechanisms of InGaAs/GaAs quantum dot chain structures[J]. Nanoscale Research Letters,2017,12(1):183-187.
[8]王继红,罗子江,周勋,等.间歇式As中断生长InGaAs/GaAs量子点[J].功能材料,2017,48(5): 5023-5027.
[9]LaBella V P,Krause M R,Ding Z,et al. Arsenic-rich GaAs (001) surface structure[J]. Surface Science Reports,2005,60(1): 1-53.
[10] Kratzer P,Penev E,Scheffler M.Understanding the growth mechanisms of GaAs and InGaAs thin films by employing first-principles calculations[J].Applied Surface Science,2003, 216(1):436-446.
[11] De Assis T A, Aaro Reis F D.Smoothening in thin-film deposition on rough substrates[J]. Physical Review E,2015,92(5):1-10.
[12] Riposan A,Martin G K M,Mirecki M J.Step instability and island formation during annealing of pseudomorphic InGaAs/GaAs layers[J].Applied Physics Letters,2003,83(22): 4518-4520.
[13] Gyure M F,Zinck J J,Ratsch C,et al.Unstable growth on rough surfaces[J].Physical Review Letters,1998,81(22):4931-4934.
[14] 许振嘉.近代半导体材料的表面科学基础[M].北京:北京大学出版社,2002.
[15] Sadao Adachi.IV族、III-V族和II-VI族半导体材料的特性[M].北京:科学出版社, 2009.
[16] Qian G X,Martin R M,Chadi D J. First-principles study of the atomic reconstructions and energies of Ga-and As-stabilized GaAs (100) surfaces[J].Physical Review B,1988,38(11):7649-7663.
[17] Gendry M,Grenet G,Robach Y,et al.Role of surface energy and surface reconstructions on the 2D-to-3D growth-mode transition of strained InxGa1-xAs layers on InP (001)[J]. Physical Review B,1997,56(15):9271-9274.
[18] Grinfeld M A.The stress driven rearrangement instability in crystalline films[J].Journal of Intelligent Material Systems & Structures,1993, 4(1):76-81.
[19] Bauer E,Merwe J H.Structure and growth of crystalline superlattices:From monolayer to superlattice[J].Physical Review B,1986,33(6): 3657-3671.
[20] Matthews J W.Defects associated with the accommodation of misfit between crystals[J]. Journal of Vacuum Science and Technology, 1975,12(1):126-133.
