硅埋置型毫米波系统级封装中光敏BCB工艺改进*
2017-04-25陈雯芳孙晓玮
陈雯芳,孙 浩,方 针,孙晓玮*
(1.中国科学院上海微系统与信息技术研究所,上海 200050;2.上海大学通信与信息工程学院,上海 200070)
硅埋置型毫米波系统级封装中光敏BCB工艺改进*
陈雯芳2,孙 浩1,方 针2,孙晓玮1*
(1.中国科学院上海微系统与信息技术研究所,上海 200050;2.上海大学通信与信息工程学院,上海 200070)
硅埋置型毫米波系统级封装中,传统光敏BCB工艺常在沟槽处引入气泡及凹陷,导致上层金属线不连续。为减少气泡与凹陷的产生,提出一种新型涂覆工艺——“双型三次涂覆工艺”,即在使用大厚度BCB的基础上,引入低粘滞性BCB,并三次涂覆BCB。采用此工艺对Ka波段低噪声放大器进行封装,发现气泡数量及凹陷程度大大减小,证明了此工艺的可行性及有效性。在25 GHz~37 GHz频段内,封装后比封装前增益减少1dB,满足高性能封装要求。
系统级封装;气泡缺陷;双型三次涂覆;毫米波;硅埋置
随着深空探测、空间遥感和高速宽带通信技术[1-2]的飞速发展,人们对微波毫米波模块和系统的高集成度、多功能、小型化和低成本等方面提出了更高要求[3-7]。基于硅基埋置技术的三维系统集成技术是毫米波三维高密度封装中一个重要的研究方向[8-10]。
苯并环丁烯BCB(Benzocyclobutene)介电常数和介电损耗低,同时具备吸湿率低,化学特性稳定,热力与机械稳定等优点,因此被广泛用做三维系统集成的介质层材料。BCB分为非光敏与光敏两种。本文将采用工艺步骤简单、成本较低的光敏BCB作为介质层[10-11]。
传统基于光敏BCB的硅埋置三维封装工艺易在芯片埋置引入的沟槽处产生气泡及凹陷,严重影响沟槽处上层金属互连,造成金属布线的不连续。本文将分析气泡及凹陷产生机理,研究减少气泡及凹陷产生的改进方法。
1 封装过程中气泡和凹陷产生原因分析
硅埋置三维系统集成工艺的基片采用N<100>的硅片,埋置的芯片厚度为100 μm。为了满足系统封装性能的要求,需要涂覆20 μm大厚度的BCB[6]。基于光敏BCB的硅埋置型系统级封装的基本工艺方法极易引入气泡以及凹陷.了解基本封装工艺的流程以及封装结构,有助于分析气泡以及凹陷的产生机理。
1.1 基本工艺方法
传统工艺流程如图1。具体工艺步骤如下:(1)氧化硅基板,形成双面二氧化硅,如图1(a);(2)腐蚀二氧化硅腔,如图1(b);(3)空腔制备,如图1(c);(4)地层金属布线,如图1(d);(5)埋置芯片,如图1(e);(6)BCB层制备;(7)上层金属布线如图1(g)。

图1 传统工艺流程
图1中BCB层工艺的具体流程如下:首先旋涂一层增粘剂AP3000;再旋涂20 μm的BCB(转速900 rad/min,旋转30 s),如图1(f);其次进行前烘、曝光、显影前烘、显影、显影后烘一系列步骤;放入回流炉中,在N2环境下进行固化,固化温度240 ℃,50 min;最后用O2/SF6(8∶2)在深反应离子刻蚀机中刻蚀去除显影残余物,完成BCB通孔制作,如图1(g)。
1.2 产生气泡和凹陷的机理
在硅埋置工艺中,埋置芯片的空腔通常是采用50 ℃的40 wt%的KOH溶液腐蚀N<100>的普通硅衬底制备而成。腐蚀为各向异性的,因此埋置空腔的侧壁形成了1个54.74°的倾角,如图2所示。当芯片埋入空腔后,空腔的边缘与芯片边缘之间形成了上宽下尖的楔形沟槽,空腔深度为110 μm,楔形沟槽上宽为78 μm。这样的结构很容易在BCB涂覆过程中引入气泡以及凹陷问题。

图2 楔形沟槽
1.2.1 气泡产生机理
粘滞性是衡量光刻胶流动特性的参数。粘滞性随着光刻胶中的溶剂的减少而增加;高的粘滞性会产生厚的光刻胶;粘滞性越小,光 刻胶厚度越均匀[10]。陶氏公司生产的几种不同型号的BCB的粘滞性以及涂覆厚度如表1,其中型号为3000系列的是非光敏型BCB,4000系列的是光敏型BCB,可以看到4026-46型BCB的粘稠度是非常高的,室温下为1100cSt。

表1 不同型号BCB粘滞性
为满足封装性能的需要,传统工艺采用陶氏公司提供的4026-46光敏型BCB,流动性较差。此种BCB旋涂时,极易在沟槽底部封存气体,如图3(a)。旋涂后,进行后续的曝光前烘,气体受热膨胀。由于BCB流动性差且BCB中的溶剂挥发快,很快凝固成型,使气体无法溢出,于是BCB表面形成气泡,如图3(b),气泡高度最高可达90 μm。
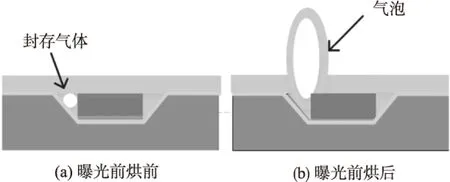
图3 气泡的产生
1.2.2 凹陷产生机理
凹陷在封装过程中经常会产生,直接影响到系统封装的可靠性。在BCB旋涂时在沟槽底部没有封存气体的情况,以陶氏公司生产的4026-46型号的光敏BCB为例,对固化前后BCB厚度的变化进行探讨,如表2所示。其中,变化率为固化后与固化前厚度的比值。

表2 固化前后BCB厚度变化
根据表2得知,BCB固化后,厚度会减小为固化前时的76%左右。也就是说,即使旋涂时BCB将110 μm深的楔形沟槽全部填满,在固化后,BCB在楔形沟槽处的深度也会有26.4 μm的凹陷。实际上,旋涂BCB时,因为离心力,BCB无法填充满110 μm深的沟槽。BCB固化后,厚度会进一步的减小,使得凹陷加深。所以BCB在楔形沟槽处的凹陷深度远大于26 μm,使得上层金属在此处断裂,图4(a)与图4(b)是固化前后凹陷加深示意图。

图4 凹陷的产生
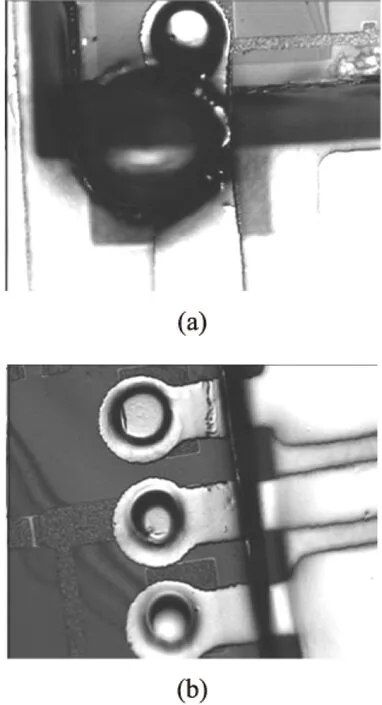
图5 显微镜下的气泡与凹陷
图5(a)与图5(b)分别表示,实际操作过程中光敏BCB的涂覆工艺在楔形沟槽处产生的气泡与凹陷。气泡以及凹陷将导致顶层金属线的不连续,封装的失败。
1.3 工艺改进
已有相关文献提出了工艺改进的方案。针对气泡问题,有人提出了静置法[13](常温常压),即在涂覆BCB后,静置2 h,再进行曝光前烘等后续步骤。这种方案对于采用非光敏型BCB的硅埋置工艺效果明显,但是对于光敏型BCB,收效甚微,气泡仍明显存在[11-13]。因为相同涂覆厚度所用的光敏型BCB比非光敏型BCB的粘滞性高,流动性差。另有文献建议采用真空静置法[12]来处理气泡问题。这种方法试图利用内外压强差,使被封存的气体冲破上层光敏BCB,快速溢出。经过实验表明,这种方法对解决气泡问题无效。因为,在真空中,光敏BCB内的溶剂极易挥发,封存在沟槽处的气体还未溢出,光敏BCB就已凝固成型,使得光敏BCB表面形成了非常明显的凸起。针对凹陷问题,有人针对涂覆非光敏型BCB时产生的凹陷问题提出了二次涂覆法[14]。这种方法对解决光敏型BCB的凹陷问题同样十分有效,但未能解决气泡问题。目前,将静置法与二次涂覆法相结合是常用的涂覆方法,在本文中命名为A工艺。

图6 双型三次涂覆法工艺流程
1.3.1 双型三次涂覆法
为同时解决凹陷以及气泡等缺陷问题,本文提出了一种“双型三次涂覆法”。如图6所示。(1)在芯片埋置完成后,先涂覆一种粘滞性极低的BCB(实验采用的陶氏公司的3022-45型BCB,粘滞性为14 cSt @ 25°C),涂覆厚度为2 μm,如图6(a)。因为此种型号的BCB流动性强,旋涂时,不易在沟槽处封存气体。旋涂后,在80 ℃热板上烘1 min。(2)涂覆大厚度光敏BCB,实验所用型号为陶氏4026-46,涂覆厚度为10 μm,然后静置两天,使已封存的气体充分溢出,再进行光敏BCB的固化,如图6(b)。(3)涂覆第3层光敏BCB,同样型号是4026-46,涂覆厚度20 μm,静置1 h~2 h,再进行曝光前烘,曝光,显影,显影后烘,固化等标准步骤,如图6(c)。(4)刻蚀光敏BCB,刻蚀厚度为第1层薄型BCB加上第2层光敏BCB的厚度,即刻蚀厚度为12 μm,露出地屏蔽层,如图6(d)所示。
“双型三次涂覆法”在使用大厚度BCB的基础上,引入低粘滞性薄型BCB,目的是减少沟槽处气体封存,并通过充分静置,使已经封存的气体充分溢出,同时三次涂覆,将会大大减轻沟槽处BCB的凹陷程度。这种方法理论上是可行的。
2 工艺试验与结果分析
本文用图6所示的双型三次涂覆法对Ka波段的低噪声放大器进行封装,封装后的结果如图7(a)所示。而图7(b)是采用工艺A实现的芯片封装效果图。对比中可以发现,两图均无明显凹陷,采用双型三次涂覆法实现的封装,沟槽处气泡无明显气泡,沟槽处金属互连线连续。

图7 双型三次涂覆法与工艺A效果对比

图8 封装前后增益对比
最后,对使用改进工艺进行封装的低噪声放大器,即图7(a)所示的放大器进行测试。测试电源电压3 V,偏置电压为0.4 V。封装前后,增益S21随着频率f的变化如图8所示。在25 GHz~37 GHz频段内,封装后的增益大于17.8 dB,而封装前的增益大于18.8 dB。由此可以看出,增益退化在1 dB左右,封装效果良好,满足封装的高性能要求。
3 结论
基于硅基埋置技术的三维系统集成技术是毫米波三维高密度封装中一个重要的研究方向。本文就基于光敏BCB的硅埋置型封装工艺中造成互连线不连续的气泡以及凹陷等缺陷进行分析研究,发现光敏BCB的高粘滞性是沟槽中产生气泡的诱因,并发现BCB固化前后厚度的变化是凹陷产生的主要原因之一。从而提出一种新方法“双型三次涂覆法”,即在使用大厚度BCB的基础上,引入低粘滞性薄型BCB,减少沟槽处气体封存,并通过充分静置,使已经封存的气体充分溢出,通过多次涂覆,减弱由于固化前后BCB厚度减小引起的凹陷程度,最终获得高平坦度的BCB,保证了沟槽处金属线互连的可靠性。随后,本文采用改进后的工艺,对Ka波段低噪声放大器进行了封装,经过镜检,发现气泡数量以及凹陷程度大大减小,证明了改进工艺的可行性以及有效性。封装前后增益退化约1dB,满足高性能封装要求。本文通过一系列的研究,为提高光敏BCB的硅埋置系统级封装的可靠性进行了有益探索和技术积淀。
[1] 李建宇,张朝杰,金小军,等. 适用于微小卫星的低功耗S波段发射机设计与实现[J]. 传感技术学报,2013(8):1168-1172.
[2] 袁铁山,张朝杰,杨伟君,等. 新型S波段软件无线电微型测控应答机的实现[J]. 传感技术学报,2012,25(6):756-760.
[3] Wang H,Wu T L,Hsu P,et al. Recent Progress of Advanced Microwave and System-in-Package Integration Technologies at National Taiwan University[C]//Microwave Conference(APMC),2014 Asia-Pacific. IEEE,2014:640-642.
[4] Feger R,Stelzer A. Millimeter-Wave Radar Systems on-Chip and in Package:Current Status and Future Challenges[C]//Wireless Sensors and Sensor Networks(WiSNet),2015:32-34.
[5] Kamgaing T,Elsherbini A A,Oster S N,et al. Ultra-Thin Dual Polarized Millimeter-Wave Phased Array System-in-Package with Embedded Transceiver Chip[C]//Microwave Symposium(IMS),2015:1-4.
[6] Lan X,Changchien P,Fong F,et al. Ultra-Wideband Power Divider Using Multi-Wafer Packaging Technology[J]. IEEE Microwave and Wireless Components Letters,2011,21(1):46-48.
[7] Chang K F,Li R,Jin C,et al. 77-GHz Automotive Radar Sensor System with Antenna Integrated Package[J]. Components Packaging and Manufacturing Technology IEEE Transactions on,2014,4(2):352-359.
[8] Wang T,Tang J,Luo L. A Wafer-Level Package of Wideband Microwave Transmission System Based on BCB/Metal Structure Embedded in Si Substrate[J]. Microsystem Technologies,2013,19(12):1953-1960.
[9] Wu L,Wang H,Tang J,et al. Research on Si-Based MEMS Process in Development 3D Millimeter-Wave Multi-Chip Module Package[C]//Microwave and Millimeter Wave Technology(ICMMT),2010 International Conference on. IEEE,2010:1049-1052.
[10] 吕文倩,吴亮,汤佳杰,等. K波段小型化收发前端的研制[J]. 电子器件,2013,36(5):623-626.
[11] Tang J,Sun X,Luo L. A Wafer-Level Multi-Chip Module Process with Thick Photosensitive Benzocyclobutene as the Dielectric for Microwave Application[J]. Journal of Micromechanics and Microengineering,2011,21(6):65035-65042(8).
[12] 崔春芳. 新型电子化学品生产技术与配方[M]. 北京:化学工业出版社,2011:85-86.
[13] 汤佳杰. 硅基埋置型圆片级系统封装及其在微波频段应用的研究[D]. 中国科学院研究生院,2012:61-70.
[14] 耿菲. 硅基埋置型MMCM封装研究[D]. 中国科学院研究生院(上海微系统与信息技术研究所),2010:60-63.
The Improvement for Photo-BCB Progress in Silicon Based Embedding Millimeter-Wave System-in-Package Technology*
CHENWenfang1,SUNHao2,FANGZhen1,SUNXiaowei1*
(1.School of Communication and Information Engineering,Shanghai University,Shanghai 200070,China;2. Shanghai Institute of Micro-System and Information Technology,Shanghai 200050,China)
In embedded silicon millimeter-wave system-in-package,the air bubbles and depressions in the gap lead to the open circuit of the upper metal lines.“The Double-Type Three-Coating Method”was proposed to promote the photosensitive benzocyclobutene(BCB)coating process. The thin BCB with low viscosity was used besides the thick BCB,to reduce the gas sealed at the gap. A Ka-band low noise amplifier was packaged in the new method. The number of bubbles and the degree of depressions are reduced. And the flatness of the metal lines is improved,which proves the feasibility and effectiveness of the Double-Type Three-Coating Method. The measurement results show that the gain after packaging is 1 dB lower than the gain before packaging,which meets the requirements of high-performance package.
SIP;air bubbles and depressions;the double-type three-coating method;millimeter;Silicon-based embedded

项目来源:国家重大仪器项目(2012YQ14003702)
2016-03-09 修改日期:2016-05-24
C:1350;0170J
10.3969/j.issn.1005-9490.2017.02.001
TN705
A
1005-9490(2017)02-0267-05
