薄膜厚度和溅射功率对有机衬底上ZnO:Ga薄膜应力的影响
2016-12-23张哲浩吕建国江庆军叶志镇
张哲浩,吕建国,江庆军,叶志镇
(1.硅材料国家重点实验室,浙江大学材料科学与工程学院,浙江杭州 310027;2.材料科学系,金日成综合大学,平壤朝鲜 420216)
薄膜厚度和溅射功率对有机衬底上ZnO:Ga薄膜应力的影响
张哲浩1,2,吕建国1,江庆军1,叶志镇1
(1.硅材料国家重点实验室,浙江大学材料科学与工程学院,浙江杭州 310027;2.材料科学系,金日成综合大学,平壤朝鲜 420216)
在室温(RT)下,采用直流(DC)磁控溅射在聚碳酸酯(PC)衬底上制备Ga掺杂ZnO(GZO)薄膜。通过X射线衍射(XRD)与基片曲率方法研究薄膜的残余应力。提出并讨论了厚度和溅射功率对GZO薄膜的应力影响并证实所有薄膜的应力均是压缩应力。研究表明随着薄膜厚度的增加,外应力可以得到充分释放。而溅射功率的变化可以改变GZO薄膜的应力和晶粒尺寸。研究表明溅射功率在140W的条件下制备的厚度225nm薄膜具有最大的晶粒尺寸和最小的压缩应力。结果表明改变溅射参数,比如溅射功率和薄膜厚度,GZO薄膜能够有效地释放应力。
ZnO:Ga薄膜;应力;基片曲率法;直流磁控溅射;有机衬底
1 引 言
透明导电氧化物(TCO)薄膜在过去的几十年中引起了科研工作者的广泛关注,它作为透明电极和窗口材料可用于各种电子器件如太阳能电池、发光二极管、传感器以及平板显示器等[1-4]。Ⅲ族元素如Al或Ga掺杂Zn O被认为是铟锡氧化物(ITO)的理想替代物,它们不仅具有良好的电学及光学性能,而且具有低成本、无毒、原材料丰富的优点。尤其与ITO相比,在氢等离子气氛下Zn O相对稳定[4]。在Ⅲ族元素中,Ga被认为是最有前景的掺杂元素之一。因为Ga与Zn离子半径接近,而Ga-O键和Zn-O键的键长也很相近,虽然掺杂浓度较高,但晶格畸变并不大。此外,金属Al具有非常高的活性,因而生长过程中易氧化[5]。相比Al而言,Ga具有较低反应活性,不易氧化,这是Ga作为掺杂元素的另一个优势。
目前制备Ga掺杂ZnO(GZO)薄膜的技术包括磁控溅射技术、电子束蒸发技术、脉冲激光沉积法、化学气相沉积法、溶胶-凝胶法以及喷雾高温热解法等[6-13]。其中磁控溅射技术由于具有沉积速率高、沉积的薄膜致密、易于大面积生产等特点而得到广泛的应用。
由于柔性透明导电氧化物具有固有的特点,例如可弯曲、重量轻、体积小、不易破碎、成本低和易于大面积生产等,因此广泛应用于柔性液晶显示器、可弯曲的太阳能电池和光伏建筑一体化等领域,研究开发具有优良光电性与稳定性的柔性透明导电薄膜具有十分重大的意义。可用的有机衬底材料较多,例如polypropylene adipate(PPA)、polymide(PI)、polyester、polyethyleneterephthalate(PET)、polyethylenenapt-halene(PEN)和polycarbonate(PC)[8,14-18]。由于PC聚合物具有较多的优点,如优异的电绝缘性能、良好的可见光区的透过率、突出的抗冲击性能、吸水率较低、收缩率较小、耐化学性好、无毒,所以我们选择PC衬底。然而,它同样具有一些缺点,如热膨胀系数高、耐热性低、机械强度弱。到目前为止,虽然较多研究人员报道了聚合物衬底GZO基透明导电薄膜及其电学及光学性能的研究情况[8,19],可是对柔性衬底上生长的GZO薄膜的应力的研究十分有限[20]。众所周知,薄膜中存在的残余应力对其性能(特别是对薄膜的机械、电学等性能)影响显著。因而,对于ZnO基器件的制造,需要系统研究ZnO薄膜的应力,以提高薄膜的质量和后续器件的性能。
本文中,我们在室温下,采用直流磁控溅射技术制备了GZO薄膜,并使用两种方法,即X射线法[21]与基片曲率法,测试GZO薄膜的残余应力,研究GZO薄膜厚度与溅射功率对GZO薄膜残余应力的影响。
2 实验过程
GZO薄膜是在常温下采用直流磁控溅射技术在厚度0.25mm的PC衬底上制备而得。Zn-Ga合金靶中Ga(99.999%)的含量为4.0at.%,其直径和厚度分别为3英寸和3mm。靶材和衬底的间距为10.5cm,腔体的本底真空度为2.0×10-3Pa,高纯度Ar和O2为溅射气氛,氧气的分压比为13.8%,溅射压强为0.5Pa。溅射功率范围在110W~150W,溅射时间为3min~12min。
通过X’PertPRO型X射线衍射仪以及轮廓测定仪(Dektak 3)对样品的残余应力进行测试表征。
3 结果与分析
3.1 薄膜厚度对p C衬底上GZO薄膜残余应力的影响
图1为在140 W的溅射功率下,制备的不同厚度GZO薄膜的XRD图谱。在XRD图中,只有一个较强的(002)衍射峰与很弱的(004)衍射峰,没有发现其它峰。这表明GZO薄膜沿c轴择优取向生长,c轴垂直于衬底,与薄膜厚度无关,薄膜中不存在其它相(如Ga2O3相等)或大尺寸颗粒。随着GZO薄膜厚度的增加,(002)衍射峰的强度提高。当薄膜厚度最厚的时候,获得最强的衍射峰。这些结果与其他研究人员报道结果[19]一致,说明随GZO薄膜厚度增大薄膜的晶体质量变好。通过式(1)(Debye Scherrer公式)估算晶粒的尺寸:

其中,λ为X射线的波长,θ为Bragg衍射角,β为(002)衍射峰的半高宽。

图1 不同厚度GZO透明导电薄膜的XRD图谱(a)75nm;(b)150nm;(c)225nm;(d)300nmFig.1 XRD patterns of GZO films with different film thicknesses (a)75nm;(b)150nm;(c)225nm;(d)300 nm
通过X射线法计算薄膜的应力。对于六方晶体,GZO薄膜应力的计算基于双轴应变模型[23]。沿c轴的应变可以通过使用以下公式来计算:

其中,C0是本体氧化锌的无应变晶格常数,C是通过XRD测量的ZnO薄膜的晶格常数。利用以下公式,导出平行于薄膜表面的薄膜应力σfilm,该公式适用于六方晶系的材料:

关于弹性常数Cij,使用单晶ZnO的数值,即C11=208.8,C33=213.8,C12=119.7,C13=104.2 GPa[24]。将这些值代入式(3),获得对GZO薄膜的残余应力的计算式(4):

表1给出通过XRD图谱获得的PC衬底上制备的不同厚度GZO透明导电薄膜的实验结果。由表1可以看出随着薄膜厚度增大晶粒尺寸增大,说明随着薄膜生长,通过小的晶粒的聚集和晶粒边界的移动来形成大的晶粒。而且,当GZO薄膜厚度增加到225nm的时候,GZO薄膜的压缩应力减少;当GZO薄膜厚度为225nm以上时,GZO薄膜的压缩应力几乎是常数。
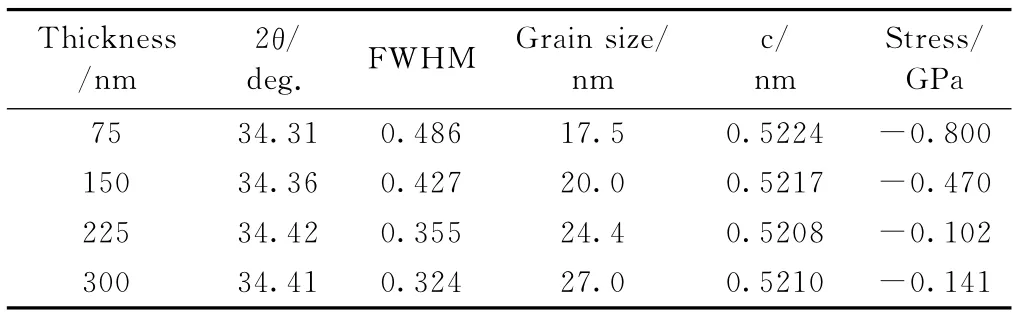
表1 通过XRD图谱获得的p C衬底上制备的不同厚度GZO薄膜的实验结果Table 1 Experimental results evaluated from XRD patterns of the GZO films prepared on p C substrates with different film thickness
通常薄膜的总应力由两部分组成,一部分为由晶体中的杂物、缺陷以及晶格变形引起的内应力,另外一部分为由薄膜和衬底之间的晶格错配以及膨胀系数不同引起的外应力。应力数值的负号意味着薄膜残余应力是压缩应力,因而,所获得的薄膜残余应力都是压缩应力。很多课题组[25-27]报道了应力方向的变化,然而,我们的试验中并没发现应力方向的变化。通过“原子轰击”模型(‘atomic peening’model)来解释薄膜的本征压缩应力[31]:在生长过程中,来自靶的一部分溅射粒子插入到薄膜里。同时,随着薄膜的生长,表面原子由溅射粒子的轰击而移动到生长中的薄膜内更深的地方。这些溅射粒子的填隙子与表面原子导致晶格常数的减少,因而产生压缩应力。Ga的掺杂导致压缩应力的减少。在Zn O薄膜中,由于Ga3+离子半径比Zn2+更小,当Ga3+离子替代Zn2+离子的时候,压缩应力减少,而且当Ga原子填隙的时候,压缩应力增大。在生长过程中,大多数Ga3+离子可能替代Zn2+离子,因而GZO薄膜的压缩应力减少。虽然Ga3+离子半径(0.062nm)比Zn2+(0.074nm)更小,但是跟Al3+(0.054nm)相比,和Zn2+更相近。在GZO薄膜中Ga3+离子与Zn2+离子半径很匹配,因此点阵畸变可显著减少。
其他课题组报道了由于ZnO薄膜与衬底材料的热膨胀系数α不同而引起的热应变比测量的应变小得多[28,32]。在我们的研究中,虽然ZnO薄膜的热膨胀系数(αZnO=6.05×10-6K-1)和PC衬底的热膨胀系数(αPC=7.0×10-5K-1)的差别较大,可是溅射中温度变化极小,因而我们可以忽略热应变。这意味着测量的薄膜应力是由生长工艺本身而导致的。在GZO薄膜生长初始阶段,GZO薄膜和PC衬底的晶格错配对薄膜的残余应力有较大影响。然而,随着GZO薄膜厚度的增加,这种外应力逐渐消失。在低温下这种外应力消失的速度较慢[25],对PC衬底上GZO薄膜而言,当薄膜厚度大于225nm时,这种外应力将几乎完全消失。随着GZO薄膜厚度的增加,晶粒尺寸增大,晶粒尺寸的增大又促进压缩应力的减少。
3.2 溅射功率对p C衬底上GZO薄膜残余应力的影响
图2给出了不同溅射功率的条件下PC衬底上制备的GZO薄膜的XRD图谱。在XRD图谱中,所有薄膜只有一个较强的(002)衍射峰及微弱的(004)衍射峰,没有出现其它峰。这表明GZO薄膜沿c轴择优取向生长,c轴垂直于衬底,与薄膜厚度无关,不存在其他相(如Ga2O3相等)或大尺寸颗粒。随着溅射功率的增大,衍射峰的强度逐渐增大。当溅射功率为140 W的时候(图2(d)),(002)衍射峰的强度最强。再增加溅射功率时,(002)衍射峰的强度反而减小。由图2可知,140 W的功率下制备的GZO薄膜的晶体质量最好。

图2 不同的溅射功率下制备的GZO薄膜的XRD图谱(a)110W;(b)120W;(c)130W;(d)140W;(e)150WFig.2 XRD patterns of GZO films deposited at different sputtering powers (a)110W;(b)120W;(c)130W;(d)140W;(e)150W
表2给出了通过XRD图谱获得的不同溅射功率下PC衬底上沉积的GZO透明导电薄膜的实验结果。通过上述方法算出GZO薄膜的晶粒尺寸和残余应力。所有薄膜厚度都在约213~237nm,因而外应力几乎不存在,获得的应力就是内应力。当溅射功率增加到140W时,GZO薄膜的晶粒尺寸逐渐增大,而GZO薄膜的压缩应力减少。溅射功率再增大,GZO薄膜的晶粒尺寸减少,而GZO薄膜的压缩应力增大。随着溅射功率的增大,薄膜表面迁移率逐渐增加,表面迁移率的增加导致晶粒尺寸增大。随溅射功率继续提高,表面上粒子由于溅射粒子的运动能量极大而更容易解吸附,因而限制了晶核的长大,导致形成小晶粒;而且,当溅射功率极大时,晶体质量变差,因为制备速度太快,不能形成良好的晶体和致密的薄膜。
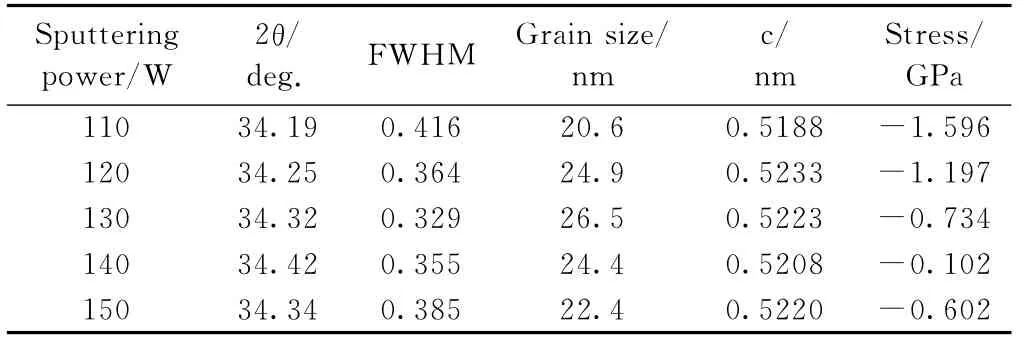
表2 通过XRD图谱获得的不同溅射功率下pC衬底上制备的GZO透明导电薄膜的实验结果Table 2 Experimental results evaluated from XRD patterns of the GZO transparent conductive films prepared on p C substrates at different sputtering power
由表2我们可以知道晶粒尺寸和压缩应力之间呈反比关系。较大晶粒尺寸导致压缩应力减少,甚至应力方向发生改变[26-27]。在本实验中,没有发现应力方向的变化,随着晶粒尺寸的增大,只有压缩应力的减少,有些文章也报道过类似的结果[29-30]。对应力性质而言,不同的课题组有不同的结果意味着掺杂Zn O薄膜的应力性质对制备工艺十分敏感。当溅射功率为140W时,我们获得薄膜中最大的晶粒尺寸和最小的压缩应力。GZO薄膜的晶粒尺寸越大,其晶体质量越好。晶体质量越好,压缩应力也越小[28]。因为良好的晶体质量意味着在晶体内有很少缺陷,因而随着晶体质量的提高,本征应力减少。
由实验结果,我们可知当外应力几乎消失时,晶粒尺寸增大导致压缩应力减少。140W的溅射功率和225nm的薄膜厚度是最佳的生长参数。
3.3 与基片曲率法结果的对比
我们采用另一个方法,即基片曲率法,与XRD法的应力数值相比,验证这次研究结果。样品曲率变化与薄膜应力的关系,可通过stoney公式来表达[34]:

式中Es为衬底的杨氏模量,υs为泊松比,ts为衬底的厚度,tf为薄膜的厚度,R为基片镀膜前的曲率半径,R0为基片镀膜后的曲率半径。
由式(5)来计算PC衬底上GZO透明导电薄膜的残余应力。图3给出通过独立的两种方法获得的应力对比。图3(a)为制备的不同薄膜厚度GZO透明导电薄膜的残余应力对比,图3(b)为不同溅射功率下制备的GZO透明导电薄膜的残余应力对比。由图3可知,与基片曲率法的结果相比,XRD法的压缩应力数值偏大。这两种方法获得的压缩应力结果在数值上的差别主要是由于XRD分析中衍射峰位置的测量准确度的误差而引起的。然而,通过独立的两种方法获得的应力变化规律是一致的。

图3 通过独立的两种方法获得的随薄膜厚度(a)和溅射功率(b)的变化比较PC衬底上制备的GZO薄膜的本征应力变化Fig.3 Intrinsic stress of GZO films deposited on PC substrate measured by two independent methods as a function of film thickness(a)and sputtering power(b)
4 结 论
采用XRD法与基片曲率法研究GZO透明导电薄膜的残余应力。GZO透明导电薄膜的厚度由75nm增加到225nm,薄膜的压缩应力逐渐减少。当GZO透明导电薄膜的厚度大于225nm的时候,薄膜的压缩应力几乎不变。当溅射功率由110W增大到140W时,GZO薄膜的晶粒尺寸增大而压缩应力逐渐减少。当溅射功率再提高时,GZO透明导电薄膜的晶粒尺寸变小,而其压缩应力变大。在140W的溅射功率下制备的GZO薄膜具有最大的晶粒尺寸与最小的压缩应力。通过独立的两种薄膜压缩应力测定方法(XRD法和基片曲率法)确定研究结果。通过实验,我们发现改变溅射参数,比如溅射功率和溅射时间(与薄膜厚度有关),室温下在PC衬底上制备的GZO薄膜能够有效地释放应力。
[1]吴云龙,成惠峰,余刚,等.ITO透明导电薄膜厚度与光电性能的关系[J].材料科学与工程学报,2012,30(1):14~16.
[2]Nakagawara O,Kishimoto Y,Seto K,et al.Moisture-resistant ZnO transparent conductive films with Ga heavy doping[J]. Appl Phys Lett,2006,89:0919041~3.
[3]季伶俐,贺蕴秋,孙芳芳.Zn-Sn-O系统透明导电薄膜的制备及其性能[J].材料科学与工程学报,2012,30(1):63~70.
[4]葛水兵,程珊华,宁兆元.Zn O:A l透明导电膜的制备及其性能的研究[J].材料科学与工程学报,2000,18(3):77~79.
[5]Assuncão V,Fortunato E,Marques A,et al.Influence of the deposition pressure on the properties of transparent and conductive ZnO:Ga thin-film produced by r.f.sputtering at room temperature[J].Thin Solid Films,2003,427:401~405.
[6]Cheong K Y,Muti N,Ramanan S R.Electrical and optical studies of Zn O:Ga thin films fabricated via the sol-gel technique[J].Thin Solid Films,2002,410:142~146.
[7]Ma Q B,Ye Z Z,He H P,et al.Preparation and characterization of transparent conductive ZnO:Ga films by DC reactive magnetron sputtering[J].Materials Characterization,2008,59:124~128.
[8]Gong L,Lu J G,Ye Z Z.Transparent and conductive Ga-doped Zn O films grown by RF magnetron sputtering on polycarbonate substrates[J].Sol Energ Mat Sol Cells,2010,94:937~941.
[9]Khranovskyy V,Grossner U,Lazorenko V,et al.PEMOCVD of Zn O thin films,doped Ga and some of their properties[J]. Superlattices&Microstructures,2006,39:275~281.
[10]Henley S J,Ashfold M N R,Cherns D.The growth of transparent conducting Zn O films by pulsed laser ablation[J]. Surface&Coatings Technology,2004,177:271~276.
[11]Gomez H,Maldonado A,Olvera M L.Gallium doped Zn O thin films deposited by chemical spray[J].Sol Energ Mat Sol Cells,2005,87:107~116.
[12]Yamamoto T,Sakemi T,Awai K,et al.Dependence of carrier concentration on oxygen pressure for Ga-doped ZnO prepared by ion plating method[J].Thin Solid Films,2004,451:439~442.
[13]Asmar R A,Juillaguet S,Ramonda M,et al.Fabrication and characterization of high quality undoped and Ga2O3-doped Zn O thin films by reactive electron beam co-evaporation technique[J].J Cryst Growth,2005,275:512~520.
[14]Yang T L,Zhang D H,Ma J,et al.Transparent conducting Zn O:Al films deposited on organic substrates deposited by r.f. magnetron-sputtering[J].Thin Solid Films,1998,326:60~62.
[15]Zhang D H,Yang T L,Ma J,et al.Preparation of transparent conducting Zn O:Al films on polymer substrates by r.f. magnetron sputtering[J].Appl Surf Sci,2000,158:43~48.
[16]Chen M,Pei Z L,Wang X,et al.Properties of ZnO:Al films on polyester produced by dc magnetron reactive sputtering[J]. Materials Letters,2001,48:137~143.
[17]Kim B G,Kim J Y,Lee S J,et al.Structural,electrical and optical properties of Ga-doped ZnO films on PET substrate[J]. Appl Surf Sci,2010,257:1063~1067.
[18]Chung Y M,Moon C S,Jung M J,et al.The low temperature synthesis of Al doped Zn O films on glass and polymer using magnetron co-sputtering:Working pressure effect[J].Surface& Coatings Technology,2005,200:936~939.
[19]Elvira F,Alexandra G,Vitor A,et al.Growth of Zn O:Ga thin films at room temperature on polymeric substrates:thickness dependence[J].Thin Solid Films,2003,442:121~126.
[20]Liu Y Y,Zang Y L,et al.Stress and structural studies of ZnO thin films on polymer substrate under different RF powered conditions[J].Materials Letters,2009,63:2597~2599.
[21]张定铨,何家文.材料中残余应力的X射线衍射分析和作用[M].西安:西安交通大学出版社,1999.
[22]Culity B D.Elements of X-Ray Diffraction[M].second ed.,Addison-Wesley,Reading MA,1978.
[23]Cebulla R,Wendt R,Ellmer K.[J].J Appl Phys,1998,83:1087~1095.
[24]Wang Y G,Lau S P,Lee H W,et al.Comprehensive study of Zn O films prepared by filtered cathodic vacuum arc at room temperature[J].J Appl Phys,2003,94:1597~1604.
[25]Hur T B,Hwang Y H,Kim H K.Strain effects in ZnO thin films and nanoparticles[J].J Appl Phys,2006,99:064308.
[26]Kumar V,Singh R G,Singh F,et al.Highly transparent and conducting boron doped zinc oxide films for window of Dye Sensitized Solar Cell applications[J].J Alloy Compd,2012,544:120~124.
[27]Mekhnache M,Drici A,et al.Properties of Zn O thin films deposited on(glass,ITO and ZnO:Al)substrates[J]. Superlattices&Microstructures,2011,49:510~518.
[28]Mohd F M,Mohamad H M,Mohd Z S,et al.Influence of various sol concentrations on stress/strain and properties of ZnO thin films synthesised by sol-gel technique[J].Thin Solid Films,2013,527:102~109.
[29]Yang S Y,Mana B Y,Liu M,et al.Structural,optical and magnetic properties of Zn1-xCoxO dilute magnetic semiconductors thin films by pulsed laser deposition[J].Physica B,2010,405:4027~4031.
[30]Ghosh R,Basaka D.Effect of substrate-induced strain on the structural,electrical,and optical properties of polycrystalline Zn O thin films[J].J Appl Phys,2004,96:2689~2692.
[31]Hoffman D W,Thornton J A.[J].Thin Solid Films,1977,45:387~396.
[32]Liu Y Y,Yang S Y,Wei G X,et al.In f luence of Substrate Temperature on Stress and Morphology Characteristics of Co Doped ZnO Films Prepared by Laser-Molecular Beam Epitaxy[J].J Mate Sci Technol,2013,29:1134~1138.
[33]Zhou H B,Zhang H Y,Han L W,et al.Effects of sputtering power on the properties of Al-doped Zn O films deposited on amorphous silicon films substrate[J].Superlattices and Microstructures,2013,64:563~568.
[34]Lee H W,Lau S P,Wang Y G.Fabrication and characterization of polymer/nanoclay hybrid ultrathin multilayer film by spin selfassembly method[J].Thin Solid Films,2004,458:9~14.
Influence of Film Thickness and Sputtering power on Stress properties of Ga:ZnO Thin Films on polymer Substrate
JANG Cholho1,2,LU Jian-guo1,JIANG Qing-jun1,YE Zhi-zhen1
(1.State Key Laboratory of Silicon Materials,School of Materials Science and Engineering,Zhejiang University,Hangzhou 310027,China;2.Department of Materials Science,Kim Il Sung University,pyongyang 420216,D.p.R.of Korea)
The Ga doped Zn O(GZO)films are deposited on polycarbonate(PC)substrate by direct current(DC)magnetron sputtering at room temperature(RT).The residual stress of the films is investigated by X-ray diffraction(XRD)and wafer curvature method.Influence of thickness and sputtering power on stress properties of GZO thin films grown on PC substrate by DC magnetron sputtering are reported and discussed. We find that the stress of all films is compressive stress.As the film thickness increase,the extrinsic stress can be fully relaxed.Change of the sputtering power results in the change of the stress and the difference of the grain size in the GZO films.For the films deposited with the thickness of 225nm,the film deposited at 140 W has the largest crystal grain and the smallest compressive stress.From our experimental results,we suggest that by adjusting the sputtering parameters,such as sputtering power and thickness,the stress relaxation in the GZO thin film grown on polymer substrate at RT could be achieved.
Ga doped ZnO;stress;wafer curvature method;DC magnetron sputtering;polymer substrate
TB34;TB43
A
10.14136/j.cnki.issn 1673-2812.2016.03.002
1673-2812(2016)03-0348-06
2015-05-11;
2015-06-16
国家自然科学基金资助项目(51172204)
张哲浩(1980-),男,博士研究生,研究方向:半导体薄膜。E-mail:jangcholho80@163.com。
叶志镇(1955-),男,教授,博导,研究方向:半导体薄膜与纳米材料。E-mail:yezz@zju.edu.cn。
