塑封IC失效分析及对策
2012-08-08王立国
王立国,邵 刚
(天水华天科技股份有限公司,甘肃天水 741000)
现代激烈的市场竞争中,质量是企业的生命。当产品在使用中由于自身质的变化导致产品丧失了预定的工作能力或其性能已劣化成不合格的状态时,我们通常称产品失效。电子器件的失效随着时间的变化可分为早期失效、正常失效和退化失效。失效符合浴缸曲线。早期失效多是由设计或工艺失误造成的质量缺陷所致,可以通过常规电参数检验和筛选进行检测,后两者则是由器件中的潜在缺陷引起的,潜在缺陷的行为与时间和应力有关,像潮气吸附、腐蚀和热机械应力、过电应力、静电放电等产生的失效占主导地位。
1 失效分析方法介绍
1.1 塑封IC常见失效机理
塑封IC是指以塑料等树脂类聚合物材料封装的集成电路。由于树脂类材料具有吸附水汽的特性,故限制了其应用领域,特别是在军事领域。其常见的失效机理有:芯片破裂、管芯钝化层损伤、管芯金属化腐蚀、金属化变形、键合金丝弯曲、金丝键合焊盘凹陷、键合线损伤、键合线断裂和脱落、键合引线和焊盘腐蚀、引线框架腐蚀、引线框架的低粘附性及脱层、包封料破裂、包封材料疲劳裂缝、封装爆裂(“爆米花”)、电学过载和静电放电、焊接点疲劳、粘片胶厚度不符、粘片胶沾污、压区破损、不同材质界面的分层等。
1.2 塑封IC失效分析方法
常用的失效分析方法有:电学分析、化学分析、热学分析、物理分析、电学分析。其中物理分析特点详见表1。
1.3 分析技术
常用失效分析的方法有:AES-奥格(Auger)电子分光显微镜、ESCA——化学分析用的电子波谱学、SIMS-二次离子质谱测定法、SEM-扫描电子显微镜、EDX-能量分散X射线分析、WDX-波长分散X射线分析、RBS-卢瑟福背向散射光谱测定法、LIMS-激光离子化质谱测定法、EBIC-电子束感应电流、SLAM和C-SAM、俄歇电子能谱仪。

表1 物理分析特点
1.3.1 SEM分析
SEM使用电子束(300 eV~40 keV)弹出低能级二级电子,用这些弹出电子的电流对阴极射线管的z轴进行亮度调制,产生一个视频图像。此方法分析时样品必须导电或表面覆盖导电层(场发射电镜不需要导电)。SEM将光学显微镜的放大倍数扩展到20~80万倍。图1为SEM电镜发现在塑封料和引线框架之间有分层。
1.3.2 EDX-能量分散X射线分析
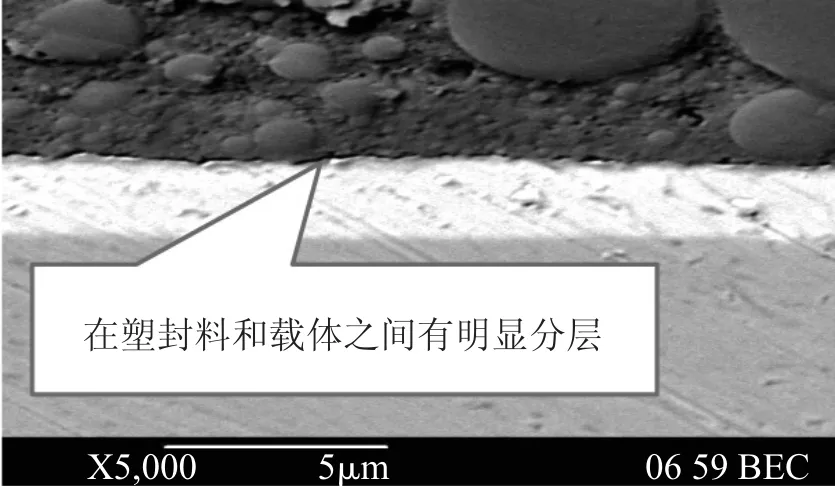
图1 SEM电镜下发现分层
EDX-能量分散X射线分析是当X射线检测器加到SEM上时,在SEM的同时,可以得到组成成分的分析(见图2)。从而可以在高倍下看到样本并对其照相,此外,也可对选择的区域进行分析,甚至可以转换成与二次电子图像相同的比例。
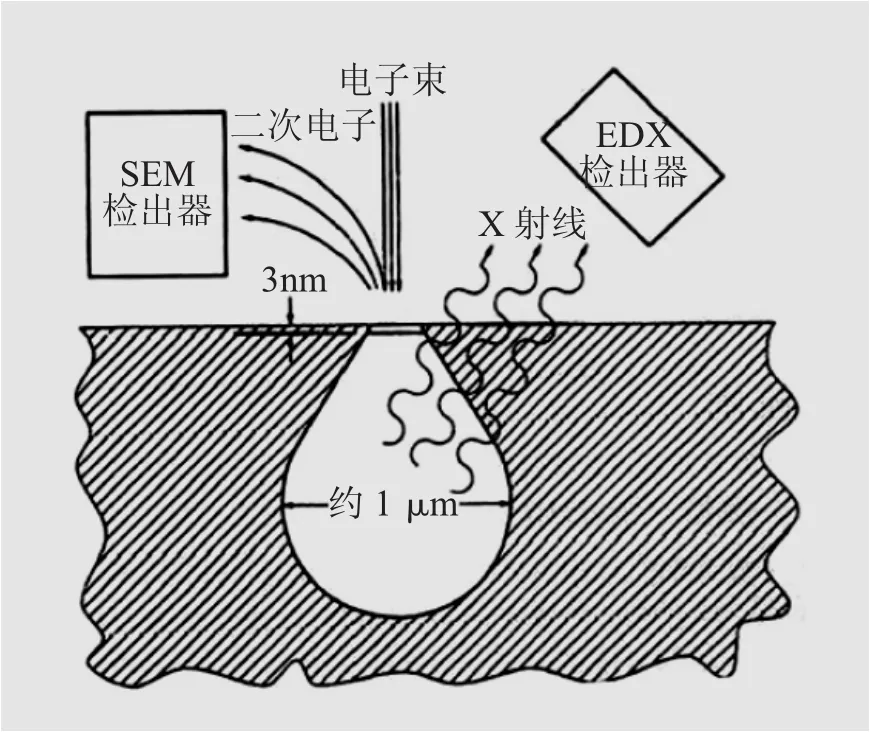
图2 组成成分分析
1.3.3 红外分析
红外热分析运用红外显微镜、红外扫描显微镜等,它的基本原理是,当器件加上电源后芯片上将有一定温度,产生相应的红外辐射,通过相应的红外接收系统,可将芯片上的反常热点显示出来,发现不合理的设计及材料和工艺中的缺陷,如反偏P-N结上的发光点、针孔、尖端扩散及铝膜台阶处的局部发热等。图3为红外分析仪发现芯片局部不良的照片。
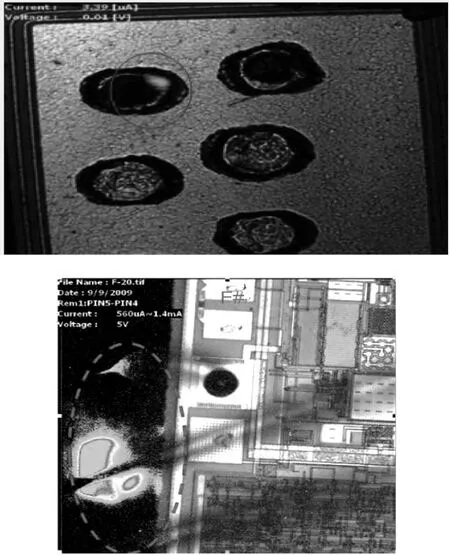
图3 红外分析仪发现芯片局部不良
1.3.4 SLAM和C-SAM分析
SLAM和C-SAM分析是利用扫描激光声学显微镜(SLAM)和C型扫描激光声学显微镜(C-SAM),都是使用高频超声对材料和元件中的不连续性进行检查,可用于非破坏性的元器件贴装的研究。SLAM使用的工作频率为10~500 MHz的穿通发射技术,而C-SAM工作在脉冲回音模式,声信号被聚焦在感兴趣的界面深度上,一个电子控制门被用来选择特定的深度。图4是C-SAM扫描发现有裂片的图片。

图4 C-SAM扫描发现有裂片
1.4 塑封IC失效分析基本步骤
1.4.1 保存物理证据
在生产和使用过程中,对失效的样品应妥善保管,并且温度、湿度应受控,并避免振动及静电等外力作用造成对失效样品的二次作用,使原来的失效模式发生变化,破坏物理证据;在非破坏分析前,应避免对失效的样品做电性分析。
1.4.2 失效产品信息及失效确认
(1)失效产品信息收集。接受上级或客户不良品信息反馈及分析请求,并了解客户相关信息(指失效模式、参数值、客户抱怨内容、型号、批号、失效率、所占比例等,与正常品相比不同之处);
(2)失效产品信息记录。记录各项信息内容,以在长期记录中形成信息库,为今后的分析工作提供经验值;
(3)收集工艺信息。包括与此产品有关的生产过程中的人员、机台、材料、方法、环镜变动的情况。
1.4.3 物理分析
(1)外观目检及镜检:重点检查器件的电镀层质量、管脚根部和密封缝的机械损伤、密封质量的完好性。
(2)X-Ray透视及SAT检查:透视和扫描器件内部,检查失效器件内部键合丝的质量,如断裂、烧熔、冲线率及布线是否正确,检查软焊料空洞及分层情况等。如图5~7所示。
1.4.4 电性分析
检查器件的电性能及参数是否正常、验证失效现象、分析异常以及初步分析失效原因。
1.4.5 破坏性分析

图5 X-Ray透视图

图6 SAT检查软焊料空洞

图7 SAT检查粘片胶空洞
破坏性分析目前主要采用化学开封、机械开封(激光开封)和切片分析(Cross-Section)。化学开封可采用手动开封和仪器开封,采用手动开封的方法为开帽镜检,用30~60倍显微镜检查机械缺陷、内引线、芯片位置、铝条好坏等,用400~1 000倍的镜像显微镜观察光刻、铝引线、氧化层缺陷、芯片裂纹等,并对结果照相;进一步测试电参数,必要时可划断铝条用探针测试管芯,检查电路的有源和无源元件性能是否正常;除去铝膜再对管芯进行测试,观察性能变化,并检查二氧化硅层的厚度与存在的针孔等;除去SiO2用探针测试管芯,分析表面是否有沟道、分析失效是否由表面效应引起。
如果分析未找到失效的真正原因,可对失效样品做切片试验,并进行SEM/EDX/FIB/TEM检查,进一步确认失效机理。切片、SEM、FIB、TEM、EDX分析图片见图8~图12。
1.5 根本失效原因确定

图8 切片分析图片

图9 SEM分析图片

图10 FIB分析图片
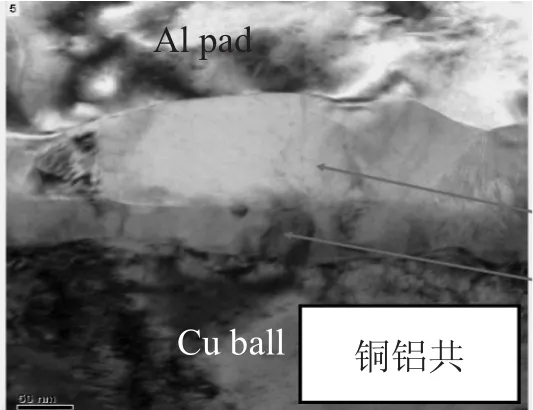
图11 TEM分析图片

图12 EDX分析图片
塑封IC失效的原因有:设计缺陷、原材料品质不良、制程问题、工艺问题、运输中静电击穿或存储环境中水汽吸附、使用时的过应力等,应针对失效分析样品,确定导致失效的根本原因。工艺问题在塑封IC中占失效比例最大,问题主要集中在前工序上,典型代表如由于粘片后对芯片未做等离子清洗,致使塑封电路在塑封材料与引线框架和芯片间发生分层,导致在过回流焊时,发生爆裂效应(俗称“爆米花”效应),而拉断键合丝,从而发生开路失效,还有压焊造成的弹坑,损伤下层设计线路。
1.6 纠正措施及验证
在查明失效原因的基础上,通过分析、计算和必要的可靠性验证,提出预防、纠正、改善措施,经评审通过后付诸实施,跟踪验证预防纠正措施的有效性,并按技术规范控制要求或图样管理制度对设计或工艺文件进行变更,制定永久改善措施,彻底解决问题。
2 提高塑封IC可靠性的措施
“可靠性”是指元件、产品、系统在一定时间内、在一定条件下无故障地执行指定功能的能力或可能性。可通过可靠度、失效率、平均无故障间隔时间来评定产品可靠性。
产品的可靠性取决于固有设计、制造过程、工作条件(确定产品使用时的环境温度、湿度,产品工作的电流、电压等),以下从三方面介绍提高塑封IC可靠性的措施。
2.1 产品可靠性设计
产品可靠性设计应优先考虑使用环境的复杂性。它取决于用户的类型以及产品的工作周期,可以通过仿真分析,来实现产品的可靠性,极大地缩短产品设计的时间及可靠性验证时间,同时通过试验或分析来验证工艺是否已达到了满足可靠性的目标。通过可靠性试验,产品的设计可以得到证实。产品的可靠性试验可以暴露出设计人员未想到的设计的薄弱环节或得到不令人满意的结果,作为试验人员,应向工程师反馈他们所需要的信息,以便工程师们改善设计,达到预期的效果。
在塑封IC设计时,为了提高可靠性,将零件最大允许应力限制到低于其最大额定应力值的某一规定值。并在产品中要考虑热量的产生和扩散,避免出现由温度造成的可靠性问题。
2.2 工艺及材料控制
在塑封IC整个生产过程,应加大工艺控制,其主要措施有:
(1)减少封装体内水汽含量,避免分层效应。封装体内的实际水汽含量是由密封材料、封装体本身、密封环境释放的水和通过密封处漏入的水汽组成。为防止水汽侵入,良好的钝化覆盖层(使用磷玻璃或氮化硅)是必要的,其次是减少包封料中的离子沾污物,在包封料中掺入杂质离子俘获剂或离子清除剂,提高塑封料与引线框架间的粘接强度,在塑封料中加入填充物延长水汽渗透路径,降低材料的吸水性等。
(2)严格控制产品在各站的加工等待时间和工艺条件要求。各站点的温湿度应满足工艺加工要求,流转的半成品在各站应及时加工,不加工的产品应保持在氮气柜中。各站点等待加工时间不能超过24 h,测试前产品要进行烘烤,去除湿气。
(3)减少封装体内部气泡,避免塑封体裂纹的产生。在IC后道封装的塑封过程中,环氧模塑料在熔融状态下充填成型时,包入或卷进去的空气以及饼料中原有的挥发性物质在成膜阶段时不能完全排出,残留在塑封体内部就形成气泡。其对可靠性的影响有:在过回流焊时导致塑封体开裂、使树脂的耐温性能下降、影响电性能。通过对料饼预热,使塑封料中的气体在进入料筒之前就挥发出来,阻止气体进入塑封体内部。
(4)减小金属框架对封装的影响。金属框架是塑料封装IC的基本材料,从上芯开始进入生产过程一直到结束,几乎贯穿整个封装过程,对上芯、压焊、塑封、电镀、切筋等工序质量均有影响,为提高塑封IC可靠性,对塑封用金属框架的要求有:选铜质引线框架,达到良好的热匹配,外引线脚增加锁定孔,减少切筋成型时的应力。
2.3 包装、运输及使用
在塑封电路运输、装卸、存贮等过程中,必须采取一定的保护措施。包装过程的保护措施有:必要的防潮保护(如:抽真空加干燥剂)、物理损伤保护(以免引线弯曲或断裂)、防静电放电保护等。器件使用单位应重视在元器件的测试、装配和调试、试验过程中严格执行有关操作程序,防止电学过载和静电放电失效。
3 结束语
塑封IC的失效分析只是对封装过程存在的异常进行分析,提供失效原因或潜在因素,用以采取措施改善塑料封装过程的不足,提高产品封装的良率。同时封装技术不断的趋于晶圆级,分析技术也在不断的更新,塑封IC的失效分析将延伸到晶圆级分析,提出了新的挑战。
[1] Tames J.Licari Leonard ard R.Enlow(美)著,朱瑞廉译.混合微电路技术手册:材料、工艺、设计、试验和生产(第二版)[M].北京:电子工业出版社,2004.
[2] 李双龙.塑封IC常见失效及对策[J].电子与封装,2004(2):31-33.
