标准中氦质谱检漏试验判据的研究
2011-02-04金毓铨
金毓铨
(中国电子科技集团公司第五十五研究所,江苏 南京 210016)
1 引言
气密封装电子器件氦质谱检漏的试验条件和判据,有固定方法和灵活方法两种。固定方法针对不同器件的内腔容积,规定加压条件和氦质谱检漏时的氦测量漏率极限值。灵活方法只针对不同器件的内腔容积,规定器件的空气等效标准漏率的极限值,实施时根据规定的等效标准漏率和实际的加压条件,计算氦测量漏率极限值。作为制定详细规范和实施检验时可以选用的两种方法,其宽严程度应该基本相当。但是本文以美国军用标准MIL-STD-750E《半导体器件试验方法》[1]为例进行的具体计算说明并非如此。灵活方法明显严于固定方法,多数情况下超过一个数量级。
2 计算方法和结果
美国军用标准MIL-STD-750E《半导体器件试验方法》(2006年11月20日)的方法1071.8中的氦质谱检漏固定方法规定的加压条件和判据如表1所示。

表1 MIL-STD-750E规定的加压条件和判据
该标准规定,灵活方法根据规定的空气等效标准漏率的极限值,以及实际的加压条件,用式 (1)计算氦测量漏率的极限值。

式(1)中:R1—氦的测量漏率,Pa·cm3/s;
L—空气等效标准漏率,Pa·cm3/s;
PE—加压的绝对压强,Pa;
Po—绝对大气压强,Pa;
t1—加压时间, s;
t2—去除压力到漏率检测之间的等待时间,s;
V—被试器件封装的内腔容积,cm3;
2.69为空气和氦的分子量之比的平方根((28.96/4)1/2)。
对灵活方法规定的判据如表2所示。
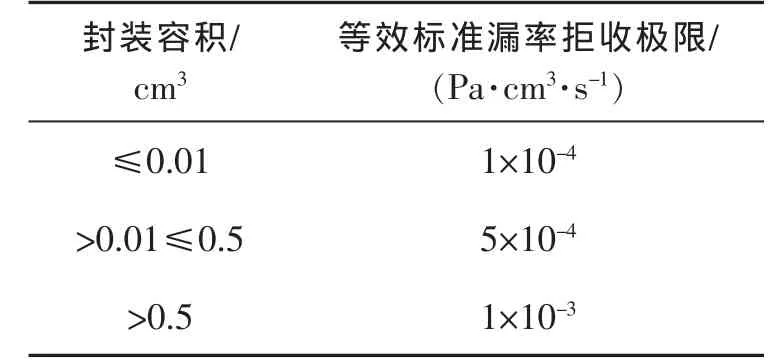
表2 MIL-STD-750E对灵活方法规定的判据
为比较表1和表2的判据是否基本相当,按表1规定的加压条件和测量漏率拒收判据R1,根据式 (1),用数值逼近的方法计算了相应的等效标准漏率L。计算时封装容积采用表1规定的封装容积范围的近似中间值,如果只规定了封装容积的上限,则采用二分之一上限值,见表3的第2列。计算结果见表3。
将表3中计算得到的等效标准漏率与表2中标准规定的等效标准漏率进行比较,可以看出存在较大的差别。除了封装容积为0.01~0.05这一范围,相差约5倍外,其它封装容积两者的差别均达到或超过一个数量级,灵活方法的要求明显严于固定方法。
另外一个美国军用标准,MIL-STD-883H《微电路试验方法》[2](2010年 2月 26日)的方法1014.13也包括程序相同的氦质谱检漏固定方法和灵活方法。用上述方法进行同样的计算,结果见表4。

表3 对表1规定的条件和判据计算得到的等效标准漏率

表4 MIL-STD-883H规定的加压条件和判据及计算得到的等效标准漏率
MIL-STD-883H对灵活方法规定的判据如表5所示。
将表4中计算得到的等效标准漏率与表5中标准规定的等效标准漏率进行比较,两者之间的差别均不超过一倍,不存在MIL-STD-750E 《半导体器件试验方法》中的问题。
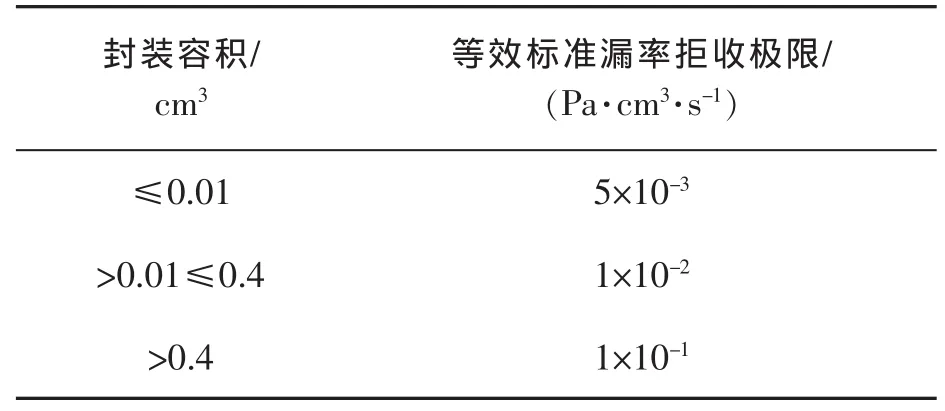
表5 MIL-STD-883H对灵活方法规定的判据
3 结束语
美国现行的军用标准MIL-STD-750E《半导体器件试验方法》的方法1071.8中的氦质谱检漏的固定方法和灵活方法的判据的宽严程度存在数量级的差别,灵活方法远严于固定方法。在进行标准或有关文件制定时如果参考这一标准,或者执行类似标准时就应予以注意。就固定方法而言,MILSTD-750E《半导体器件试验方法》的漏率判据已经严于MIL-STD-883H《微电路试验方法》,灵活方法又明显严于固定方法,如果不是有意加严检验要求,或迫不得已 (例如器件不能承受3个大气压的压强),则不宜采用灵活方法。
[1]MIL-STD-750E-2006,Test methods forsemiconductor devices[S].
[2]MIL-STD-883H-2010,Test method standard microcircuits[S].
